
在先进逻辑工艺讨论中,我们很容易把注意力全部放在晶体管结构上:
FinFET、GAA、CFET……
但在 IEDM 2025 的这份 Short Course 报告中,IBM 给出的视角非常直接:晶体管还能继续演进,但互连已经开始成为决定系统性能的硬瓶颈。
这份报告的主题并不宏大,却极其现实: Cu 互连还能不能继续用?如果不能,下一步该怎么走?

一、先给结论:这不是“Cu 已死”的报告
报告一开始就把话说清楚了:
Cu 并没有立刻失效 但在先进节点下,Cu 必须被“系统性改造” 真正面向 1.x nm 及以下节点的方案,已经不能只靠 Cu 延寿
二、Cu 互连真正卡住的,不是某一个点
报告非常明确地指出:Cu 互连的问题不是单点失效,而是三件事同时恶化。
1. Cu 填充:已经接近几何极限
随着 BEOL pitch 持续缩小:
沟槽越来越窄 深宽比越来越高 Barrier / liner 越来越薄
结果是:
Cu electroplating 的填充窗口急剧收窄,空洞不再是“偶发缺陷”,而是结构性风险。
2. 线电阻上升:不是工艺没做好,而是物理必然
当线宽进入十几纳米:
Barrier / liner 占比不断增加 Cu 有效导电截面积不断下降 电子平均自由程与线宽同量级
这时,表面散射和晶界散射成为主导机制,Cu 的电阻率随尺寸缩小急剧上升。这不是“换个设备就能解决”的问题,而是尺寸效应本身在惩罚 Cu。
3. 电迁移:小空洞也能致命
在高电流密度条件下:
原子迁移路径变短 多个界面同时成为扩散通道
报告强调一个容易被低估的事实:
在先进节点,哪怕是很小的 EM 空洞,也足以在目标寿命内造成失效。

三、Cu Extension:不是换材料,而是“榨干体系潜力”
1. Liner 工程:从 Ta 走向 Ru-Co
报告回顾了 liner 的演进逻辑:
Ta/TaN:传统方案,已不适合极小尺寸 Co liner:显著改善 Cu fill Ru liner:填充能力更好,但带来 CMP 与 EM 新问题 Ru-Co 复合 liner:在填充、EM 和集成复杂度之间取得更平衡的结果
这是目前多家厂商都在验证、甚至已经采用的现实路径。

2. Cu Reflow:已经不是实验室技术
报告明确指出:
Cu reflow 自 7 nm 起具备量产可行性 相比传统 seed + plating: 晶粒更大 EM 寿命分布更集中 不是“最好”,但在极限条件下“更稳”
3. Advanced Low-k:为 Cu 多争取一点空间
一个容易被忽略的关键点是:
新一代 ALK 材料本身具备 Cu/O₂ barrier 特性 可以进一步减薄 liner 直接降低线电阻,同时维持 TDDB 可靠性
这不是低 k 回潮,而是Cu 能否继续用下去的重要前提。

四、真正的 Innovation:Post-Cu 不是“换金属”那么简单
报告给出了一个非常清醒的判断:
Post-Cu 的难点,不在于“选哪个金属”,而在于“你用什么互连架构”。
1. 为什么 Ru / Co 会成为候选?
报告给出的筛选标准非常工程化:
尺寸散射下的有效电阻率 高熔点与高内聚能(抑制 EM) 趋近 barrier-less 的集成潜力
在这些条件下,Ru、Co、Rh 成为现实候选,其中 Ru 的研究数据最完整、验证最系统。
2. Damascene Ru 的“隐藏问题”:Line Wiggling
这是整篇报告中非常“IEDM”的一个点。
在 Ru damascene 结构中,观察到沿线方向的周期性 CD 起伏(wiggling):
不是 litho 问题 不是刻蚀缺陷 而是高表面能金属 + 低模量 low-k 结构下的力学失稳
结果是:
局部强散射 有效电阻上升 设计不可预测
这直接动摇了 damascene 是否适合 Post-Cu 金属。

五、Subtractive Ru:报告给出的关键突破口
在此背景下,报告给出了一个非常明确的方向:
Post-Cu 必须认真考虑 Subtractive 工艺路线。
1. 为什么是 Subtractive?
相比 damascene:
导体体积分数更高 更容易引入 airgap Line / via 可以同时受益 R、C、EM 可以一起改善,而不是彼此牺牲
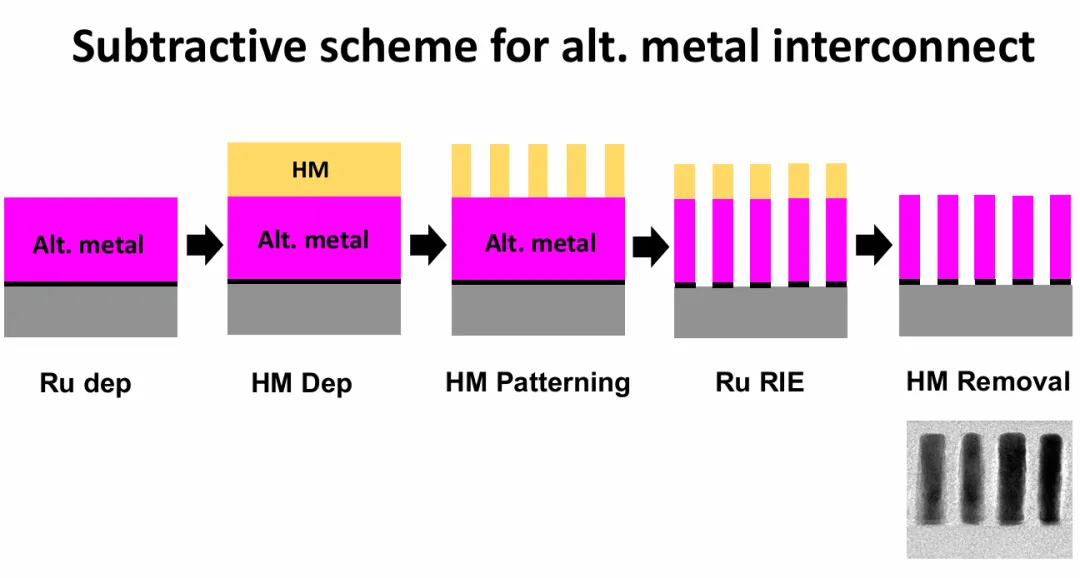
2. TopVia 结构的真正价值
Fully subtractive Ru TopVia 带来的不是“结构好看”,而是实打实的工程收益:
消除 line-via 接口 Via 导体体积最大化 Airgap 不再被 via 打穿 寄生电容降低约9–23%
3. 可靠性不是 PPT
报告给出了明确的实验结果:
TDDB:满足目标要求,无明显 spacing 依赖 EM:在相似尺寸下,优于已知 Cu damascene 数据 EM 失效位置出现在 Cu feeder,而非 Ru 本体
这意味着:Ru 本身并不是系统中的短板。
六、写在最后:这份报告真正想告诉我们的
这不是一份“预测未来”的报告,而是在回答一个现实问题:
如果今天就要往 1 nm 走,互连该怎么办?
IEDM 给出的答案非常务实:
Cu 仍然能用,但只能在“被极度优化的延续路线”中使用 真正面向未来节点的互连,必须接受: 材料改变 结构改变 集成方式改变 Subtractive Ru + TopVia + Airgap,是目前少数同时满足物理、工艺和可靠性的现实方案
晶体管还在往前冲,而互连,已经开始决定谁能真正走到终点。
如果您喜欢学芯屋的内容,想看到更多半导体芯片设计&制造相关的知识,可以点击“在看”、“转发”、“点赞”,并在评论区留言想学习的内容,博主会抽出时间加急更新,请点击下面的名片加关注并设星标,学芯屋知识星球会分享更多有价值的文献报告等等,欢迎各位加入!



