本文从替代可行性、核心优劣势、时间节点、适用场景与现存问题五方面,对未来“玻璃基板替代有机基板” 发展趋势进行分析。
一、替代可行性:高端先进封装 “刚需替代”,中低端 “长期共存”
1)在AI时代有机基板(ABF/BT 树脂)暴露出的不足
- 高频损耗大:Df≈0.01–0.03,112Gbps+ SerDes 信号衰减严重,带宽利用率低。
- 热膨胀失配:CTE≈50–70 ppm/℃,与硅(~3 ppm/℃)差异大;大尺寸 FC-BGA/Chiplet 易翘曲、焊点失效、良率低。
- 细线路极限:L/S≈5–8 μm,I/O Pitch<30 μm、I/O 数>2000 时难以支撑。
- 高温稳定性差:Tg≈180–220℃,高功率 AI/GPU 长期工作易变形、可靠性下降。
2)玻璃基板(硼硅 / 石英)的核心优势
- 超低介电损耗:Df≈0.001–0.003,比有机低一个量级,支撑 224Gbps + 高频高速。
- CTE 可精准匹配:3–9 ppm/℃,热应力极小,大尺寸 / 多芯片封装翘曲显著改善。
- 纳米级平整度:粗糙度<4 nm,支撑 L/S<2 μm 的高密度 RDL,I/O 密度提升 10 倍 +。
- 热稳定性好:Tg>500℃,导热优于有机,散热效率提升,适合高功率芯片。
- 大尺寸面板化:可做 700×700 mm,面板级工艺提升产能、降低单位成本。
结论:在 AI/HPC/ 高端 FC-BGA/Chiplet 领域,玻璃基板替代有机基板具备强技术必然性;中低端消费 / 工业 PCB 短期无经济性,长期共存。

二、核心优劣势对比

根据目前公开的信息,预计2026 导入、2028 放量、2030 高端主导
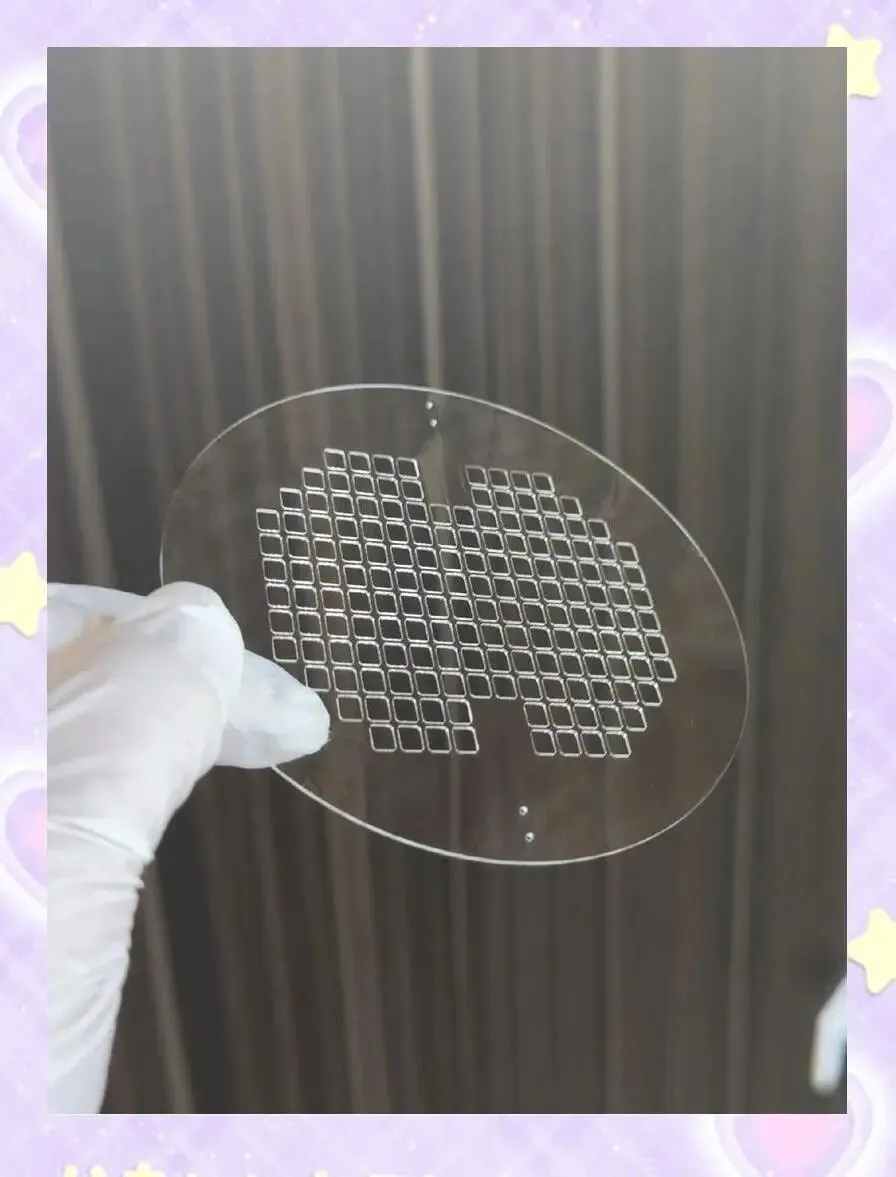
1)全球龙头路线图(2026–2030)
2026 年:小批量商业化试产;英特尔 / 台积电 / 三星 / 苹果验证,AI 服务器芯片(如 Baltra)率先导入。
2027 年:试点产线落地;台积电 CoPoS、英特尔 EMIB 玻璃基板量产线投产,良率爬坡至 85%+。
2028–2029 年:快速放量;高端 FC-BGA/Chiplet 渗透率达 20%–30%,价格或下降至有机的 1.5–2 倍。
2030 年:高端主导;AI/GPU/ 高速光模块领域渗透率超 50%,中低端仍以有机为主。
2)中国产业链节奏(滞后国际约 1 年)预计2028 年:国内载板厂或小批量试产,配套国产 AI 芯片与光模块。

四、玻璃基板适用场景:
1)玻璃基板(2026–2028 导入)
AI 训练芯片 / GPU、高端 FC-BGA、高速光模块 / CPO等或逐渐导入玻璃基板
2.5D/3D 先进封装:替代硅中介层,降本 + 提升产能。
2)有机基板(2030 年前或维持有机)
消费电子 PCB:手机 / 平板 / 笔记本,成本敏感、性能要求低。
工业 / 汽车普通 PCB:非高速、非高功率,性价比优先。
低端服务器 / 通信板卡:<56Gbps SerDes,有机板足够。
本图文来自于网络公开信息,不代表本公众号立场,如需采用该文介绍的技术进行应用,请认真进行核实。如果您认为平台推送文章侵犯了您的知识产权,请及时联系我们(54634889@QQ.com),我们将第一时间删除。如何免费获取高清PDF全文资料
更多阅读:
韩国CCL短缺达到危机水平,价格创历史新高,部分PCB企业待料停工
T-glass供不应求,国内玻纤巨头持续加码低膨胀纤维电子纱项目,新增产能240吨
日东纺(Nittobo)2025年度第3四半期決算説明会主要質疑応答
宏和科技拟投资7.2亿元建设年产1254吨高性能玻纤纱产线等项目,抢占AI风口
日东纺(nittobo)中期业绩说明会,T玻璃供不应求,竞争者供应量未达到足够水平
泰山玻纤:打破国外独家垄断,为AI芯片“贴”上国产“退热贴”

# 扫描上方二维码,添加小编微信 #
# 申请请备注公司+姓名+职位 #
更多关于
玻璃纤维/复合材料/碳纤/电子纱/PCB/玄武岩纤维
LOW-DK/LOW-CET/CCL


