今天分享的是2025年10月英飞凌发布了第二版SiC功率半导体可靠性白皮书,相比于2020年的第一版增加了很多内容。计划分10期进行解读。
《英飞凌如何控制和保证基于SiC的功率半导体器件的可靠性白皮书》的中英文原文链接已放置在评论区。
SiC MOSFET栅氧可靠性简介
过去十年SiC 技术已发展得基本成熟,SiC MOS 器件的栅极氧化层可靠性已逐步取得改进。SiC的栅氧可靠性可以使用Si技术的许多专业知识,例如基于SiC的SiO2的物理击穿场强与Si 器件上的SiO2相似。SiC MOSFET的栅氧可靠性之所以不如Si MOSFET,是由于“外在 (extrinsic)”缺陷导致的,这些外在的缺陷(或称为非本征缺陷)导致栅氧发生细微变形,致使局部栅氧变薄(图1),这些变形可能源自于外延层 (EPI) 或衬底 (Sub) 缺陷、金属杂质、颗粒或在器件制造过程中掺入到栅氧中的其他外来杂质。
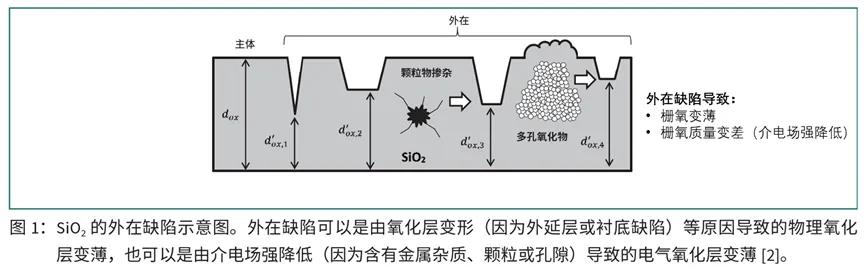
SiC MOSFET栅氧筛查
SiC MOSFET结束流片时,因为具有更大数量的杂质缺陷,栅氧通常有更高的早期失效概率(图2)。
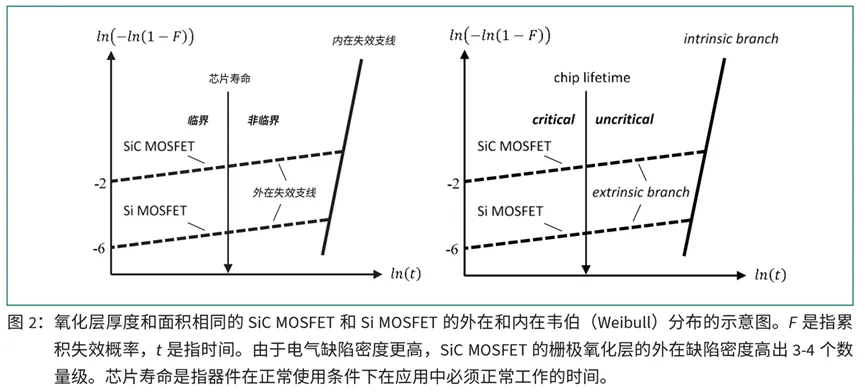
图2解读:图2是Weibull分布图,用来比较SiC和Si MOSFET的栅氧失效概率,可以看出SiC材料的缺陷多,从而导致SiC器件的外在失效概率高,所以必须要对SiC器件做高压筛查以筛除“临界”器件。
坐标轴:纵轴ln(-ln(1-F))是累积失效概率F的“双重对数变换”,这是Weibull分布的标准画法;横轴ln(t)表示时间t的对数。
两条虚线:表示SiC和Si MOSFET栅氧的外在 (extrinsic) 失效支线,SiC MOSFET的“虚线”比Si的要高4个单位,表示在相同时间下,SiC的失效概率远高于Si,这对应了文中所说的“SiC MOSFET的栅极氧化层的外在缺陷密度高出3-4个数量级”
陡峭的实线:表示内在(intrinsic)失效支线,器件使用时间足够长的时候,存在外在缺陷的器件都失效完了,就会进入到本征(内在)失效阶段。这条线非常陡峭(β值大),表示器件一旦进入本征失效阶段,失效概率就会急剧上升,这是由栅氧材料本身极限决定的,所以SiC和Si的这条支线相似。
临界与非临界区域:左侧临界区域表示在芯片的设计寿命内就可能失效,这很危险,必须将这些器件剔除掉,右侧的非临界区域表示器件在芯片设计寿命内不会失效,或者说器件的实际寿命大于设计寿命,是安全的。
在终测中筛除缺陷器件,通常需要对每个器件施加预定幅值和时间的高栅压应力脉冲,从而使具有关键外部缺陷的器件失效,而没有外部缺陷的,或只存在非关键外部缺陷的器件则不会受损,也不会出现电性能退化(如Vth或Ron),通过筛查的剩余器件具有更高的栅氧可靠性。
要想实现快速高效栅压筛查,栅氧必须比固有的本征寿命所需栅氧厚度要厚很多,栅氧越厚就越能使用比器件典型应用电压高很多的筛查电压,同时保证不损坏无缺陷器件。筛查电压与应用电压之比越大,筛查效率越高。通过在终测中剔除缺陷器件,客户面临的潜在可靠性问题就能被器件制造商微小良率损失所取代。
但是更厚的栅氧会导致MOS沟道电阻升高,因为MOS沟道电阻与栅氧厚度成正比,然而在SiC功率MOSFET 中,沟道电阻仅占导通电阻的一小部分,其余占比较大的部分包括JFET区、漂移区以及衬底电阻。高筛查效率带来的优异的栅氧可靠性,是以Ron略微增大为代价的,虽然难以避免这种在可靠性与性能之间进行的折中,但可以利用Ron和栅氧可靠性与栅极氧化层厚度的相关性不同的这一事实:随着栅氧厚度增加,栅氧可靠性呈指数级改善,Ron仅呈线性增加,且只影响沟道电阻。此外在漂移区电阻更为突出的高温条件下,略微加厚的栅氧所带来的性能损失反倒更小。
总之,使用较厚的栅氧只需牺牲一丁点儿性能就能显著提升筛查效率,从而提高整体可靠性。因此英飞凌从一开始就决定采用沟槽式MOSFET技术,其中一个原因是,沟槽器件与栅氧更厚的平面结构相比,在器件通态时栅氧上电场强度较小且沟道电导率明显更高。因此,较厚栅氧所带来的沟道电阻增加,在沟槽式器件中要小得多。因此英飞凌沟槽SiC MOSFET 能够采用更厚的栅氧以实现更高的筛查电压与可靠性,同时仍能保持极低的沟道电阻。
筛选 vs. 老化
相比在高电压和室温条件下进行的栅极电压筛查,传统的栅极电压老化试验(burn-in)是一种不太理想的替代方案。老化试验通常使用更低栅压与更高温度进行更长时间的应力试验。
对比栅压筛查,老化试验的优势在于:由于电压水平大幅降低(通常甚至不到工作栅极电压的两倍),因此原则上也适用于栅氧更薄的SiC MOSFET。然而,即使应力持续时间更长、温度更高,老化测试也很难、甚至无法实现与栅极电压筛查类似的外在筛查效率。这是外在栅氧击穿的本质决定的:其对栅极电压水平呈指数依赖,应力持续时间与应力温度带来的加速作用则弱得多。
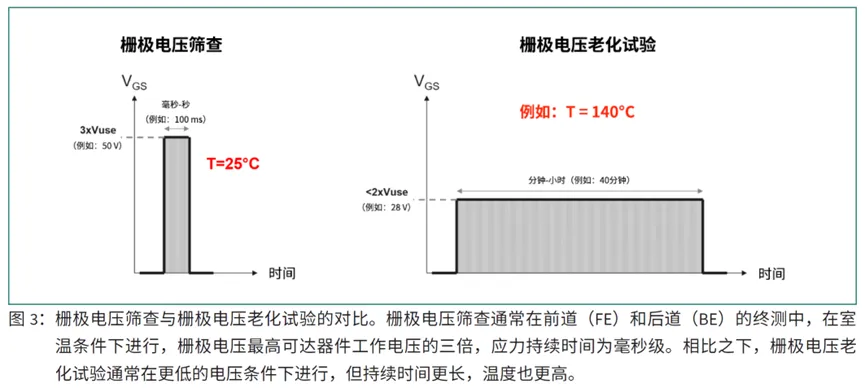
以图3为例,对于工作条件为VGS=+18V, Tj,max=175°C的器件,与栅极老化试验(28V, 40min, 140°C)相比,栅压筛查(50V, 100ms, 25°C)所获得的外在筛查效率达到~50倍。换言之,要达到在50V和25°C条件下持续100ms的栅压筛查所实现的外在筛查效率,需要在28V和140°C条件下进行约1000h的老化试验。如此漫长的老化时间极为不利且成本高昂,并且在高偏压和高温条件下长期施加栅极应力,可能会导致阈值电压 (Vth) 和Ron发生严重漂移,众所周知,这种偏压温度不稳定性 (BTI) 会引发永久性的电参数退化。
本公众号内容基于英飞凌2025年10月发布的《英飞凌如何控制和保证基于SiC的功率半导体器件的可靠性白皮书》进行整理、分析与解读,版权归原作者所有,本文仅作学术交流与技术讨论,不构成对原文的实质性替代,详细内容请阅读原文,如有不当引用请联系删除。


