关注回复“1”即加入免费报告分享群,每日获取行业研究报告;回复“2022”,获取1000份行业报告合集

资料来源:网络(如有侵权请联系作者删除)
获取方式:PDF完整版文末扫码获取
周包资料:9月第2周
更多资料:2022行业资料包


文章摘要

Q1:混合键合是什么?先进封装已成为驱动算力持续提升的"后摩尔时代"新引擎,键合技术的性能直接决定了集成系统的上限。键合技术本身经历了从引线键合、倒装芯片、热压键合到扇出封装的演进,最终迈向混合键合时代。混合键合通过铜-铜直接键合取代传统凸块,实现了10um以下的超精细间距互连,在互连密度、带宽、能效和单位互连成本上带来数量级提升,是支撑3D堆叠与异构集成的关键突破。其工艺分为晶圆对晶圆(适合存储等均匀小芯片)和芯片对晶圆(适合大芯片及异构集成)。目前,混合键合已在3D NAND、CIS(取代TSV)等领域成熟应用,并正加速向HBM、AI芯片、DDR6+及SolC等高性能计算场景扩展,成为突破算力与带宽瓶颈、重塑产业链价值的核心使能技术。

文章内容

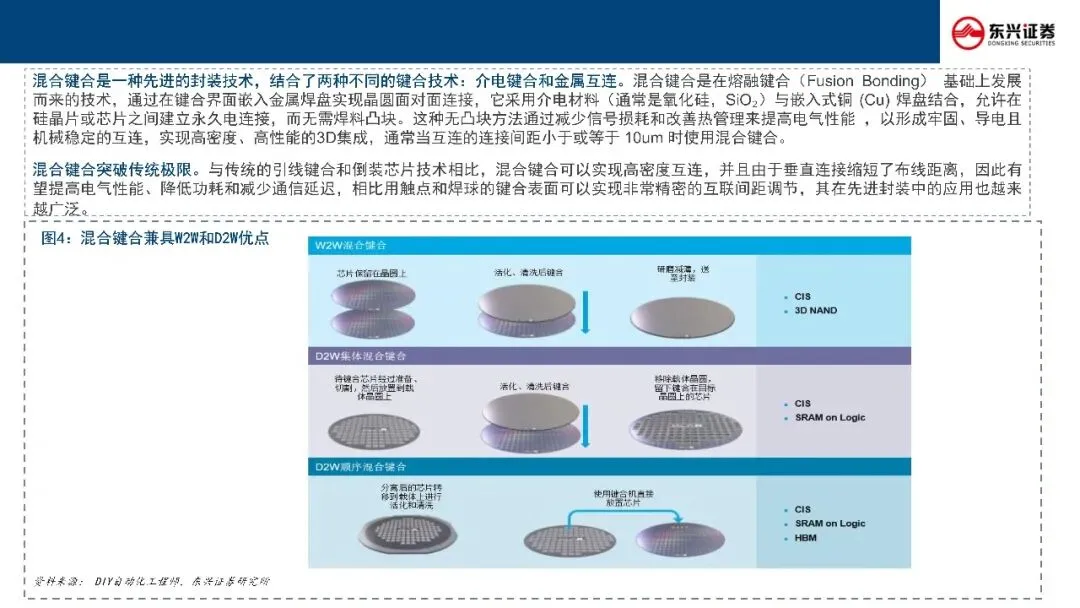
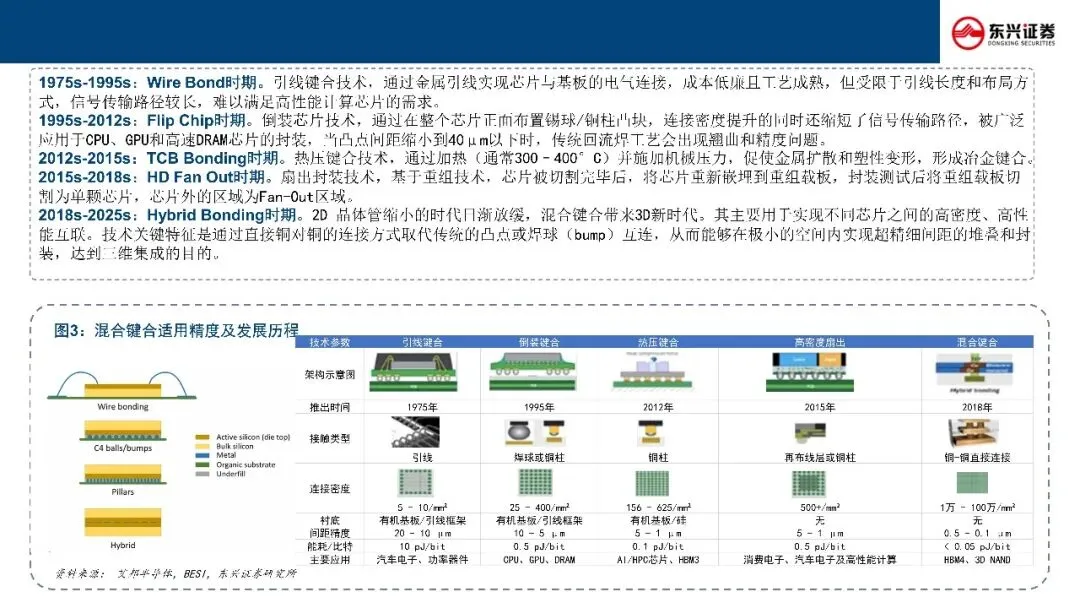


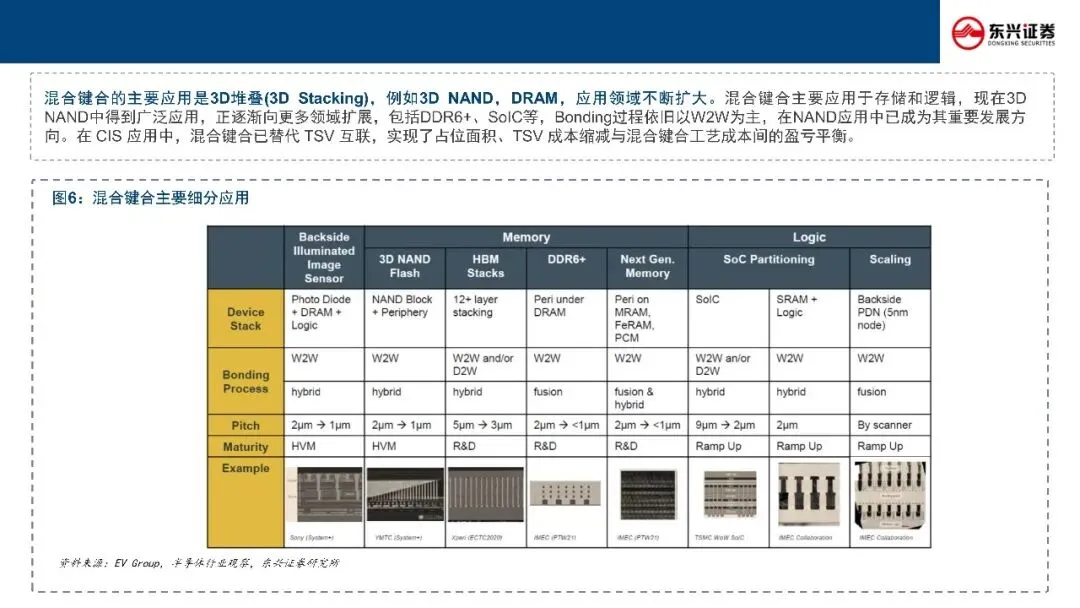

受篇幅限制,仅为部分报告预览
完整版PDF领取方式
长按复制下方【暗号】
半导体行业分析手册之二:混合键合设备,AI算力时代的芯片互连革命与BESI的领航之路-260126-东兴证券-42页
发给客服领取对应资料
识别下面二维码添加客服


----------------------------------------------------------------------
免责声明:以上报告均系本报告通过公开、合法渠道获得,报告版权归原撰写/发布机构所有,如有侵权,请联系作者删除,本报告为推荐阅读,仅供参考学习,不构成投资建议,如对报告内容存疑,请与撰写/发布机构联系。

往期推荐












点个在看你最好看


