зәізұіжҠҖжңҜйўҶеҹҹж¶өзӣ–зәізұіе°әеҜёз§‘еӯҰгҖҒе·ҘзЁӢе’ҢжҠҖжңҜпјҢйҖҡиҝҮжҺ§еҲ¶зү©иҙЁгҖҒеҺҹеӯҗеҲ°еҺҹеӯҗгҖҒеҲҶеӯҗеҲ°еҲҶеӯҗжҲ–еңЁеӨ§еҲҶеӯҗж°ҙе№ідёҠжқҘеҲӣйҖ е…·жңүж–°йў–зү№жҖ§е’ҢеҠҹиғҪзҡ„еҠҹиғҪжқҗж–ҷгҖҒи®ҫеӨҮе’Ңзі»з»ҹгҖӮзәізұіз»“жһ„зҡ„йўҶеҹҹпјҢйҖҡеёёе°әеҜёе°ҸдәҺ100зәізұіпјҢе°әеҜёд»ӢдәҺжҷ®йҖҡгҖҒе®Ҹи§ӮжҲ–д»Ӣи§Ӯе°әеәҰдә§е“ҒгҖҒеҫ®еһӢеҷЁд»¶пјҢжҲ–иҖ…д»ӢдәҺеҚ•дёӘеҺҹеӯҗжҲ–еҲҶеӯҗд№Ӣй—ҙгҖӮеҲ¶йҖ йҮҸеӯҗзӮ№гҖҒзәізұіз®Ўе’ҢзәізұізәӨз»ҙгҖҒи¶…и–„иҶңе’Ңзәізұіжҷ¶дҪ“гҖҒзәізұіеҷЁд»¶зӯүжһ„件еҲ¶е“ҒжңүдёӨз§Қж–№жі•пјҡиҮӘдёӢиҖҢдёҠзҡ„еҗҲжҲҗе’ҢиҮӘдёҠиҖҢдёӢзҡ„е°ҸеһӢеҢ–гҖӮ
иҮӘдёӢиҖҢдёҠзҡ„ж–№жі•е·§еҰҷең°жҺ§еҲ¶дәҶзәізұіе°әеәҰз»“жһ„зҡ„жһ„е»әгҖӮиҝҷз§Қж–№жі•йҖҡиҝҮйҖҗдёӘеҺҹеӯҗгҖҒйҖҗдёӘеҲҶеӯҗжһ„е»әжқҘеЎ‘йҖ йҮҚиҰҒзҡ„еҠҹиғҪз»“жһ„гҖӮз ”з©¶дәәе‘ҳжӯЈеңЁеҠӘеҠӣеҜ»жүҫвҖңиҮӘз»„иЈ…вҖқзҡ„жңәеҲ¶гҖӮвҖңиҮӘз»„иЈ…вҖқж¶үеҸҠдәәдҪ“жңҖеҹәжң¬зҡ„жҲҗеҲҶиҮӘжҲ‘еӨҚеҲ¶жңҖеҹәжң¬зҡ„з»“жһ„гҖӮвҖңиҮӘз»„иЈ…вҖқж¶өзӣ–дәҶйҖҡиҝҮдҪҝз”ЁеҺҹеӯҗе’ҢеҲҶеӯҗжһ„е»әдәӢзү©гҖҒз”ҹй•ҝжҷ¶дҪ“е’ҢеҲӣе»әзәізұіз®ЎпјҢжқҘеҲӣе»әеҠҹиғҪеҚ•е…ғгҖӮ
вҖңиҮӘдёҠиҖҢдёӢвҖқжҳҜдёҖз§Қе°ҶдәӢзү©д»ҺеӨ§еһӢз»“жһ„зј©е°Ҹдёәе°ҸеһӢз»“жһ„зҡ„ж–№жі•гҖӮдҫӢеҰӮпјҢзңҹз©әз®Ўи®©дҪҚдәҺжҷ¶дҪ“з®ЎпјҢ然еҗҺи®©дҪҚдәҺICпјҲIntegrated CircuitйӣҶжҲҗз”өи·ҜпјүпјҢжңҖз»Ҳи®©дҪҚдәҺLSIпјҲLarge Scale Integrated CircuitпјҡеӨ§и§„жЁЎйӣҶжҲҗз”өи·ҜпјүгҖӮиҝҷз§ҚйҖҡиҝҮд»ҺеҺҳзұіе°әеҜёзј©е°ҸеҲ°еҫ®зұіе°әеҜёжқҘеҲӣйҖ дәӢзү©зҡ„ж–№жі•иў«з§°дёәвҖңеҫ®з”өеӯҗеӯҰвҖқгҖӮ
дј—жүҖе‘ЁзҹҘпјҢеҫ®з”өеӯҗжҠҖжңҜеңЁиҝҮеҺ»еӣӣеҚҒе№ҙдёӯд»ҘжҢҮж•°йҖҹеәҰеҸ‘еұ•гҖӮз”ұдәҺе…¶еә”з”ЁеҠҹиғҪдё°еҜҢгҖҒиҝҗиЎҢиғҪиҖ—дҪҺгҖҒеҲ¶йҖ жҲҗжң¬дҪҺпјҢеҫ®з”өеӯҗеӯҰйҖҡиҝҮж–°еһӢе°ҸеһӢз”өеӯҗеҷЁд»¶зҡ„еҸ‘жҳҺеҮ д№Һиҝӣе…ҘдәҶжҲ‘们з”ҹжҙ»зҡ„еҗ„дёӘж–№йқўгҖӮжңҖйҮҚиҰҒзҡ„иҝӣжӯҘжҳҜе°Ҷеҫ®з”өеӯҗеӯҰеҸҠе…¶еҲ¶йҖ ж–№жі•жү©еұ•еҲ°и®ёеӨҡйқһз”өеӯҗйўҶеҹҹпјҢдҫӢеҰӮеҫ®еһӢиҮҙеҠЁеҷЁгҖҒеҫ®еһӢе–·е°„еҷЁгҖҒеҫ®еһӢдј ж„ҹеҷЁе’Ңеҫ®еһӢDNAжҺўй’ҲгҖӮ
йҡҸзқҖиҝҷйЎ№жҠҖжңҜзҡ„дёҚж–ӯеҸ‘еұ•пјҢе®ғе·Із»Ҹд»Һеҫ®зұіе°әеәҰжү©еұ•еҲ°зәізұіе°әеәҰпјҢеӣ жӯӨеҮәзҺ°дәҶвҖңзәізұіжҠҖжңҜвҖқжҲ–вҖңзәізұіеҲ¶йҖ вҖқзҡ„еӯҳеңЁгҖӮеҲ©з”ЁзәізұіжҠҖжңҜпјҢеӨ§и§„жЁЎз”ҹдә§зҡ„еҚҠеҜјдҪ“еҷЁд»¶дёҠзҡ„жңҖзӘ„зәҝеӣҫеҪўзҺ°е·ІжҺҘиҝ‘50nmд»ҘдёӢзҡ„ж°ҙе№ігҖӮеңЁз ”究е®һйӘҢе®ӨдёӯпјҢеҷЁд»¶зү№еҫҒе°әеҜёзҡ„ж°ҙе№іе°әеҜёе·Ід»Һ130nmиҝӣдёҖжӯҘзј©е°ҸиҮі6nmд»ҘдёӢпјҢеһӮзӣҙе°әеҜёе·ІеҮҸе°ҸиҮіе°ҸдәҺ1.5nmжҲ–еҮ дёӘеҺҹеӯҗгҖӮиҝҷдәӣиў«з§°дёәвҖңзәізұіеҷЁд»¶вҖқзҡ„зәізұізә§еҷЁд»¶жҳҜйҖҡиҝҮиҮӘдёҠиҖҢдёӢзҡ„е°ҸеһӢеҢ–ж–№жі•иҺ·еҫ—зҡ„гҖӮ
иҮӘдёҠиҖҢдёӢзҡ„еҫ®еһӢеҢ–еҠ е·Ҙж–№жі•зҡ„ж ёеҝғжҳҜзәізұіе…үеҲ»жҠҖжңҜпјҢеҰӮз”өеӯҗжқҹе…үеҲ»EBLпјҡElectron Beam LithographyгҖҒзәізұіеҺӢеҚ°е…үеҲ»NILпјҡNanoimprint LithographyгҖҒXе°„зәҝе…үеҲ»XRLпјҡX-ray Lithographyе’ҢжһҒзҙ«еӨ–е…үеҲ»EUVLпјҡExtreme Ultraviolet LithographyгҖӮеңЁиҝҷеӣӣз§Қзәізұіе…үеҲ»жҠҖжңҜдёӯпјҢEBLж–№жі•еӣ е…¶иғҪеӨҹе°Ҷз”өеӯҗжқҹзІҫзЎ®иҒҡз„Ұе’ҢжҺ§еҲ¶еңЁеҗ„з§Қеҹәеә•дёҠиҖҢжҲҗдёәиҝҪжұӮз»ҲжһҒзәізұіз»“жһ„зҡ„йўҶи·‘иҖ…гҖӮе®һйӘҢиҜҒжҳҺпјҢз”өеӯҗжқҹеҸҜд»ҘиҒҡз„ҰеҲ°1зәізұід»ҘдёӢгҖӮеҰӮжһңжңүеҗҲйҖӮзҡ„жҠ—иҡҖжҖ§жқҗж–ҷпјҢиҝҷе°ҶдҪҝEBLзҡ„еҲҶиҫЁзҺҮжү©еұ•еҲ°дәҡзәізұіеҢәеҹҹгҖӮ
з”өеӯҗжқҹе…үеҲ»жҠҖжңҜжҳҜдёҖз§ҚйҖҡиҝҮе°ҶеҜ№з”өеӯҗж•Ҹж„ҹзҡ„иЎЁйқўжҡҙйңІеңЁз”өеӯҗжқҹдёӯжқҘеҲ¶йҖ дәҡеҫ®зұізә§е’Ңзәізұізә§зү№еҫҒзҡ„ж–№жі•гҖӮе®ғеҲ©з”ЁдәҶжҹҗдәӣеҢ–еӯҰзү©иҙЁеңЁз”өеӯҗз…§е°„дёӢдјҡж”№еҸҳе…¶зү№жҖ§зҡ„дәӢе®һпјҢе°ұеғҸз…§зӣёиғ¶зүҮеңЁе…үз…§е°„дёӢдјҡж”№еҸҳе…¶зү№жҖ§дёҖж ·гҖӮйҖҡиҝҮи®Ўз®—жңәжҺ§еҲ¶з”өеӯҗжқҹзҡ„дҪҚзҪ®пјҢеҸҜд»ҘеңЁиЎЁйқўеҶҷе…Ҙд»»ж„Ҹз»“жһ„пјҢд»ҺиҖҢдҪҝеҺҹе§Ӣж•°еӯ—еӣҫеғҸзӣҙжҺҘиҪ¬з§»еҲ°зӣёе…іеҹәеә•дёҠгҖӮжү«жҸҸз”өеӯҗжҳҫеҫ®й•ңй—®дё–еҗҺдёҚд№…пјҢEBLд№ҹйҡҸд№Ӣй—®дё–гҖӮеҮ д№Һд»ҺдёҖејҖе§Ӣе°ұжңүдҪҺдәҺ100nmеҲҶиҫЁзҺҮзҡ„жҠҘйҒ“гҖӮж—©еңЁ1964е№ҙпјҢBroersе°ұжҠҘйҒ“дәҶз”Ё10nmе®Ҫзҡ„з”өеӯҗжқҹеңЁйҮ‘еұһиҶңдёҠд»ҘзҰ»еӯҗеҲ»иҡҖеҮә50nmзҡ„зәҝгҖӮеҗҺжқҘеңЁ1976е№ҙпјҢйҡҸзқҖз”өеӯҗе…үеӯҰжҠҖжңҜзҡ„ж”№иҝӣпјҢжҠҘйҒ“дәҶдҪҝз”Ё0.5nmжҺўй’ҲеңЁAu-PdдёҠеҲ»з”»еҮә8nmзҡ„зәҝгҖӮ1984е№ҙпјҢеҲ©з”ЁEBLжҠҖжңҜеҲ¶йҖ еҮәдәҶеҠҹиғҪжӯЈеёёзҡ„Aharonov-Bohmе№Іж¶үеҷЁд»¶гҖӮMurayзӯүдәәжҠҘйҒ“дәҶйҮ‘еұһеҚӨеҢ–зү©жҠ—иҡҖеүӮдёӯ1еҲ°2nmзҡ„зү№еҫҒгҖӮзӣҙеҲ°жңҖиҝ‘пјҢEBLеҮ д№ҺеҸӘз”ЁдәҺеҲ¶йҖ з ”з©¶е’ҢеҺҹеһӢзәізұіз”өеӯҗеҷЁд»¶гҖӮзӣ®еүҚпјҢе…¶зІҫеәҰе’Ңзәізұіе…үеҲ»иғҪеҠӣдҪҝе…¶жҲҗдёәдёәе…¶д»–е…Ҳиҝӣе…үеҲ»ж–№жі•еҲ¶дҪңжҺ©иҶңзҡ„йҰ–йҖүе·Ҙе…·гҖӮ
еңЁEBLзәізұіеҲ¶йҖ дёӯпјҢйңҖиҰҒеңЁз”өеӯҗж•Је°„еҜјиҮҙжңҖе°Ҹзҡ„жҠ—иҡҖеүӮжӣқе…үзҡ„е·ҘдҪңжқЎд»¶дёӢиҝӣиЎҢгҖӮдёәдәҶе®һзҺ°иҝҷдёҖзӣ®ж ҮпјҢйңҖиҰҒдҪҝз”Ёй«ҳиғҪжҲ–дҪҺиғҪз”өеӯҗгҖӮеңЁй«ҳиғҪжғ…еҶөдёӢпјҢз”өеӯҗжқҹйҖҡиҝҮеј№жҖ§ж•Је°„еңЁжҠ—иҡҖеүӮдёӯзҡ„еұ•е®ҪжҳҜжңҖе°Ҹзҡ„пјҢ并且з”өеӯҗжқҹеҸҜд»Ҙж·ұе…Ҙеҹәеә•гҖӮдҪҺиғҪз”өеӯҗж–№жі•д№ӢжүҖд»Ҙжңүж•ҲпјҢжҳҜеӣ дёәз”өеӯҗиғҪйҮҸеӨӘдҪҺпјҢж— жі•еңЁжҠ—иҡҖеүӮдёӯж•Је°„еҫҲиҝңзҡ„и·қзҰ»гҖӮ
EBLзі»з»ҹжҳҜжү«жҸҸз”өеӯҗжҳҫеҫ®й•ң(SEM) еҸҚеҗ‘е·ҘдҪңзҡ„з»“жһңпјҢеҚіз”Ёе®ғжқҘд№ҰеҶҷиҖҢдёҚжҳҜиҜ»еҮәгҖӮеӣ жӯӨпјҢе…¶и§ҶйҮҺе’ҢеҗһеҗҗйҮҸеҸ—еҲ°иҜҘе·ҘдҪңеҺҹзҗҶжҖ§иҙЁзҡ„йҷҗеҲ¶гҖӮдёҺSEMзұ»дјјпјҢEBLзі»з»ҹз”ұдёүдёӘеҹәжң¬йғЁеҲҶз»„жҲҗпјҡз”өеӯҗжһӘгҖҒзңҹз©әзі»з»ҹе’ҢжҺ§еҲ¶зі»з»ҹгҖӮеӣҫ1жҳҫзӨәдәҶEBLзі»з»ҹзҡ„зӨәж„ҸеӣҫгҖӮ
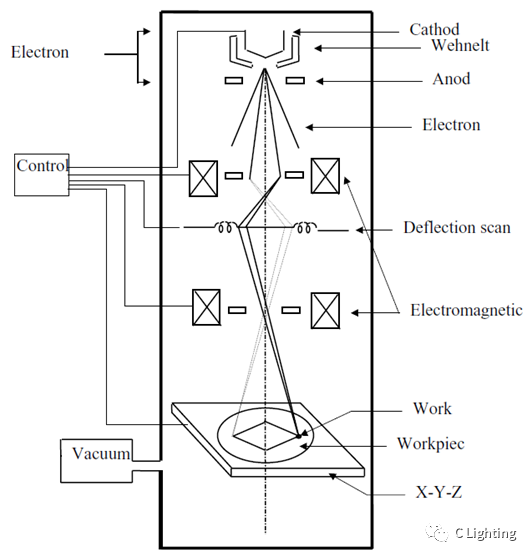
з”өеӯҗжһӘжҳҜдёҖз§Қдә§з”ҹгҖҒеҠ йҖҹгҖҒиҒҡз„Ұз”өеӯҗжқҹ并е°Ҷе…¶жҠ•е°„еҲ°еҹәжқҝдёҠзҡ„иЈ…зҪ®гҖӮз”өеӯҗйҰ–е…Ҳз”ұйҳҙжһҒжҲ–з”өеӯҗеҸ‘е°„жәҗдә§з”ҹгҖӮ然еҗҺпјҢз”өеӯҗйҖҡиҝҮйқҷз”өеңәеҠ йҖҹд»ҘиҺ·еҫ—жӣҙй«ҳзҡ„еҠЁиғҪпјҢ并еҪўжҲҗй«ҳиғҪз”өеӯҗжқҹгҖӮжңҖеҗҺпјҢз”ұз”өгҖҒзЈҒиҒҡз„ҰйҖҸй•ңе’ҢеҒҸиҪ¬зі»з»ҹз»„жҲҗзҡ„еј•еҜјзі»з»ҹе°Ҷз”өеӯҗжқҹдј иҫ“еҲ°еҹәзүҮдёҠзҡ„е·ҘдҪңзӮ№гҖӮз”өеӯҗжқҹеҸӘжңүеңЁй«ҳзңҹз©әзҺҜеўғдёӢжүҚиғҪжӯЈеёёдә§з”ҹе№¶ж— йҷҗеҲ¶ең°дј ж’ӯеҲ°еҹәзүҮдёҠгҖӮж №жҚ®з”өеӯҗжһӘдҪҝз”Ёзҡ„жқҗж–ҷе’Ңз”өеӯҗжқҹеҠ е·Ҙзҡ„еә”з”ЁпјҢеҜ№зңҹз©әеәҰзҡ„иҰҒжұӮйҖҡеёёеңЁ10-4еҲ°10-8Paд№Ӣй—ҙгҖӮеӣ жӯӨпјҢеңЁз”өеӯҗжһӘе’Ңе·ҘдҪңи…”еҶ…еҪўжҲҗзңҹз©әзҺҜеўғзҡ„зңҹз©әзі»з»ҹиў«и®ӨдёәжҳҜз”өеӯҗжқҹеҠ е·Ҙи®ҫеӨҮдёӯжңҖйҮҚиҰҒзҡ„йғЁд»¶д№ӢдёҖгҖӮ
жҺ§еҲ¶зі»з»ҹдёәз”өеӯҗжқҹзҡ„дә§з”ҹгҖҒдј иҫ“е’Ңе®ҡж—¶жҸҗдҫӣж“ҚжҺ§иғҪеҠӣгҖӮе®ғиҝҳжҸҗдҫӣеҜ№еҹәзүҮ平移е’Ңе…¶д»–еҠҹиғҪзҡ„жҺ§еҲ¶гҖӮйҖҡиҝҮеҹәзүҮ平移е’Ңз”өеӯҗжқҹжү«жҸҸд№Ӣй—ҙзҡ„еҚҸи°ғпјҢеҸҜд»Ҙе°ҶAutoCADи®ҫи®ЎиҪ¬з§»еҲ°з”өеӯҗжқҹжҠ—иҡҖеүӮи–„еұӮдёҠгҖӮ
з”өеӯҗжқҹе…үеҲ»зҡ„зҗҶи®әеҸҜд»ҘйҖҡиҝҮз”өеңәе’ҢзЈҒеңәдёӯзҡ„з”өеӯҗиҝҗеҠЁд»ҘеҸҠеҹәжң¬зҡ„з”өеӯҗе…үеӯҰе…ғ件жқҘзҗҶи§ЈгҖӮдёҖиҲ¬жқҘиҜҙпјҢз”өеңәе’ҢзЈҒеңәдёӯзҡ„з”өеӯҗиҝҗеҠЁеҸҜд»Ҙз”ЁйәҰе…Ӣж–ҜйҹҰж–№зЁӢз»„жқҘжҸҸиҝ°гҖӮ然иҖҢпјҢд»…д»…йҖҡиҝҮе°Ҷиҫ№з•ҢжқЎд»¶пјҲthe boundary conditionsпјүеә”з”ЁдәҺйәҰе…Ӣж–ҜйҹҰж–№зЁӢз»„жқҘи§ЈеҶіз”өеӯҗжқҹзі»з»ҹзҡ„е®һйҷ…и®ҫи®Ўй—®йўҳжҳҜйқһеёёеӣ°йҡҫзҡ„гҖӮеӣ жӯӨпјҢжң¬иҠӮд»…з»ҷеҮәеҹәжң¬зҡ„з”өеӯҗеҠЁеҠӣеӯҰгҖӮ

е…¶дёӯпјҢqжҳҜз”өеӯҗзҡ„з”өиҚ·пјҢmжҳҜз”өеӯҗзҡ„иҙЁйҮҸпјҢrжҳҜз”өеӯҗзӣёеҜ№дәҺд»»ж„ҸеҺҹзӮ№зҡ„дҪҚзҪ®зҹўйҮҸгҖӮEе’ҢBеҲҶеҲ«иЎЁзӨәз”өеңәе’ҢзЈҒеңәгҖӮvжҳҜз”өеӯҗеңЁзЈҒеңәдёӯзҡ„иҝҗеҠЁйҖҹеәҰгҖӮ
иҖғиҷ‘еҲ°з”өеӯҗжқҹеҸ‘з”ҹй•ңзӯ’зҡ„иҪҙеҜ№з§°еңәзі»з»ҹпјҢз”өеӯҗжқҹйҖҡиҝҮиҪҙзәҝйҷ„иҝ‘зҡ„дёҖдёӘе…¬е…ұзӮ№ж—¶пјҢеҸҜд»ҘйҖҡиҝҮдёҖдёӘзӣёеҜ№жңүйҷҗзҡ„еңәзҡ„еҸҳеҢ–еҢәеҹҹдҪҝз”өеӯҗжқҹйҖҡиҝҮеҸҰдёҖдёӘе…¬е…ұзӮ№гҖӮзұ»жҜ”дәҺе…үе…үеӯҰпјҢе°Ҷ第дёҖдёӘе…¬е…ұзӮ№з§°дёәзү©пјҢ第дәҢдёӘе…¬е…ұзӮ№з§°дёәеғҸпјҢе°Ҷеңәзҡ„еҢәеҹҹз§°дёәз”өеӯҗйҖҸй•ңгҖӮз”өеӯҗйҖҸй•ңзҡ„еұһжҖ§е’ҢеҸӮж•°еҸҜз”ұд»ҘдёӢеҮҶиҪҙеҝғе°„зәҝж–№зЁӢжҺЁеҜјеҫ—еҮәпјҡ

е…¶дёӯV0жҳҜиҪҙдёҠзҡ„з”өеҠҝгҖӮдҫӢеҰӮпјҢз”ұдәҺеҜјж•°V'0е’ҢV"0зӣёеҜ№дәҺV0иҝӣиЎҢеҪ’дёҖеҢ–пјҢеӣ жӯӨеҸҜд»ҘзҗҶи§ЈдёәеҶіе®ҡз”өеӯҗиҪЁиҝ№зҡ„жҳҜеңәеҲҶеёғиҖҢдёҚжҳҜз”өеҠҝејәеәҰгҖӮиҝҷиЎЁжҳҺжүҖжңүе№іиЎҢдәҺиҪҙзәҝзҡ„иҪЁиҝ№пјҢж— и®әе…¶еҲқе§ӢеҚҠеҫ„еҰӮдҪ•пјҢйғҪе…·жңүзӣёеҗҢзҡ„з„ҰзӮ№гҖӮйңҖиҰҒжіЁж„Ҹзҡ„жҳҜпјҢе°„зәҝж–№зЁӢдёӯдёҚеҢ…еҗ«з”өеӯҗз”өиҚ·qе’Ңз”өеӯҗиҙЁйҮҸmгҖӮиҝҷж„Ҹе‘ізқҖиҜҘж–№зЁӢд№ҹйҖӮз”ЁдәҺе…¶д»–зІ’еӯҗпјҢеҰӮзҰ»еӯҗгҖӮеҲ©з”Ёеӣҫ2дёӯзҡ„е°„зәҝзӨәж„ҸеӣҫпјҢеҸҜд»Ҙд»Һе…¬ејҸпјҲ2пјүдёӯеҫ—еҲ°и–„пјҲthinпјүз”өеӯҗйҖҸй•ңзҡ„дёӨдёӘз„Ұи·қдёәпјҡ

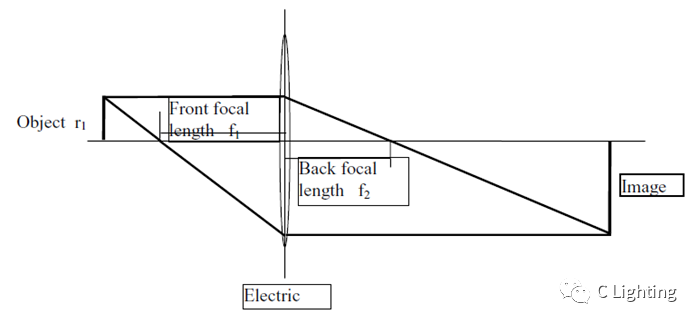
дёӨдёӘз„Ұи·қд№Ӣй—ҙзҡ„е…ізі»дёҺе…үеӯҰдёӯзҡ„е…ізі»зұ»дјјпјҢе…¶дёӯзӣёеҪ“дәҺе…үеӯҰжҠҳе°„зҺҮNiгҖӮ

дёҺз”өеңәдёҖж ·пјҢиҪҙеҜ№з§°зЈҒеңәд№ҹе…·жңүйҖҸй•ңзү№жҖ§пјҢз§°дёәзЈҒйҖҸй•ңгҖӮзЈҒйҖҸй•ңзҡ„еҮҶиҪҙзәҝж–№зЁӢиў«еҶҷдёәпјҡ

е…¶дёӯB0жҳҜиҪҙдёҠзҡ„зЈҒеңәгҖӮжҳҫ然пјҢзЈҒйҖҸй•ңж•Ҳеә”е°ҶеҸ–еҶідәҺз”өеӯҗзҡ„з”өиҚ·е’ҢиҙЁйҮҸгҖӮзЈҒйҖҸй•ңжҳҜеҜ№з§°зҡ„пјҢеӣ дёәеҰӮжһңB0зҡ„з¬ҰеҸ·зӣёеҸҚпјҢж–№зЁӢе°ҶдҝқжҢҒдёҚеҸҳгҖӮзЈҒйҖҸй•ңзҡ„з©әй—ҙдёҚеҸҳжҖ§зЎ®дҝқдәҶеңЁиҪҙйҷ„иҝ‘пјҢиҝӣиЎҢз”өеӯҗжҲҗеғҸж—¶дёҚдјҡеӨұзңҹгҖӮдёҺз”өйҖҸй•ңзұ»дјјпјҢз„Ұи·қдёәпјҡ

з”өеӯҗжқҹеҒҸиҪ¬еҸҜд»ҘйҖҡиҝҮдҪҝз”Ёйқҷз”өе’ҢзЈҒжҖ§Bipole elementжқҘе®һзҺ°гҖӮйқҷз”өеңәдјҡе°ҶйҖҡиҝҮзҡ„з”өеӯҗжқҹеҒҸеҗ‘жӯЈжһҒпјҢиҖҢзЈҒеңәеҲҷе°Ҷз”өеӯҗжқҹеҒҸиҪ¬еҲ°дёҺеңәж–№еҗ‘еһӮзӣҙзҡ„ж–№еҗ‘гҖӮзәҜзЈҒеңәдјҡж”№еҸҳз”өеӯҗиҝҗеҠЁзҡ„ж–№еҗ‘пјҢдҪҶдёҚдјҡж”№еҸҳйҖҹеәҰгҖӮзЈҒеңәдёҺз”өеӯҗи·Ҝеҫ„жӣІзҺҮзҡ„е…ізі»еҸҜеҶҷдёәпјҡ

е…¶дёӯRiжҳҜзһ¬ж—¶жӣІзҺҮдёӯеҝғпјҢОёжҳҜзЈҒеңәе’ҢйҖҹеәҰзҹўйҮҸд№Ӣй—ҙзҡ„и§’еәҰгҖӮ
дёҺе…¶д»–е…үеҲ»д»ӘеҷЁзӣёжҜ”пјҢз”өеӯҗжһӘзҡ„дҪҝз”ЁжҳҜз”өеӯҗжқҹе…үеҲ»жҠҖжңҜзҡ„ж ёеҝғзү№зӮ№гҖӮз”өеӯҗжһӘзҡ„еҺҹзҗҶеҸҜд»ҘйҖҡиҝҮе…үзәҝзҡ„е…үеӯҰдј йҖ’ж–№ејҸжқҘзҗҶи§ЈгҖӮз”өеӯҗе…үеӯҰе…ғ件еҸӘжҳҜе®ғ们зҡ„е…үеӯҰеҜ№еә”зү©гҖӮеӣ жӯӨпјҢжң¬иҠӮе°Ҷдё»иҰҒе…іжіЁз”өеӯҗжһӘпјҢеҢ…жӢ¬еҸ‘е°„жәҗзҡ„з”ҹжҲҗгҖҒз”өеӯҗжқҹж•ҙеҪўе’Ңз”өеӯҗжқҹзҡ„еј•еҜјзі»з»ҹгҖӮ
еҸ‘е°„пјҲemissionпјүпјҡз”өеӯҗеҸ‘е°„жңүдёӨз§ҚгҖӮ第дёҖз§Қз§°дёәзғӯз”өеӯҗеҸ‘е°„пјҢеҪ“еҸ‘е°„жқҗж–ҷиў«еҠ зғӯеҲ°и¶іеӨҹй«ҳзҡ„жё©еәҰж—¶еҸ‘з”ҹгҖӮ第дәҢз§ҚжҳҜз”өеңәеҸ‘е°„пјҢеҚіз”өеӯҗеңЁејәеӨ–еҠ з”өеңәзҡ„дҪңз”ЁдёӢдә§з”ҹгҖӮз”ұдәҺзғӯз”өеӯҗеҸ‘е°„еңЁдә§з”ҹз”өеӯҗж–№йқўе…·жңүжӣҙй«ҳзҡ„ж•ҲзҺҮе’ҢжӣҙдҪҺзҡ„жҲҗжң¬пјҢеӣ жӯӨиў«е№ҝжіӣеә”з”ЁдәҺе·ҘдёҡйўҶеҹҹпјҢиҝҷд№ҹжҳҜжҲ‘们еңЁжӯӨдё»иҰҒе…іжіЁзҡ„й—®йўҳгҖӮ
ж №жҚ®йҮҸеӯҗеҠЁеҠӣеӯҰеҺҹзҗҶпјҢз”өеӯҗеңЁ0в—ҰKж—¶еӨ„дәҺеҹәжҖҒйқҷжӯўпјҢе…¶иғҪзә§е’ҢиғҪеёҰжҳҜжҳҺзЎ®е®ҡд№үзҡ„гҖӮйҡҸзқҖеҢ–еҗҲзү©жё©еәҰзҡ„еҚҮй«ҳпјҢдёҖдәӣз”өеӯҗиҺ·еҫ—жӣҙеӨҡиғҪйҮҸ并и·ғиҝҒеҲ°жӣҙй«ҳзҡ„иғҪзә§гҖӮеӣ жӯӨиғҪеёҰе®ҪеәҰеўһеҠ гҖӮеҪ“жё©еәҰи¶іеӨҹй«ҳж—¶пјҢз”өеӯҗиҺ·еҫ—и¶іеӨҹзҡ„иғҪйҮҸжқҘе…ӢжңҚеӨ©з„¶еұҸйҡңпјҢеҚійҳ»жӯўе®ғ们йҖғйҖёзҡ„еҠҹеҮҪж•°гҖӮзү№еҲ«жҳҜпјҢйҡҸзқҖжё©еәҰзҡ„еҚҮй«ҳпјҢйҮ‘еұһдј еҜјеёҰзҡ„дёҠйҷҗдјҡжЁЎзіҠ并延伸гҖӮдёҖдәӣдј еҜјз”өеӯҗиҺ·еҫ—и¶іеӨҹзҡ„иғҪйҮҸжқҘе…ӢжңҚйҮ‘еұһиЎЁйқўзҡ„еҠҝеһ’гҖӮ然еҗҺпјҢиҝҷдәӣз”өеӯҗеҸҜд»ҘйҖҡиҝҮж–ҪеҠ йҖӮеҪ“зҡ„з”өеңәиў«еҗёеј•еҮәжқҘгҖӮеҰӮжһңз”өеңәи¶іеӨҹй«ҳпјҢиғҪеӨҹд»ҺеҠҹеҮҪж•°дёәЙёзҡ„йҳҙжһҒдёӯеҗёеҸ–жүҖжңүеҸҜз”Ёзҡ„з”өеӯҗпјҢеҲҷеңЁжё©еәҰ T дёӢиҺ·еҫ—зҡ„йҘұе’Ңз”өжөҒеҜҶеәҰ J пјҲз”ұи‘—еҗҚзҡ„Richardson-Dushmanе®ҡеҫӢз»ҷеҮәпјүпјҢе…¶дёӯAжҳҜз”ұжқҗж–ҷеҶіе®ҡзҡ„еёёж•°пјҢkжҳҜзҺ»е°”е…№жӣјеёёж•°гҖӮ

еңЁе®һйҷ…зҡ„з”өеӯҗжһӘи®ҫи®ЎдёӯпјҢз”өеӯҗжһӘзҡ„з”өжөҒйҖҡеёёе°ҸдәҺйҘұе’Ңз”өжөҒгҖӮеңЁиҝҷз§Қжғ…еҶөдёӢпјҢз”өеңәзҡ„ејәеәҰдёҚи¶ід»Ҙд»ҺйҳҙжһҒеҗёиө°жүҖжңүеҸҜз”Ёзҡ„иҮӘз”ұз”өеӯҗгҖӮеӣ жӯӨпјҢж®ӢдҪҷз”өеӯҗиҒҡйӣҶеңЁйҳҙжһҒиЎЁйқўйҷ„иҝ‘пјҢеҪўжҲҗз”өеӯҗдә‘еұӮгҖӮиҝҷз§Қе·ҘдҪңж–№ејҸиў«з§°дёәз©әй—ҙз”өиҚ·йҷҗеҲ¶еҸ‘е°„пјҢе…¶дјҳзӮ№жҳҜеңЁйҳҙжһҒзЁҚеүҚж–№еҪўжҲҗдёҖдёӘиҫғе°Ҹзҡ„иҷҡжӢҹйҳҙжһҒпјҢиҜҘиҷҡжӢҹйҳҙжһҒе…·жңүзЁіе®ҡзҡ„з”өиҚ·еҜҶеәҰпјҢеҹәжң¬дёҠдёҺйҳҙжһҒжё©еәҰж— е…ігҖӮе№іиЎҢз”өжһҒд№Ӣй—ҙзҡ„з”өжөҒз”ұChildе®ҡеҫӢз»ҷеҮәпјҢе…¶дёӯпјҢVжҳҜеҠ йҖҹз”өеҺӢпјҢLжҳҜйҳҙжһҒе’ҢйҳіжһҒд№Ӣй—ҙзҡ„и·қзҰ»пјҡ

еӣҫ3жҳҫзӨәдәҶз©әй—ҙз”өиҚ·йҷҗеҲ¶еҸ‘е°„е’Ңжё©еәҰзӣёе…іеҸ‘е°„иҢғеӣҙеҶ…зҡ„з”өжөҒеҜҶеәҰгҖӮз”өеӯҗжһӘдёӯзҡ„еӨ§еӨҡж•°йҳҙжһҒеңЁз©әй—ҙз”өиҚ·е’ҢйҘұе’ҢзҠ¶жҖҒд№Ӣй—ҙзҡ„иҝҮжёЎиҢғеӣҙеҶ…е·ҘдҪңпјҢд»ҘдҫҝеҸҜд»ҘеңЁжңҖдҪҺзҡ„йҳҙжһҒжё©еәҰдёӢиҺ·еҫ—жүҖйңҖзҡ„еҸ‘е°„з”өжөҒеҜҶеәҰгҖӮж–№зЁӢпјҲ9пјүе’ҢпјҲ10пјүз»ҷеҮәдәҶд»Һз»ҷе®ҡйҳҙжһҒжқҗж–ҷиҺ·еҫ—жүҖйңҖеҸ‘е°„зҡ„жқЎд»¶гҖӮеҸӘиҰҒжҢҮе®ҡжқҗж–ҷпјҢе°ұеҸҜд»Ҙе®ҢжҲҗеҲқжӯҘзҡ„йҳҙжһҒи®ҫи®ЎгҖӮ

иҮӘз”ұз”өеӯҗеҸҜд»ҺеӨҡз§Қжқҗж–ҷзҡ„йҳҙжһҒдёӯиҺ·еҫ—гҖӮ然иҖҢпјҢз”өеӯҗжһӘи®ҫи®Ўзҡ„дё»иҰҒиҰҒжұӮжҳҜйҳҙжһҒе…·жңүиҫғдҪҺзҡ„еҠҹеҮҪж•°е’ҢиүҜеҘҪзҡ„зғӯж•ҲзҺҮпјҢжҸҗдҫӣи¶іеӨҹзҡ„еҸ‘е°„з”өжөҒпјҢ并且结жһ„з®ҖеҚ•гҖӮеңЁжүҖжңүзҡ„йҷҗеҲ¶жқЎд»¶дёӯпјҢз”өеӯҗжһӘзҡ„зңҹз©әжқЎд»¶еҜ№йҳҙжһҒжқҗж–ҷзҡ„йҖүжӢ©жңүеҫҲеӨ§зҡ„йҷҗеҲ¶гҖӮеңЁдҪҺзңҹз©әжқЎд»¶дёӢпјҲдҪҺдәҺ1Г—10-5В mm HgпјүпјҢйҖҡеёёдҪҝз”ЁеҠҹеҮҪж•°дҪҺгҖҒдҪ“з§Ҝи’ёеҸ‘зҺҮй«ҳзҡ„жқҗж–ҷпјҢеҰӮй’ЎгҖӮиҝҷз§Қжқҗж–ҷйҰ–е…ҲеҢ…еҗ«еңЁеҸҰдёҖз§Қжқҗж–ҷзҡ„дҪ“еҶ…пјҢдёәйҳҙжһҒжҸҗдҫӣз»“жһ„е’ҢеҪўзҠ¶пјҢ然еҗҺйҖҡиҝҮжү©ж•ЈиҝҮзЁӢиҝҒ移еҲ°иЎЁйқўгҖӮиҝҷз§ҚйҳҙжһҒиў«з§°дёәdispenser cathodeгҖӮDispenser cathodeеңЁе…¶иЎЁйқўдә§з”ҹ并дҝқжҢҒиҝҮйҮҸзҡ„йҮ‘еұһй’ЎпјҢ并дҫқйқ иҝҮйҮҸзҡ„йҮ‘еұһBaе®һзҺ°е…¶еҸ‘е°„зү№жҖ§гҖӮеңЁиҝҷз§Қз»“жһ„дёӯпјҢжқҗж–ҷзҡ„и’ёеҸ‘еҸҜд»ҘеҮҸ慢并жҳ“дәҺжҺ§еҲ¶гҖӮ
еңЁзңҹз©әеәҰй«ҳдәҺ1Г—10-5жҜ«зұіжұһжҹұзҡ„жғ…еҶөдёӢпјҢйҳҙжһҒжқҗж–ҷзҡ„йҖүжӢ©пјҢд»…йҷҗдәҺйҡҫзҶ”йҮ‘еұһпјҢе®ғ们具жңүжӣҙй«ҳзҡ„еҠҹеҮҪ数并иғҪеңЁжӣҙй«ҳзҡ„жё©еәҰдёӢе·ҘдҪңгҖӮжңҖжңүеҗёеј•еҠӣзҡ„йҡҫзҶ”йҮ‘еұһжҳҜWе’ҢTaпјҢе®ғ们зҡ„еҠҹеҮҪж•°еҲҶеҲ«дёә4.55е’Ң4.1з”өеӯҗдјҸзү№гҖӮWзҡ„зҶ”зӮ№дёә3410в„ғпјҢиҖҢTaзҡ„зҶ”зӮ№дёә2996в„ғгҖӮеңЁдҪҺдәҺ2500в„ғзҡ„жё©еәҰдёӢпјҢTaеҸ‘еҮәзҡ„з”өжөҒжҳҜй’Ёзҡ„10еҖҚгҖӮTaиҝҳжҳ“дәҺеҠ е·ҘпјҢеҸҜеҲ¶жҲҗи–„зүҮд»Ҙз”ҹдә§зү№ж®ҠеҪўзҠ¶зҡ„йҳҙжһҒгҖӮ
еҰӮжһңйңҖиҰҒе°Ҷзңҹз©әеҫӘзҺҜеҲ°еӨ§ж°”дёӯпјҢдҪҶж“ҚдҪңжё©еәҰдёҚи¶…иҝҮ5 Г— 10-6 mm HgпјҢеҲҷеҸҜд»ҘдҪҝз”ЁеҠҹеҮҪж•°дёә2.4з”өеӯҗдјҸзү№зҡ„е…ӯзЎјеҢ–镧пјҲLaB6пјүйҳҙжһҒгҖӮиҝҷжҳҜеӣ дёәеңЁиҫғдҪҺзҡ„еҸ‘е°„жё©еәҰдёӢйңҖиҰҒзӣёеҜ№иҫғй«ҳзҡ„еҸ‘е°„з”өжөҒеҜҶеәҰгҖӮеңЁе…¶д»–жҙ»жҖ§йҳҙжһҒдёӯпјҢLaB6еҜ№йҳҙжһҒжұЎжҹ“е’ҢеҜҝе‘Ҫзӯүй—®йўҳзҡ„ж•Ҹж„ҹжҖ§иҰҒдҪҺеҫ—еӨҡпјҢдҪҶе…¶й•ҝжңҹзЁіе®ҡжҖ§е’ҢзғӯеҫӘзҺҜзЁіе®ҡжҖ§д»ҚжҳҜе°ҡжңӘи§ЈеҶізҡ„й—®йўҳгҖӮ
еңЁжүҖжңүиҝҷдәӣйҳҙжһҒжқҗж–ҷдёӯпјҢй’ЁпјҲWпјүеңЁеӨ§еӨҡж•°ж–№йқўеҸҜиғҪдёҚжҳҜжңҖеҘҪзҡ„пјҢдҪҶеҜ№дәҺжҷ®йҖҡеә”з”ЁжқҘиҜҙпјҢе®ғжҳҜдёҖз§Қе»үд»·гҖҒеқҡеӣәе’ҢеҸҜйқ зҡ„еҸ‘е°„жәҗгҖӮеҲ°зӣ®еүҚдёәжӯўпјҢWд»Қ然жҳҜз”өеӯҗжқҹеҠ е·ҘйўҶеҹҹжңҖйҮҚиҰҒзҡ„йҳҙжһҒжқҗж–ҷпјҢе°Ҫз®ЎTaгҖҒLaB6д»ҘеҸҠеҗ«жңүеўһеҠ еҸ‘е°„зҡ„еҗҲйҮ‘е…ғзҙ зҡ„Wд№ҹиў«е№ҝжіӣдҪҝз”ЁгҖӮ
пјҲеҫ…з»ӯпјү




