зӯүзҰ»еӯҗеҲҮеүІеҠ е·Ҙ
зӯүзҰ»еӯҗеҲҮеүІжҳҜеңЁзңҹз©әдёӢиҝӣиЎҢе№ІејҸеҲ»иҡҖпјҢдҪҝжҷ¶еңҶиҠҜзүҮеҢ–пјҲеҚ•зүҮеҢ–пјүзҡ„еҠ е·ҘжҠҖжңҜгҖӮеңЁзӯүзҰ»еӯҗеҲҮеүІдёӯдҪҝз”Ёзҡ„Bosch
processвҖ»пјҲеҸӮз…§еӣҫпјүеҸҜе®һзҺ°й«ҳйҖҹгҖҒй«ҳзәөжЁӘжҜ”гҖҒзӘ„еҲҮеүІйҒ“зҡ„иҠҜзүҮеҢ–гҖӮ
еңЁеҲҶз«ӢејҸе…ғеҷЁд»¶е’ҢRFIDзӯүеҠ е·ҘйўҶеҹҹпјҢдёәдәҶеўһеҠ еҚ•дҪҚжҷ¶еңҶдёҠеҸҜиҺ·еҸ–зҡ„иҠҜзүҮдёӘж•°пјҢжӯЈйҖҗжӯҘеҗ‘зӘ„еҲҮеүІйҒ“ж–№еҗ‘еҸ‘еұ•гҖӮжӯӨеӨ–пјҢйқўеҗ‘移еҠЁи®ҫеӨҮе’Ңзү©иҒ”зҪ‘йңҖжұӮж—әзӣӣзҡ„е°ҸиҠҜзүҮе…ғеҷЁд»¶еҜ№дә§иғҪзҡ„иҰҒжұӮж—Ҙи¶ӢдёҘж јгҖӮеҗҢж—¶пјҢзӯүзҰ»еӯҗеҲҮеүІд№ҹеҸҜеҜ№еә”иҪҰиҪҪеҚҠеҜјдҪ“зӯүиҰҒжұӮйӣ¶зјәйҷ·зҡ„й«ҳе“ҒиҙЁеҠ е·Ҙзҡ„е…ғеҷЁд»¶гҖӮ
вҖ»еҫ·еӣҪRobert Bosch GmbHеңЁ1992е№ҙеҸ‘жҳҺзҡ„ж–№жі•
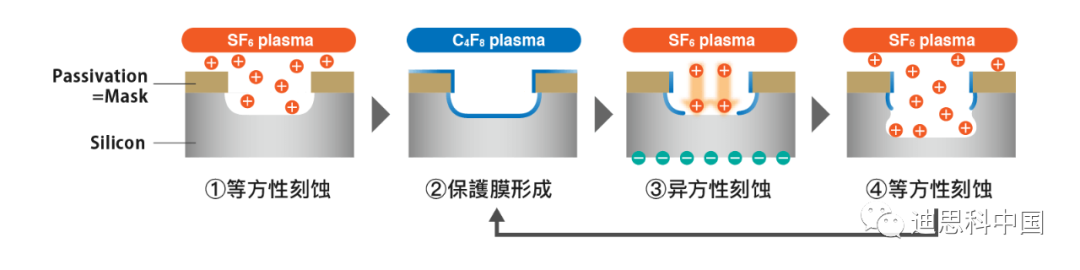
зӯүзҰ»еӯҗеҲҮеүІзҡ„дјҳзӮ№
жҸҗй«ҳе°ҸиҠҜзүҮе…ғеҷЁд»¶зҡ„з”ҹдә§зҺҮ
з”ұдәҺжҷ¶еңҶдёҠзҡ„еҲҮеүІйҒ“еҸҜеҗҢж—¶еҠ е·ҘпјҢжүҖд»ҘеҚідҪҝжҳҜе°ҸиҠҜзүҮе…ғеҷЁд»¶д№ҹиғҪз»ҙжҢҒй«ҳUPHгҖӮеҗҢж—¶пјҢзӘ„еҲҮеүІйҒ“еҢ–еҜ№еә”д№ҹеҸҜеўһеҠ еҚ•дҪҚжҷ¶еңҶзҡ„иҠҜзүҮиҺ·еҸ–дёӘж•°гҖӮ
еҸҜеҜ№еә”еӨҡз§ҚеҠ е·ҘеҪўзҠ¶
е№ІејҸеҲ»иҡҖжі•еҠ е·ҘеҸҜжҢүз…§жҺ©иҶңеӣҫжЎҲзҡ„еҪўзҠ¶иҝӣиЎҢиҠҜзүҮеҢ–гҖӮ
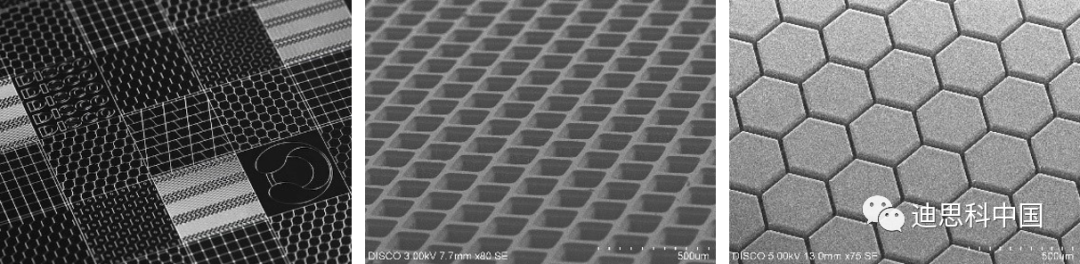
й«ҳжҙҒеҮҖжөҒзЁӢ
зӯүзҰ»еӯҗеҲҮеүІе№¶йқһжңәжў°еҠ е·ҘпјҢиҖҢжҳҜеҲ©з”ЁеҢ–еӯҰеҸҚеә”зҡ„е№ІејҸеҲ»иҡҖеҲ¶зЁӢпјҢеӣ жӯӨдёҚдјҡдә§з”ҹеҠ е·Ҙеұ‘е’Ңжә¶и§Јж®ӢжёЈзӯүгҖӮ
иҠҜзүҮејәеәҰжҸҗеҚҮ
йҖҡиҝҮдҪҝз”Ёж— жңәжў°жҚҹдјӨгҖҒзғӯеҪұе“Қе°Ҹзҡ„зӯүзҰ»еӯҗеҲҮеүІпјҢеҸҜд»ҘжҸҗй«ҳиҠҜзүҮејәеәҰгҖӮ
е·Ҙиүә
иҝӘжҖқ科еҸҜжҸҗдҫӣзҡ„ж•ҙдҪ“и§ЈеҶіж–№жЎҲ
еңЁдёҖиҲ¬зҡ„еҷЁд»¶дёӯпјҢеҲҮеүІйҒ“дёҠеӯҳеңЁзқҖйҳ»зўҚзӯүзҰ»еӯҗеҲҮеүІзҡ„иҶңе’ҢйҮ‘еұһзӯүпјҢеӣ жӯӨпјҢеңЁиҝӣиЎҢзӯүзҰ»еӯҗеҲҮеүІеүҚйңҖиҰҒе…ҲиЎҢе°Ҷе…¶еҺ»йҷӨгҖӮеӣ жӯӨпјҢиҝӘжҖқ科дҫқйқ еӨҡе№ҙеҠ е·ҘжҠҖжңҜе’Ңе·Ҙиүәзҡ„жҠҖжңҜз§ҜзҙҜ пјҢеҸҜдёәе®ўжҲ·жҸҗдҫӣеҷЁд»¶жҲҗеҪўеҗҺзҡ„зЎ…жҷ¶еңҶиҠҜзүҮеҢ–зҡ„дёҖз«ҷејҸеҠ е·ҘжңҚеҠЎгҖӮ
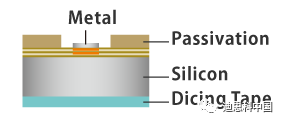
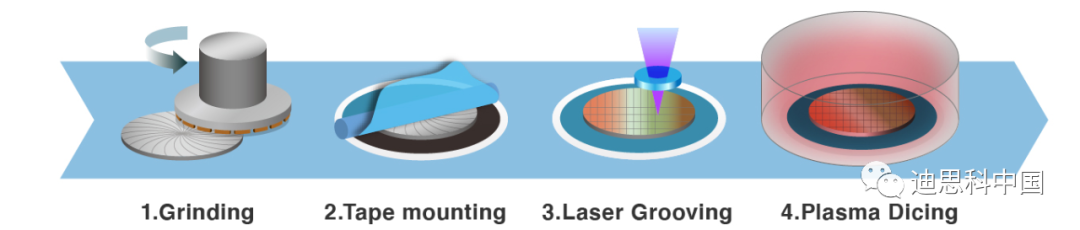
иғҢйқўз ”зЈЁпјҡйҖҡиҝҮзЈЁзүҮжңә/жҠӣе…үжңәдҪҝжҷ¶еңҶи–„еһӢеҢ–
иҙҙиҶңжңәпјҡз”ЁиҙҙиҶңжңәе°Ҷйҡҫд»ҘжүӢеҠЁжҗ¬йҖҒзҡ„и–„жҷ¶еңҶзІҳиҙҙиҮіжЎҶжһ¶дёҠ
Laser Groovingпјҡз”ЁжҝҖе…үеҲҮеүІжңәеҺ»йҷӨеҲҮеүІйҒ“йғЁеҲҶзҡ„й’қеҢ–иҶңе’ҢTEGзӯүйҮ‘еұһйғЁеҲҶ
зӯүзҰ»еӯҗеҲҮеүІпјҡжҷ¶еңҶеңЁжЎҶжһ¶дёҠе®һзҺ°зӯүзҰ»еӯҗеҲҮеүІ
е·Ҙиүәеә”з”Ёе®һз»©
Power device
LED
RFID
RF filter
MEMS
TVSпјҲZener diodeпјүзӯү
дёҺзҫҺеӣҪPlasme-Thermе…¬еҸёзҡ„е•ҶеҠЎеҗҲдҪң

DISCO CorporationдёҺзҫҺеӣҪPlasme-Thermе…¬еҸёдәҺ2016е№ҙ4жңҲзӯҫи®ўе•ҶеҠЎеҗҲдҪңеҗҲеҗҢпјҢеҗ‘е…Ёзҗғе®ўжҲ·жҸҗдҫӣиҜҘе…¬еҸёзҡ„зӯүзҰ»еӯҗеҲҮеүІиЈ…зҪ®жүҖз”Ёзҡ„R&DгҖҒиҜ•еҲҮеүІгҖҒи®ҫеӨҮй”Җе”®еҸҠе”®еҗҺж”ҜжҢҒзӯүжңҚеҠЎгҖӮ
жң¬е…¬еҸёжҳҜдёҖ家гҖҢеҚҠеҜјдҪ“еҲ¶йҖ и®ҫеӨҮз”ҹдә§е•ҶгҖҚпјҢжҸҗдҫӣз”ЁдәҺеҲ¶йҖ еҚҠеҜјдҪ“е’Ңз”өеӯҗйӣ¶д»¶зҡ„зІҫеҜҶеҠ е·Ҙи®ҫеӨҮпјҲеҰӮеҲҮеүІжңәе’Ңз ”зЈЁжңәпјүгҖҒд»ҘеҸҠе®үиЈ…еңЁи®ҫеӨҮдёҠзҡ„зІҫеҜҶеҠ е·Ҙе·Ҙе…·гҖӮ
йҷӨдәҶиҝҷдәӣдә§е“Ғд№ӢеӨ–пјҢйҖҡиҝҮжҸҗдҫӣи®ҫеӨҮе’Ңе·Ҙе…·зҡ„еә”з”ЁжҠҖжңҜжқҘиҝҪжұӮе®ўжҲ·ж»Ўж„Ҹзҡ„еҠ е·Ҙж•ҲжһңпјҢеӣ жӯӨжң¬е…¬еҸёзҡ„дә§е“Ғе’ҢеҠ е·ҘжҠҖжңҜиў«еӣҪеҶ…еӨ–硬件з”ҹдә§е•Ҷе’ҢеҚҠеҜјдҪ“еҲ¶йҖ е…¬еҸёе№ҝжіӣйҮҮз”ЁгҖӮ
е’ЁиҜўзӘ—еҸЈпјҡ
жӮЁеҸҜиҒ”зі»йӮ®з®ұ <info@discosha.com>
вҖңйҖҡиҝҮй«ҳеәҰзҡ„Kiru(еҲҮ)гғ»Kezuru(еүҠ)гғ»Migaku(зЈЁ)
е°ҶйҒҘиҝңзҡ„科жҠҖдёҺиҲ’йҖӮзҡ„з”ҹжҙ»зӣёиҝһжҺҘвҖқ


