
核心观点
1、锡焊膏:重要的电子材料,行业呈高端化发展趋势。
电子锡焊料主要包括锡膏、焊锡条、焊锡丝、预成型焊片及助焊剂等。2020年我国电子锡焊料市场空间约为300亿元,呈现逐步增长态势。锡膏不仅可应用于SMT组装工艺,还可广泛应用于LED芯片倒装固晶工艺、散热器成型工艺等,几乎涉及了所有电子产品的生产。锡膏行业整体呈现高端化的发展趋势,可以总结为三个方面。1)精细化:电子元器件尺寸、间距越来越小,促使焊接材料向粒度微细化、分布跨度更窄的方向发展,因此超细间距、更小焊盘的锡膏应运而生。当前业内企业生产锡膏时普遍采用粉径较大的T3、T4 型号的锡合金粉。部分技术领先企业开始批量使用粉径更小的T5号锡合金粉,并逐步开始向粉径更小的T6、T7型号发展;2)绿色化:主要体现在两个方面,即焊接材料无卤化、辅助焊接材料水基化;3)低温化:很多常规合金如锡银铜、锡铜合金熔点都在200℃以上,容易因焊接温度过高而导致元器件和 PCB板变形,从而造成多种焊接缺陷,同时也会大幅增加耗能。为提升焊接效果及电子装联质量,降低制造成本,研发焊接熔点在183℃以下的低温锡膏成为行业技术重要发展趋势之一。而常见的低温合金有Sn-Bi系和Sn-In系,其中Sn-In合金的共晶点为120℃,但是In的成本较高,所以目前In主要是作为微量元素进行添加。
2、光通信技术演进,锡焊膏行业需求有望爆发。
1)光模块传输速率提升,对焊接工艺的要求显著提升。光模块传输速率提升,本质上是信号频率、热密度、封装密度的同时增加,对焊点的影响集中体现为:热疲劳寿命下降 + 高频寄生效应敏感 + 微型化工艺挑战。光模块传输速率提升,封装工艺迎来改变,沿着同轴封装(TO-can)-COB(chip on board)/COC-BOX(chip on carrier on box)--混合集成(Hybrid Integration)至光电共封装(Co-Packaged Optics)。2)光模块传输速率提升,锡膏行业有望迎来量价双升。量:锡膏用量提升的双重逻辑是:光模块数量提升、高速光模块封装工艺变化带来焊点数量提升。光模块的焊点大多数在PCBA主板上,核心在光器件内部,外围在外壳封装上。随着光模块速率从10G向400G/800G演进,PCBA上的焊点数量快速增长;光器件内部精密焊点对模块的性能和可靠性至关重要,涵盖多种精细工艺如共晶焊、激光焊、金线键合、倒装焊等。价:高级别焊膏价格更贵,高速光模块对高级别焊膏需求提升。
投资建议:
锡焊行业有望受益于高速光模块进展,迎来量价齐升。重点推荐锡焊材料头部华光新材,受益标的唯特偶。
风险提示:
高端锡焊膏技术进展不及预期,高速光模块放量节奏不及预期;潜在新的工艺变化影响需求量等。



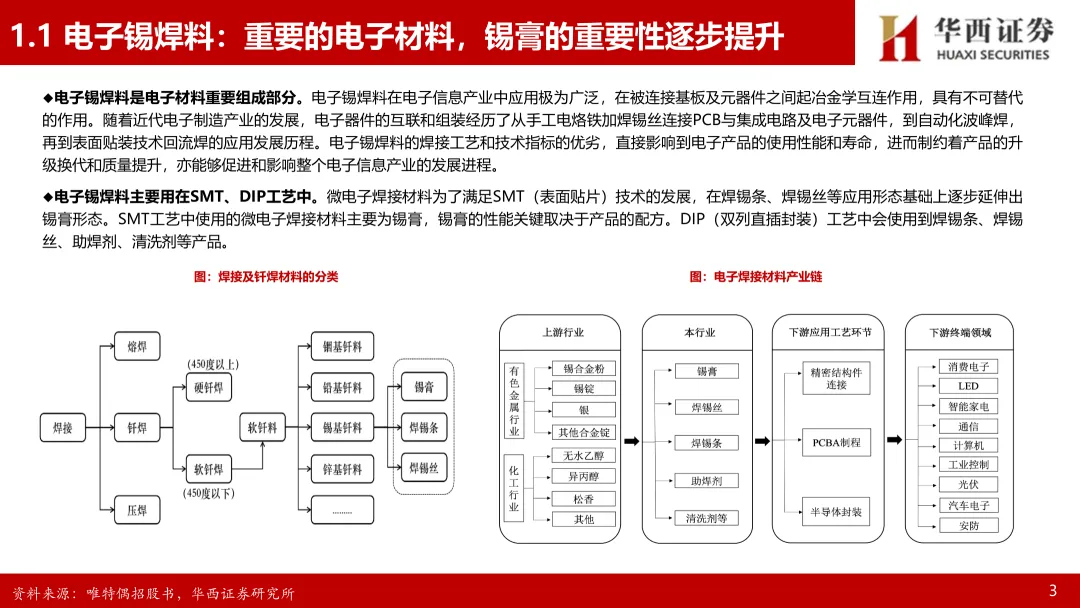

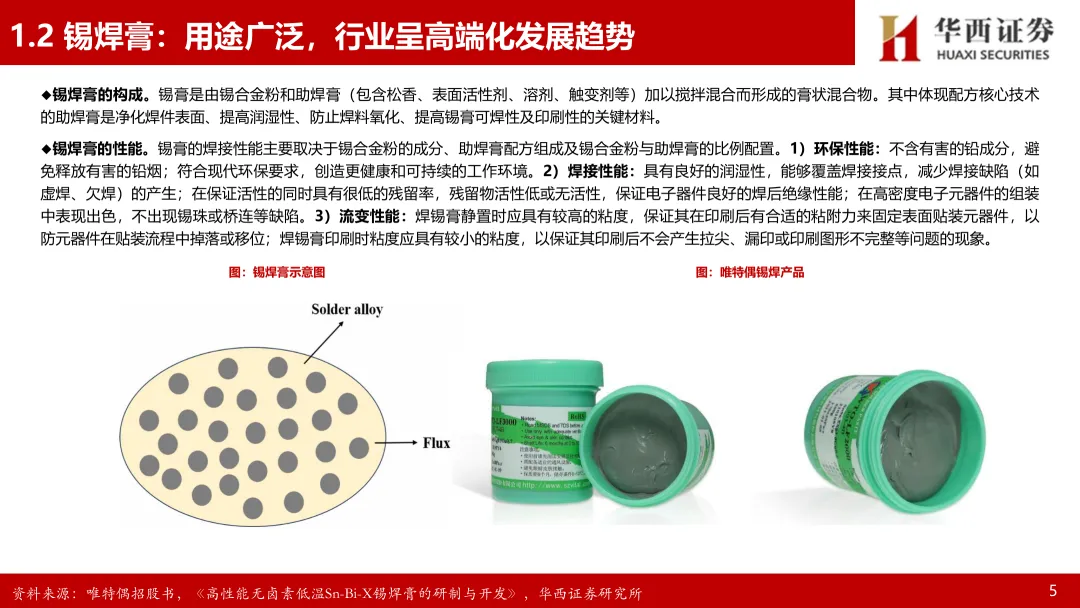





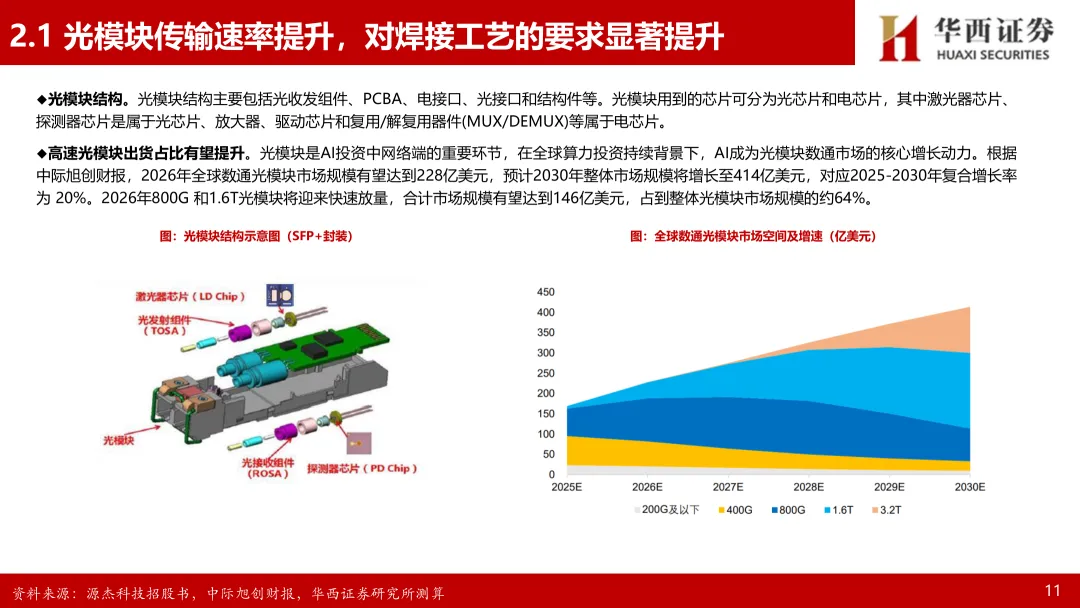
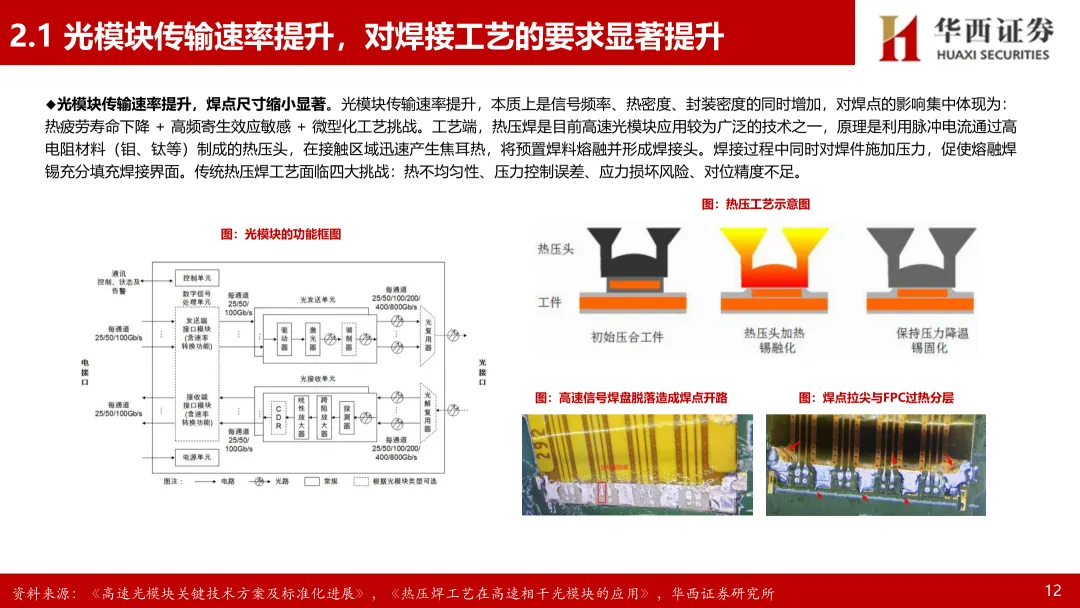



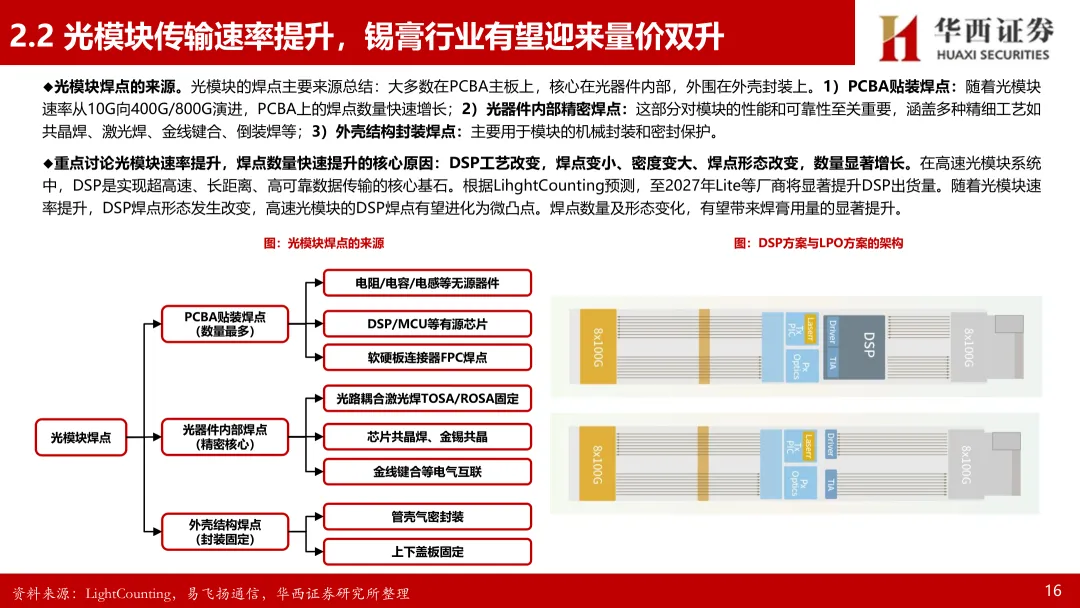
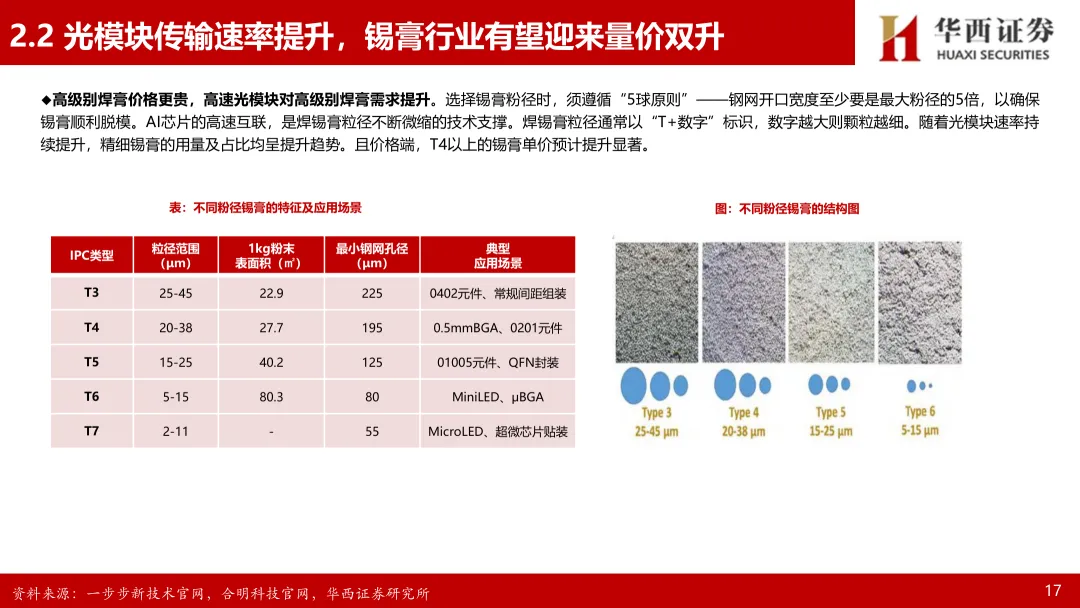







注:文中报告节选自华西证券研究所已公开发布研究报告,具体报告内容及相关风险提示等详见完整版报告。
分析师:黄瑞连
分析师执业编号:S1120524030001
分析师:石城
分析师执业编号:S1120524080001
证券研究报告:《锡焊膏行业深度报告:光通信带来行业变革,锡焊膏需求有望爆发》
报告发布日期:2026年05月05日
本订阅号为华西证券机械团队设立及运营。本订阅号不是华西证券研究报告的发布平台。本订阅号所载的信息仅面向华西证券的专业投资机构客户,仅供在新媒体背景下研究观点的及时交流。本订阅号所载的信息均摘编自华西证券研究所已经发布的研究报告或者是对已发布报告的后续解读,若因对报告的摘编而产生歧义,应以报告发布当日的完整内容为准。
在任何情况下,本订阅号所推送信息或所表述的意见并不构成对任何人的投资建议。华西证券及华西证券研究所也不对任何人因为使用本订阅号信息所引致的任何损失负任何责任。
本订阅号及其推送内容的版权归华西证券所有,华西证券对本订阅号及推送内容保留一切法律权利。未经华西证券事先书面许可,任何机构或个人不得以任何形式翻版、复制、刊登、转载和引用,否则由此造成的一切不良后果及法律责任由私自翻版、复制、刊登、转载和引用者承担。


