дёҖгҖҒCoWoS жҠҖжңҜж ёеҝғе®ҡд№үдёҺеә•еұӮйҖ»иҫ‘
CoWoSе…Ёз§°дёә Chip-on-Wafer-on-SubstrateпјҲиҠҜзүҮ-жҷ¶еңҶ-еҹәжқҝпјүпјҢжҳҜеҸ°з§Ҝз”өдё»еҜјзҡ„2.5Dе…Ҳиҝӣе°ҒиЈ…ж ёеҝғжҠҖжңҜпјҢж ёеҝғеҲҶдёәдёӨеӨ§е·ҘиүәжӯҘйӘӨпјҡ
CoWпјҲChip-on-WaferпјүиҠҜзүҮе ҶеҸ жҷ¶еңҶпјҡйҖҡиҝҮеҫ®еҮёеқ—гҖҒTSV зЎ…йҖҡеӯ”жҠҖжңҜпјҢе°Ҷ GPU/CPU зӯүйҖ»иҫ‘иҠҜзүҮгҖҒHBM й«ҳеёҰе®ҪеҶ…еӯҳе ҶеҸ еңЁзЎ…дёӯд»ӢеұӮжҷ¶еңҶдёҠпјҢе®һзҺ°й«ҳеҜҶеәҰиҠҜзүҮејӮжһ„йӣҶжҲҗпјӣ WoSпјҲWafer-on-Substrateпјүжҷ¶еңҶе°ҒиЈ…еҹәжқҝпјҡе°Ҷе®ҢжҲҗе ҶеҸ зҡ„CoWз»“жһ„иҙҙиЈ…еҲ°е°ҒиЈ…еҹәжқҝдёҠпјҢйҖҡиҝҮBGAй”Ўзҗғе®һзҺ°иҠҜзүҮй—ҙй«ҳж•Ҳдә’иҒ”дёҺдҝЎеҸ·еҜ№еӨ–дј иҫ“гҖӮ
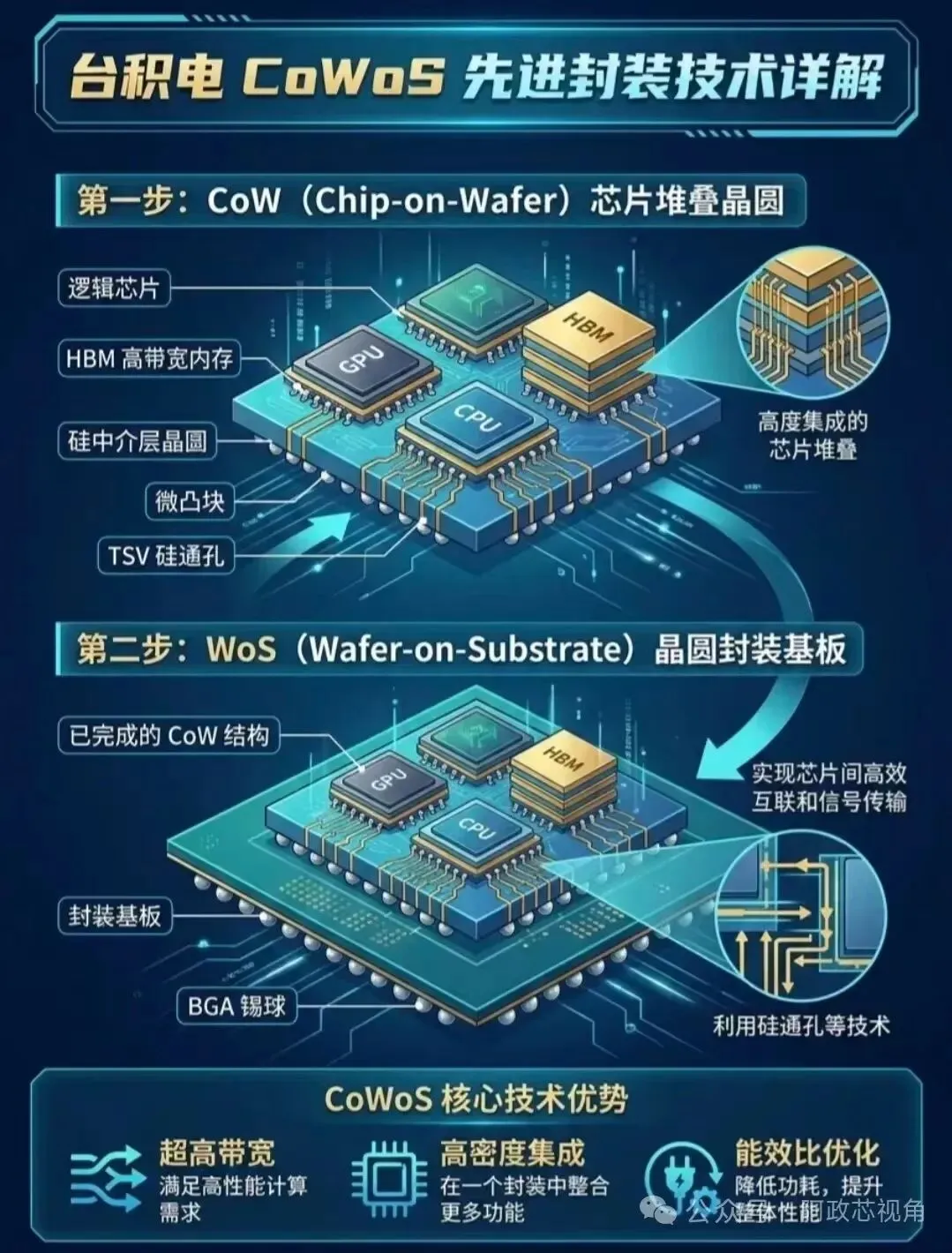
е…¶ж ёеҝғи§ЈеҶідәҶдј з»ҹе°ҒиЈ…зҡ„вҖңеҶ…еӯҳеўҷвҖқ 瓶йўҲпјҢеҮӯеҖҹи¶…й«ҳеёҰе®ҪгҖҒй«ҳеҜҶеәҰйӣҶжҲҗгҖҒиғҪж•ҲжҜ”дјҳеҢ–гҖҒејәзғӯз®ЎзҗҶеӣӣеӨ§ж ёеҝғдјҳеҠҝпјҢжҲҗдёәAIз®—еҠӣж—¶д»Јзҡ„ж ёеҝғеә•еұӮе°ҒиЈ…жҠҖжңҜгҖӮ
дәҢгҖҒCoWoS жҠҖжңҜж ёеҝғеә”з”ЁеңәжҷҜ
CoWoSжҠҖжңҜзҡ„еә”з”Ёе·ІеҪўжҲҗвҖңй«ҳз«Ҝж ёеҝғеңәжҷҜж”ҫйҮҸпјҢеӨҡйўҶеҹҹйҖҗжӯҘжё—йҖҸвҖқзҡ„ж јеұҖпјҢж ёеҝғеә”з”ЁеңәжҷҜеҰӮдёӢпјҡ
1. AIз®—еҠӣдёҺй«ҳжҖ§иғҪи®Ўз®—пјҲHPCпјү/ж•°жҚ®дёӯеҝғпјҲж ёеҝғдё»еҠӣеңәжҷҜпјү
иҝҷжҳҜCoWoS еҪ“еүҚжңҖж ёеҝғзҡ„еә”з”ЁиөӣйҒ“пјҢд№ҹжҳҜжҠҖжңҜиҝӯд»Јзҡ„ж ёеҝғй©ұеҠЁеҠӣгҖӮеӨ§иҜӯиЁҖжЁЎеһӢзҡ„и®ӯз»ғдёҺжҺЁзҗҶпјҢеҜ№ GPU дёҺ HBM еҶ…еӯҳзҡ„дә’иҒ”еёҰе®ҪгҖҒдј иҫ“延иҝҹжңүжһҒиҮҙиҰҒжұӮпјҢдј з»ҹеҲҶз«Ӣе°ҒиЈ…ж— жі•зӘҒз ҙ вҖңеҶ…еӯҳеўҷвҖқ йҷҗеҲ¶гҖӮ
CoWoS йҖҡиҝҮ 2.5D дёӯд»ӢеұӮе®һзҺ° GPU SoC дёҺ HBM зҡ„иҝ‘е°ҒиЈ…йӣҶжҲҗпјҢеӨ§е№…зј©зҹӯдҝЎеҸ·и·Ҝеҫ„пјҢдә’иҝһеёҰе®ҪжҸҗеҚҮж•°еҚҒеҖҚпјҢеҗҢж—¶жҳҫи‘—йҷҚдҪҺ延иҝҹдёҺеҠҹиҖ—гҖӮNVIDIA H100 GPUгҖҒBlackwell B200 зі»еҲ—йЎ¶зә§ AI иҠҜзүҮеқҮйҮҮз”Ё CoWoS е°ҒиЈ…пјҢеҪ“еүҚе…Ёзҗғ 90% д»ҘдёҠзҡ„й«ҳз«Ҝ AI з®—еҠӣиҠҜзүҮеқҮдҫқиө–иҜҘжҠҖжңҜпјҢжҳҜ AI з®—еҠӣеҹәе»әзҡ„ж ёеҝғеә•еұӮж”Ҝж’‘гҖӮ
2.й«ҳз«ҜйҖҡдҝЎзҪ‘з»ңи®ҫеӨҮ
5G-A/6G еҹәз«ҷгҖҒй«ҳз«Ҝи·Ҝз”ұдәӨжҚўгҖҒе…үдј иҫ“и®ҫеӨҮпјҢйңҖиҰҒиҠҜзүҮе…·еӨҮй«ҳйӣҶжҲҗгҖҒдҪҺ延иҝҹгҖҒеӨ§еёҰе®Ҫзҡ„зү№жҖ§гҖӮCoWoS еҸҜе°ҶеҹәеёҰгҖҒе°„йў‘гҖҒдәӨжҚўиҠҜзүҮдёҺй«ҳйҖҹзј“еӯҳејӮжһ„йӣҶжҲҗпјҢеӨ§е№…жҸҗеҚҮи®ҫеӨҮзҡ„ж•°жҚ®еҗһеҗҗиғҪеҠӣдёҺиғҪж•ҲжҜ”пјҢж»Ўи¶ідёӢдёҖд»ЈйҖҡдҝЎзҪ‘з»ңжө·йҮҸж•°жҚ®зҡ„й«ҳйҖҹдј иҫ“йңҖжұӮпјҢжҳҜй«ҳз«ҜйҖҡдҝЎиҠҜзүҮзҡ„ж ёеҝғе°ҒиЈ…ж–№жЎҲгҖӮ
3.ж——иҲ°ж¶Ҳиҙ№з”өеӯҗ
йў„жөӢиӢ№жһңе°ҶеңЁiPhone18 зі»еҲ—зҡ„ A20 иҠҜзүҮдёӯйҮҮз”Ё CoWoS е°ҒиЈ…пјҢж Үеҝ—зқҖиҜҘжҠҖжңҜд»Һе·Ҙдёҡзә§еҗ‘ж¶Ҳиҙ№зә§жё—йҖҸгҖӮж——иҲ°жүӢжңәгҖҒй«ҳз«Ҝ PCгҖҒVR/AR и®ҫеӨҮеҜ№иҠҜзүҮдҪ“з§ҜгҖҒеҠҹиҖ—гҖҒз®—еҠӣжңүжһҒиҮҙиҰҒжұӮпјҢCoWoS еҸҜе®һзҺ°еӨ„зҗҶеҷЁгҖҒNPUгҖҒз»ҹдёҖеҶ…еӯҳзҡ„й«ҳеҜҶеәҰйӣҶжҲҗпјҢеңЁжӣҙе°Ҹзҡ„жңәиә«еҶ…е®һзҺ°з®—еҠӣи·ғеҚҮпјҢеҗҢж—¶дјҳеҢ–з»ӯиҲӘиЎЁзҺ°гҖӮйҡҸзқҖжҲҗжң¬дёӢжҺўпјҢжңӘжқҘжңүжңӣд»Һж——иҲ°жңәеһӢеҗ‘дёӯй«ҳз«Ҝж¶Ҳиҙ№з”өеӯҗеӨ§и§„жЁЎжё—йҖҸгҖӮ
4.иҪҰ规зә§жұҪиҪҰз”өеӯҗ
L3+зә§еҲ«иҮӘеҠЁй©ҫ驶еҹҹжҺ§гҖҒжҷәиғҪеә§иҲұиҠҜзүҮпјҢеҜ№з®—еҠӣеҜҶеәҰгҖҒеҸҜйқ жҖ§гҖҒзғӯз®ЎзҗҶиғҪеҠӣжңүдёҘиӢӣзҡ„иҪҰ规зә§иҰҒжұӮгҖӮCoWoS зҡ„й«ҳеҜҶеәҰйӣҶжҲҗзү№жҖ§еҸҜе°ҶиҮӘеҠЁй©ҫ驶 SoCгҖҒиҪҰ规еҶ…еӯҳгҖҒеӣҫеғҸеӨ„зҗҶеҚ•е…ғйӣҶжҲҗдәҺеҚ•дёҖе°ҒиЈ…пјҢеҗҢж—¶е…¶зЎ… / жңүжңәдёӯд»ӢеұӮеёҰжқҘзҡ„ејәзғӯз®ЎзҗҶиғҪеҠӣпјҢеҸҜжңүж•ҲйҷҚдҪҺж ёеҝғжё©еәҰдёҺзғӯиҠӮжөҒйЈҺйҷ©пјҢжҸҗеҚҮиҪҰиҪҪзі»з»ҹзҡ„еҸҜйқ жҖ§дёҺдҪҝз”ЁеҜҝе‘ҪпјҢжҳҜй«ҳйҳ¶иҮӘеҠЁй©ҫ驶иҠҜзүҮзҡ„ж ёеҝғе°ҒиЈ…ж–№еҗ‘гҖӮ
5.й«ҳз«ҜеӣҫеғҸеӨ„зҗҶдёҺдё“дёҡиҠҜзүҮ
дёҡз•ҢйҰ–ж¬ҫUCle32G зү©зҗҶеұӮиҠҜзүҮпјҢдҫҝйҮҮз”ЁеҸ°з§Ҝз”ө CoWoS е°ҒиЈ…жҠҖжңҜгҖӮиҜҘжҠҖжңҜеҸҜе®һзҺ°и¶…й«ҳеёҰе®Ҫзҡ„еӣҫеғҸж•°жҚ®дј иҫ“дёҺеӨ„зҗҶпјҢе№ҝжіӣеә”з”ЁдәҺ 4K/8K дё“дёҡеҪұеғҸгҖҒе·ҘдёҡжңәеҷЁи§Ҷи§үгҖҒAI и§Ҷи§үжЈҖжөӢгҖҒй«ҳз«Ҝйҹіи§Ҷйў‘еӨ„зҗҶзӯүдё“дёҡиҠҜзүҮйўҶеҹҹпјҢж»Ўи¶ідё“дёҡеңәжҷҜзҡ„й«ҳжҖ§иғҪж•°жҚ®еӨ„зҗҶйңҖжұӮгҖӮ
дёүгҖҒCoWoS жҠҖжңҜжңӘжқҘжј”иҝӣж–№еҗ‘
1.жҠҖжңҜи·ҜзәҝеӨҡе…ғеҢ–жј”иҝӣпјҢз ҙи§Јж ёеҝғйҮҸдә§з—ӣзӮ№
еҪ“еүҚCoWoS-SпјҲеҚ•зЎ…дёӯд»ӢеұӮпјү жҳҜеёӮеңәдё»еҠӣпјҢдҪҶйқўдёҙеӨ§е°әеҜёдёӢзҡ„иүҜзҺҮ瓶йўҲпјӣCoWoS-RпјҲжңүжңәдёӯд»ӢеұӮпјүгҖҒCoWoS-LпјҲеұҖйғЁзЎ…дә’иҝһпјү дҪңдёәжҠҖжңҜиЎҘе……пјҢе°ҶжҲҗдёәжңӘжқҘж ёеҝғиҝӯд»Јж–№еҗ‘гҖӮ
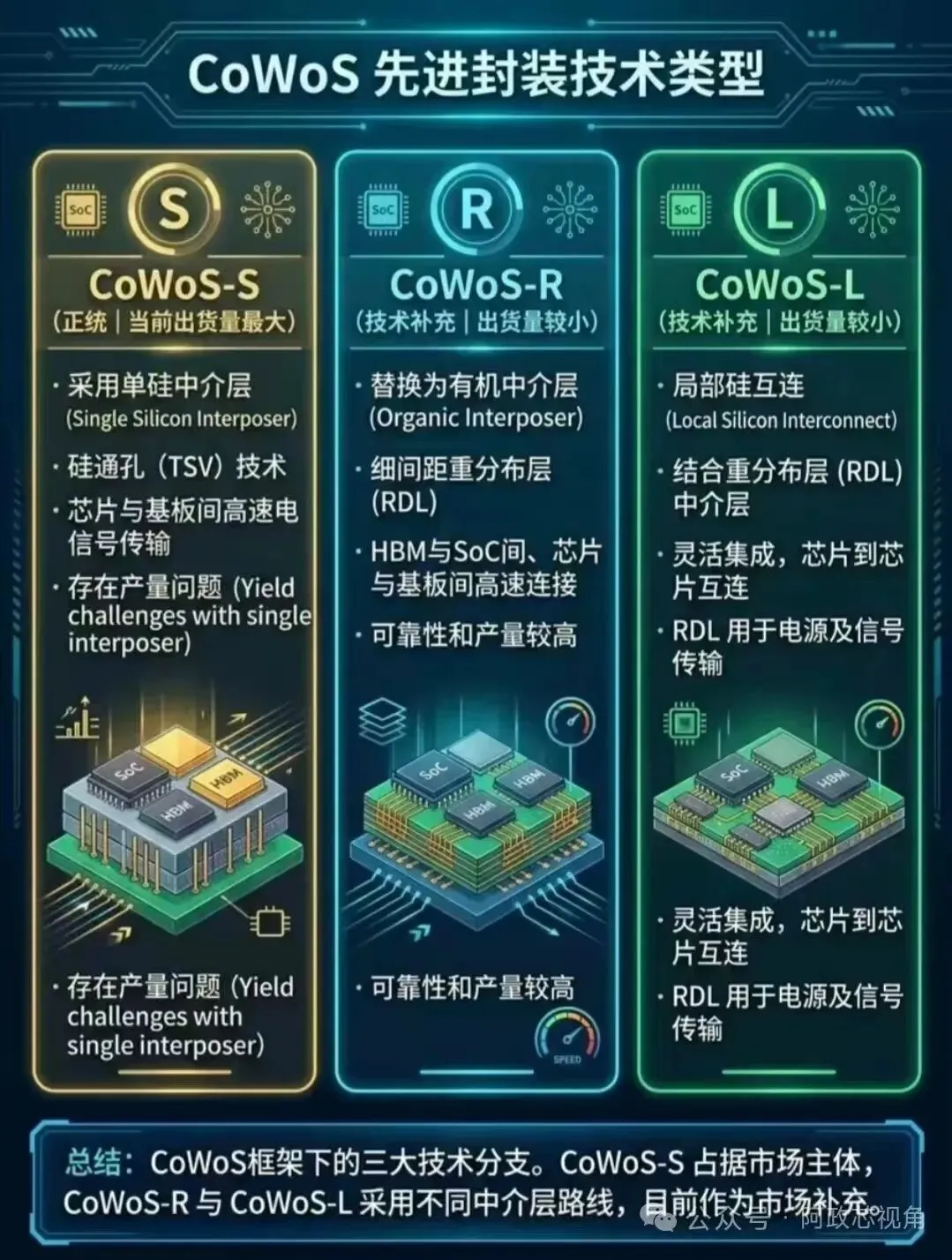
CoWoS-R и·Ҝзәҝпјҡд»Ҙжңүжңәдёӯд»ӢеұӮжӣҝд»Јдј з»ҹзЎ…дёӯд»ӢеұӮпјҢеҸҜзӘҒз ҙзЎ…дёӯд»ӢеұӮзҡ„е°әеҜёйҷҗеҲ¶пјҢеӨ§е№…жҸҗеҚҮйҮҸдә§иүҜзҺҮгҖҒйҷҚдҪҺеҲ¶йҖ жҲҗжң¬пјҢжңӘжқҘе°ҶжҲҗдёәдёӯз«Ҝ AI иҠҜзүҮгҖҒж¶Ҳиҙ№з”өеӯҗиҠҜзүҮ规模еҢ–еә”з”Ёзҡ„ж ёеҝғи·ҜзәҝпјҢжү“ејҖCoWoS зҡ„дёӢжІүеёӮеңәз©әй—ҙгҖӮ
CoWoS-L и·ҜзәҝпјҡйҮҮз”ЁеұҖйғЁзЎ…дә’иҝһ + RDL йҮҚеҲҶеёғеұӮж–№жЎҲпјҢе…јйЎҫзЎ…дёӯд»ӢеұӮзҡ„й«ҳжҖ§иғҪдёҺRDL еёғзәҝзҡ„зҒөжҙ»жҖ§пјҢйҖӮй…ҚеӨҡ SoCгҖҒеӨ§иҠҜзүҮзҡ„ејӮжһ„йӣҶжҲҗйңҖжұӮпјҢж–ҮжЎЈдёӯ NVIDIA B200 е·ІйҮҮз”ЁиҜҘжҠҖжңҜпјҢжңӘжқҘе°ҶжҲҗдёәйЎ¶зә§ AI иҠҜзүҮгҖҒи¶…з®—иҠҜзүҮзҡ„дё»жөҒж–№жЎҲгҖӮ
2.5DдёҺ3Dе°ҒиЈ…ж·ұеәҰиһҚеҗҲпјҡеҪ“еүҚCoWoS д»Ҙж°ҙе№і 2.5D е ҶеҸ дёәдё»пјҢжңӘжқҘе°Ҷеҗ‘вҖң2.5D+3DвҖқж··еҗҲе°ҒиЈ…жј”иҝӣпјҢеңЁзЎ…дёӯд»ӢеұӮдёҠе®һзҺ°еҶ…еӯҳиҠҜзүҮзҡ„ 3D еһӮзӣҙе ҶеҸ пјҢеҗҢж—¶е®ҢжҲҗйҖ»иҫ‘иҠҜзүҮзҡ„ 2.5D ж°ҙе№ідә’иҒ”пјҢиҝӣдёҖжӯҘжҸҗеҚҮйӣҶжҲҗеәҰпјҢзӘҒз ҙеёҰе®ҪдёҠйҷҗпјҢеҢ№й…ҚдёӢдёҖд»Ј HBM4 з”ҡиҮіжӣҙй«ҳйҖҹеҶ…еӯҳзҡ„дә’иҒ”йңҖжұӮгҖӮ
2.ж ёеҝғе·ҘиүәжҢҒз»ӯзӘҒз ҙпјҢеҢ№й…ҚжһҒиҮҙжҖ§иғҪйңҖжұӮ
CoWoS зҡ„ж ёеҝғжҖ§иғҪз”ұ TSV зЎ…йҖҡеӯ”гҖҒеҫ®еҮёеқ—гҖҒRDLйҮҚеҲҶеёғеұӮдёүеӨ§ж ёеҝғе·ҘиүәеҶіе®ҡпјҢжңӘжқҘе·Ҙиүәиҝӯд»Је°ҶжҢҒз»ӯеҗ‘й«ҳеҜҶеәҰгҖҒй«ҳзІҫеәҰж–№еҗ‘жј”иҝӣпјҡ
TSV зЎ…йҖҡеӯ”еӯ”еҫ„жҢҒз»ӯзј©е°ҸгҖҒеҜҶеәҰеӨ§е№…жҸҗеҚҮпјҢеҫ®еҮёеқ—иҠӮи·қд»ҺеҪ“еүҚеҮ еҚҒеҫ®зұіеҗ‘еҮ еҫ®зұізә§еҲ«зӘҒз ҙпјҢRDL зәҝе®Ҫзәҝи·қжҢҒз»ӯзј©зӘ„пјҢе®һзҺ°жӣҙй«ҳеҜҶеәҰзҡ„иҠҜзүҮдә’иҒ”пјҢеҢ№й…Қ UCle жҺҘеҸЈйҖҹзҺҮд»Һ 32Gbps еҗ‘жӣҙй«ҳзә§еҲ«зҡ„еҚҮзә§йңҖжұӮпјӣ
зғӯз®ЎзҗҶжҠҖжңҜеҗҢжӯҘдјҳеҢ–пјҢйҡҸзқҖиҠҜзүҮйӣҶжҲҗеәҰдёҺеҠҹиҖ—еҜҶеәҰжҸҗеҚҮпјҢж–°еһӢеөҢе…ҘејҸж•ЈзғӯйҖҡйҒ“гҖҒй«ҳеҜјзғӯдёӯд»ӢеұӮи®ҫи®ЎгҖҒе®ҡеҲ¶еҢ–ж•Јзғӯжқҗж–ҷе°ҶжҲҗдёәиҝӯд»ЈйҮҚзӮ№пјҢиҝӣдёҖжӯҘжҸҗеҚҮе°ҒиЈ…еҸҜйқ жҖ§пјҢж»Ўи¶іиҪҰ规зә§гҖҒе·Ҙдёҡзә§иҠҜзүҮзҡ„дёҘиӢӣзҺҜеўғиҰҒжұӮгҖӮ
3.еӣҪдә§еҢ–жӣҝд»Јиҝӣе…ҘеҠ йҖҹжңҹпјҢеӣҪеҶ…дә§дёҡй“ҫиҝҺжқҘзҲҶеҸ‘жңәйҒҮ
еҪ“еүҚCoWoS зҡ„ж ёеҝғжҠҖжңҜдёҺдә§иғҪдё»иҰҒз”ұеҸ°з§Ҝз”өеһ„ж–ӯпјҢиҖҢеӣҪеҶ… AI иҠҜзүҮгҖҒз®—еҠӣиҠҜзүҮзҡ„еӣҪдә§еҢ–йңҖжұӮзҲҶеҸ‘пјҢдёәеӣҪеҶ…дә§дёҡй“ҫеёҰжқҘдәҶжҳҺзЎ®зҡ„жӣҝд»Јз©әй—ҙгҖӮзӣ®еүҚеӣҪеҶ…е°ҒжөӢеҺӮе•Ҷе·Іе®һзҺ° 2.5D/3D е…Ҳиҝӣе°ҒиЈ…жҠҖжңҜзҡ„йҮҸдә§зӘҒз ҙпјҢжқҗж–ҷгҖҒи®ҫеӨҮзҺҜиҠӮзҡ„еӣҪдә§еҢ–й…ҚеҘ—жҢҒз»ӯе®Ңе–„пјҢжңӘжқҘеӣҪеҶ…е°ҶеҪўжҲҗе®Ңж•ҙзҡ„ CoWoS еҗҢзұ»жҠҖжңҜдә§дёҡй“ҫпјҢжү“з ҙжө·еӨ–жҠҖжңҜеһ„ж–ӯпјҢжҲҗдёәе…Ёзҗғе…Ҳиҝӣе°ҒиЈ…зҡ„ж ёеҝғеўһй•ҝжһҒгҖӮ
CoWoS зҡ„еҲ¶йҖ жҲҗжң¬е°ҶжҢҒз»ӯдёӢйҷҚпјҢеә”з”ЁеңәжҷҜе°Ҷд»Һж——иҲ°зә§ AI иҠҜзүҮгҖҒи¶…з®—пјҢеҗ‘дёӯз«Ҝ AI иҠҜзүҮгҖҒж¶Ҳиҙ№з”өеӯҗгҖҒжұҪиҪҰз”өеӯҗгҖҒе·ҘдёҡжҺ§еҲ¶зӯүйўҶеҹҹеӨ§и§„жЁЎдёӢжІүпјҢеёӮеңәз©әй—ҙе°Ҷе®һзҺ°жҢҮж•°зә§еўһй•ҝгҖӮ
еӣӣгҖҒA иӮЎ CoWoS дёҠдёӢжёёдә§дёҡй“ҫйҫҷеӨҙдјҒдёҡ
CoWoSжҳҜдёҖз§Қ2.5D е…Ҳиҝӣе°ҒиЈ…жҠҖжңҜпјҢ并йқһзӢ¬з«ӢдәҺеҚҠеҜјдҪ“еҲ¶йҖ жөҒзЁӢд№ӢеӨ–зҡ„жҠҖжңҜпјҢиҖҢжҳҜеҜ№дј з»ҹеҲ¶йҖ дёҺе°ҒиЈ…жөҒзЁӢзҡ„ж·ұеәҰиһҚеҗҲдёҺеҲӣж–°гҖӮе®ғйҖҡиҝҮзЎ…дёӯд»ӢеұӮе®һзҺ°дәҶеӨҡиҠҜзүҮзҡ„й«ҳеҜҶеәҰдә’иҒ”пјҢ既继жүҝдәҶжҷ¶еңҶеҲ¶йҖ зҡ„зІҫеҜҶе·ҘиүәпјҲеҰӮе…үеҲ»гҖҒеҲ»иҡҖгҖҒжІүз§ҜпјүпјҢеҸҲжӢ“еұ•дәҶе°ҒиЈ…жҠҖжңҜзҡ„йӣҶжҲҗиғҪеҠӣпјҢжҲҗдёәж”Ҝж’‘AIгҖҒHPC зӯүй«ҳжҖ§иғҪи®Ўз®—йўҶеҹҹеҸ‘еұ•зҡ„е…ій”®жҠҖжңҜгҖӮе®ғиҝһжҺҘдәҶеҚҠеҜјдҪ“еҲ¶йҖ зҡ„еүҚйҒ“гҖҒдёӯйҒ“гҖҒеҗҺйҒ“зҺҜиҠӮпјҢжҳҜеҚҠеҜјдҪ“дә§дёҡй“ҫдёӯд»ҺиҠҜзүҮеҲ¶йҖ еҲ°зі»з»ҹйӣҶжҲҗзҡ„е…ій”®жЎҘжўҒгҖӮ
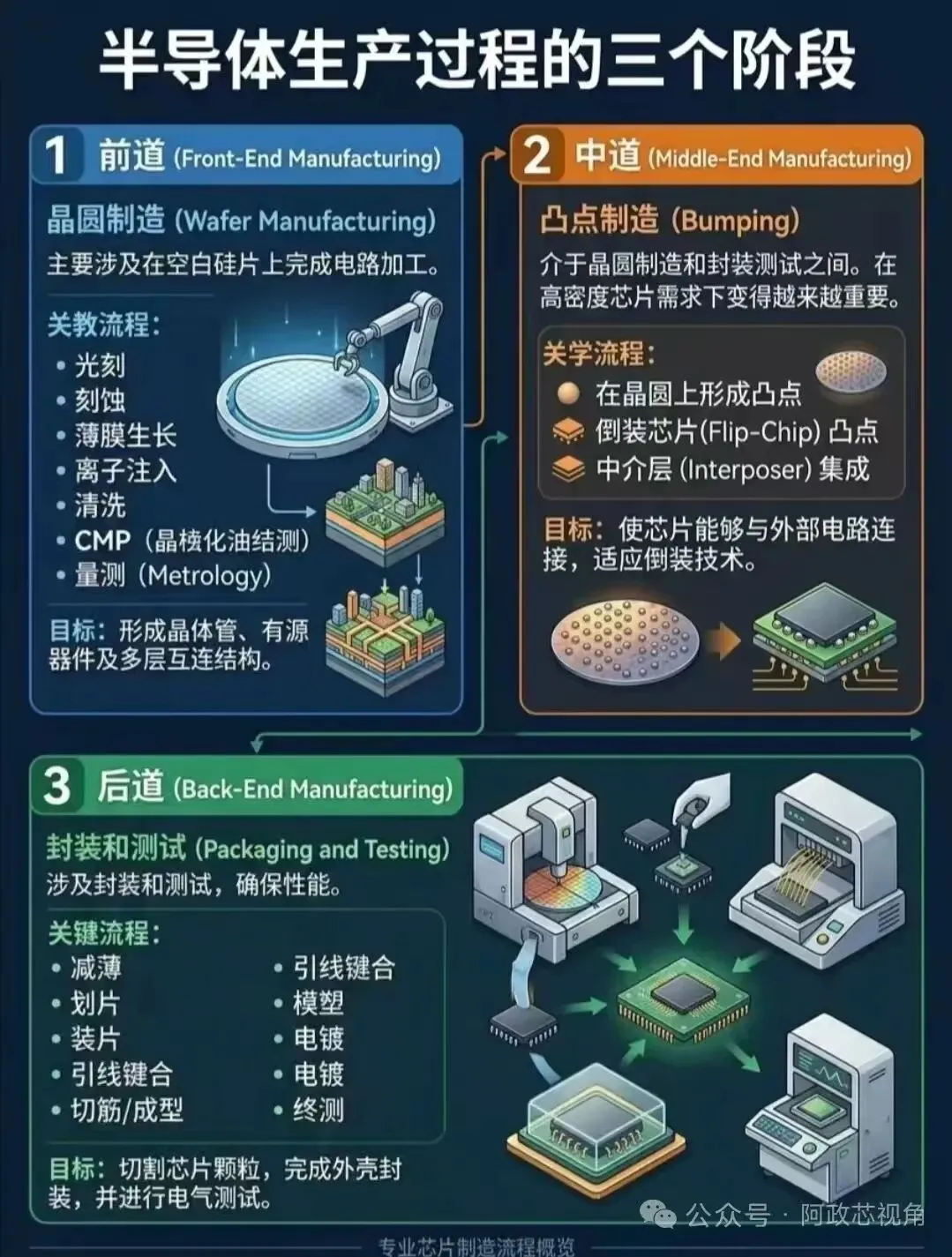
з»“еҗҲеҚҠеҜјдҪ“еүҚйҒ“-дёӯйҒ“-еҗҺйҒ“зҡ„еҲ¶йҖ жөҒзЁӢпјҢд»ҘеҸҠ CoWoS жҠҖжңҜзҡ„ж ёеҝғжһ„жҲҗпјҢе°ҶAиӮЎдә§дёҡй“ҫеҲҶдёәе°ҒиЈ…д»Је·ҘгҖҒж ёеҝғжқҗж–ҷгҖҒж ёеҝғи®ҫеӨҮгҖҒй…ҚеҘ—жңҚеҠЎеӣӣеӨ§зҺҜиҠӮпјҢеҜ№еә”йҫҷеӨҙдјҒдёҡеҸҠж ёеҝғдјҳеҠҝеҰӮдёӢпјҡ
пјҲдёҖпјүе°ҒиЈ…д»Је·ҘзҺҜиҠӮпјҲж ёеҝғйҮҸдә§зҺҜиҠӮпјҢеҜ№ж ҮеҸ°з§Ҝз”өCoWoS жҠҖжңҜиҗҪең°пјү
иҜҘзҺҜиҠӮжҳҜCoWoS жҠҖжңҜйҮҸдә§зҡ„ж ёеҝғпјҢзӣҙжҺҘеҶіе®ҡе°ҒиЈ…жҖ§иғҪдёҺиүҜзҺҮпјҢжҳҜеӣҪеҶ…дә§дёҡй“ҫзҡ„ж ёеҝғжҠ“жүӢгҖӮ
е°ҒиЈ…д»Је·ҘзҺҜиҠӮ | дёҠеёӮе…¬еҸё | ж ёеҝғдјҳеҠҝпјҲдёҺCoWoS ејәзӣёе…іпјү |
е°ҒжөӢ | й•ҝз”ө科жҠҖ пјҲ600584пјү | еӣҪеҶ…е°ҒжөӢйҫҷеӨҙгҖҒе…Ёзҗғ第дёүеӨ§е°ҒжөӢеҺӮе•ҶпјҢеӣҪеҶ…CoWoS еҗҢзұ»жҠҖжңҜз»қеҜ№йҫҷеӨҙгҖӮе…¶ XDFOIв„ўзі»еҲ—е°ҒиЈ…жҠҖжңҜе®Ңе…ЁеҜ№ж ҮеҸ°з§Ҝз”ө CoWoSпјҢе…·еӨҮ Chiplet ејӮжһ„йӣҶжҲҗгҖҒзЎ…дёӯд»ӢеұӮгҖҒTSVгҖҒй«ҳеҜҶеәҰеҫ®еҮёеқ—гҖҒRDL е…ЁжөҒзЁӢйҮҸдә§иғҪеҠӣпјҢе·Іе®һзҺ° 4nm е·ҘиүәиҠҜзүҮе…Ҳиҝӣе°ҒиЈ…йҮҸдә§пјҢдёҺеӣҪеҶ…еӨҡ家еӨҙйғЁ AI иҠҜзүҮеҺӮе•ҶиҫҫжҲҗж·ұеәҰеҗҲдҪңпјҢжҳҜеӣҪеҶ…е”ҜдёҖе…·еӨҮйЎ¶зә§ AI иҠҜзүҮе…Ҳиҝӣе°ҒиЈ…йҮҸдә§иғҪеҠӣзҡ„дјҒдёҡгҖӮ |
йҖҡеҜҢеҫ®з”ө пјҲ002156пјү | еӣҪеҶ…第дәҢеӨ§е°ҒжөӢеҺӮе•ҶпјҢAMD ж ёеҝғе°ҒжөӢеҗҲдҪңдјҷдјҙпјҢ2.5D/3D е…Ҳиҝӣе°ҒиЈ…жҠҖжңҜз§ҜзҙҜж·ұеҺҡгҖӮжҺҢжҸЎ TSVгҖҒеҫ®еҮёеқ—гҖҒеҖ’иЈ…з„ҠгҖҒRDL зӯү CoWoS ж ёеҝғе·ҘиүәпјҢ2.5D е°ҒиЈ…жҠҖжңҜе·Іе®һзҺ°еӨ§и§„жЁЎйҮҸдә§пјҢж·ұеәҰй…ҚеҘ—еӣҪеҶ… AI з®—еҠӣиҠҜзүҮгҖҒGPU иҠҜзүҮеҺӮе•ҶпјҢеҗҢж—¶еңЁиҪҰ规зә§е…Ҳиҝӣе°ҒиЈ…йўҶеҹҹе…·еӨҮйўҶе…ҲдјҳеҠҝпјҢеҸҜж»Ўи¶іжұҪиҪҰз”өеӯҗйўҶеҹҹзҡ„ CoWoS е°ҒиЈ…йңҖжұӮгҖӮ | |
еҚҺеӨ©з§‘жҠҖ пјҲ002185пјү | еӣҪеҶ…е°ҒжөӢеӨҙйғЁдјҒдёҡпјҢе·Іе®һзҺ°2.5D е…Ҳиҝӣе°ҒиЈ…жҠҖжңҜзӘҒз ҙпјҢжҺҢжҸЎ TSVгҖҒзЎ…дёӯд»ӢеұӮгҖҒй«ҳеҜҶеәҰеҖ’иЈ…з„Ҡзӯүж ёеҝғе·ҘиүәпјҢFan-outгҖҒ2.5D е°ҒиЈ…жҠҖжңҜе·Іиҝӣе…ҘйҮҸдә§йҳ¶ж®өгҖӮиҒҡз„Ұдёӯз«Ҝ AI иҠҜзүҮгҖҒж¶Ҳиҙ№з”өеӯҗгҖҒжұҪиҪҰз”өеӯҗйўҶеҹҹпјҢе…·еӨҮжҳҫи‘—зҡ„жҲҗжң¬дјҳеҠҝпјҢжҳҜеӣҪеҶ… CoWoS жҠҖжңҜдёӢжІүеёӮеңәзҡ„ж ёеҝғй…ҚеҘ—еҺӮе•ҶгҖӮ |
пјҲдәҢпјүж ёеҝғжқҗж–ҷзҺҜиҠӮпјҲCoWoS е°ҒиЈ…жҲҗжң¬ж ёеҝғпјҢеӣҪдә§еҢ–жӣҝд»Јж ёеҝғиөӣйҒ“пјү
жқҗж–ҷжҲҗжң¬еҚ е…Ҳиҝӣе°ҒиЈ…жҖ»жҲҗжң¬зҡ„60% д»ҘдёҠпјҢеҜ№еә”ж–ҮжЎЈдёӯзЎ…дёӯд»ӢеұӮгҖҒе°ҒиЈ…еҹәжқҝгҖҒTSVгҖҒеҫ®еҮёеқ—гҖҒBGA й”ЎзҗғгҖҒж•Јзғӯзӯүж ёеҝғзҺҜиҠӮпјҢж ёеҝғйҫҷеӨҙеҰӮдёӢпјҡ
ж ёеҝғжқҗж–ҷзҺҜиҠӮ | дёҠеёӮе…¬еҸё | ж ёеҝғдјҳеҠҝпјҲдёҺCoWoS ејәзӣёе…іпјү |
е°ҒиЈ…еҹәжқҝ пјҲWoS зҺҜиҠӮж ёеҝғпјҢCoWoS е°ҒиЈ…жңҖеӨ§зү©ж–ҷжҲҗжң¬йЎ№пјү | ж·ұеҚ—з”өи·Ҝ пјҲ002916пјү | еӣҪеҶ…IC иҪҪжқҝйҫҷеӨҙпјҢеӣҪеҶ…е°‘ж•°е…·еӨҮй«ҳз«Ҝ FC-BGA е°ҒиЈ…еҹәжқҝйҮҸдә§иғҪеҠӣзҡ„дјҒдёҡпјҢFC-BGA еҹәжқҝжҳҜ CoWoS е°ҒиЈ…зҡ„ж ёеҝғеҹәжқҝгҖӮе·Іе®һзҺ° 2.5D/3D е…Ҳиҝӣе°ҒиЈ…з”Ё FC-BGA еҹәжқҝзҡ„жҠҖжңҜзӘҒз ҙдёҺе°Ҹжү№йҮҸйҮҸдә§пјҢж·ұеәҰй…ҚеҘ—еӣҪеҶ…еӨҙйғЁе°ҒжөӢеҺӮе•ҶдёҺ AI иҠҜзүҮеҺӮе•ҶпјҢжҠҖжңҜеЈҒеһ’еӣҪеҶ…йўҶе…ҲгҖӮ |
е…ҙ森科жҠҖ пјҲ002436пјү | еӣҪеҶ…е°ҒиЈ…еҹәжқҝеӨҙйғЁдјҒдёҡпјҢFC-BGA е°ҒиЈ…еҹәжқҝе·Іе®һзҺ°йҮҸдә§пјҢдә§иғҪжҢҒз»ӯжү©еј пјҢиҒҡз„Ұ AI иҠҜзүҮгҖҒHPC з”Ёй«ҳз«Ҝе°ҒиЈ…еҹәжқҝпјҢдёҺй•ҝз”ө科жҠҖгҖҒйҖҡеҜҢеҫ®з”өзӯүе°ҒжөӢйҫҷеӨҙиҫҫжҲҗж·ұеәҰеҗҲдҪңпјҢжҳҜ CoWoS е°ҒиЈ…еҹәжқҝеӣҪдә§еҢ–зҡ„ж ёеҝғеҺӮе•ҶгҖӮ | |
зЎ…дёӯд»ӢеұӮ/TSVж ёеҝғ жқҗж–ҷ пјҲCoW зҺҜиҠӮж ёеҝғпјү | з«ӢжҳӮеҫ® пјҲ605358пјү | еӣҪеҶ…зЎ…зүҮйҫҷеӨҙпјҢе…·еӨҮ8/12 иӢұеҜёзЎ…зүҮйҮҸдә§иғҪеҠӣпјҢеҸҜжҸҗдҫӣ CoWoS е°ҒиЈ…з”ЁзЎ…дёӯд»ӢеұӮжҷ¶еңҶпјҢеҗҢж—¶жҺҢжҸЎ TSV зЎ…йҖҡеӯ”еҠ е·Ҙе·ҘиүәпјҢжҳҜеӣҪеҶ…зЎ…дёӯд»ӢеұӮжқҗж–ҷзҡ„ж ёеҝғдҫӣеә”е•ҶгҖӮ |
йӣ…е…Ӣ科жҠҖ пјҲ002409пјү | еӣҪеҶ…з”өеӯҗжқҗж–ҷйҫҷеӨҙпјҢTSV з”Ёе…үеҲ»иғ¶гҖҒж—Ӣж¶Ӯз»қзјҳд»ӢиҙЁпјҲSOIпјүжқҗж–ҷе·Іе®һзҺ°йҮҸдә§пјҢжҳҜ CoWoS е°ҒиЈ… TSV е·Ҙиүәзҡ„ж ёеҝғжқҗж–ҷдҫӣеә”е•ҶпјҢеҗҢж—¶е…·еӨҮе°ҒиЈ…з”ЁеүҚй©ұдҪ“гҖҒж№ҝз”өеӯҗеҢ–еӯҰе“Ғе…Ёе“Ғзұ»й…ҚеҘ—иғҪеҠӣ | |
еҫ®еҮёеқ—/й”®еҗҲдә’иҒ”жқҗж–ҷ | е®үйӣҶ科жҠҖ пјҲ688019пјү | еӣҪеҶ…жҠӣе…үж¶ІйҫҷеӨҙпјҢе…¶з”өй•Җж¶ІгҖҒCMP жҠӣе…үж¶ІжҳҜеҫ®еҮёеқ—еҲ¶йҖ гҖҒRDL е·Ҙиүәзҡ„ж ёеҝғжқҗж–ҷпјҢе·Іе®һзҺ° 2.5D е…Ҳиҝӣе°ҒиЈ…з”Ёдә§е“ҒйҮҸдә§пјҢй…ҚеҘ—еӣҪеҶ…е°ҒжөӢйҫҷеӨҙпјҢжү“з ҙжө·еӨ–еһ„ж–ӯгҖӮ |
жңүз ”ж–°жқҗ пјҲ600206пјү | еӣҪеҶ…иҙөйҮ‘еұһжқҗж–ҷйҫҷеӨҙпјҢе…·еӨҮе°ҒиЈ…з”Ёз„Ҡж–ҷгҖҒжә…е°„йқ¶жқҗгҖҒеҫ®еҮёеқ—з”ЁйҮ‘й”Ўз„Ҡж–ҷйҮҸдә§иғҪеҠӣпјҢжҳҜCoWoS еҫ®еҮёеқ—гҖҒеҖ’иЈ…з„Ҡе·Ҙиүәзҡ„ж ёеҝғжқҗж–ҷдҫӣеә”е•ҶпјҢдә§е“Ғе·ІйҖҡиҝҮеӣҪеҶ…еӨҙйғЁе°ҒжөӢеҺӮе•Ҷи®ӨиҜҒгҖӮ | |
еә·ејәз”өеӯҗ пјҲ002119пјү | еӣҪеҶ…й”®еҗҲжқҗж–ҷйҫҷеӨҙпјҢе…·еӨҮй”®еҗҲдёқгҖҒBGA й”ЎзҗғйҮҸдә§иғҪеҠӣпјҢе…¶й«ҳеҜҶеәҰй”®еҗҲдёқгҖҒBGA й”Ўзҗғе·Ій…ҚеҘ—е…Ҳиҝӣе°ҒиЈ…йўҶеҹҹпјҢжҳҜ CoWoS е°ҒиЈ…зҡ„ж ёеҝғеҹәзЎҖжқҗж–ҷеҺӮе•ҶгҖӮ | |
зғӯз®ЎзҗҶжқҗж–ҷ | дёӯзҹіз§‘жҠҖ пјҲ300684пјү | еӣҪеҶ…еҜјзғӯж•Јзғӯжқҗж–ҷйҫҷеӨҙпјҢе…·еӨҮй«ҳеҜјзғӯзҹіеўЁзүҮгҖҒеҜјзғӯз•Ңйқўжқҗж–ҷгҖҒж¶ІеҶ·ж•ЈзғӯжЁЎз»„йҮҸдә§иғҪеҠӣпјҢеҸҜжҸҗдҫӣCoWoS е°ҒиЈ…з”Ёе®ҡеҲ¶еҢ–ж•Јзғӯи§ЈеҶіж–№жЎҲпјҢй…ҚеҘ— AI жңҚеҠЎеҷЁгҖҒй«ҳз«ҜиҠҜзүҮеҺӮе•ҶгҖӮ |
йЈһиҚЈиҫҫ пјҲ300602пјү | еӣҪеҶ…з”өзЈҒеұҸи”ҪдёҺж•Јзғӯжқҗж–ҷйҫҷеӨҙпјҢе…¶й«ҳеҜјзғӯзЎ…иғ¶зүҮгҖҒVC еқҮзғӯжқҝгҖҒж¶ІеҶ·ж•Јзғӯжқҝе·Із”ЁдәҺ 2.5D е…Ҳиҝӣе°ҒиЈ…иҠҜзүҮж•ЈзғӯпјҢй…ҚеҘ—еӣҪеҶ… AI з®—еҠӣиҠҜзүҮгҖҒжңҚеҠЎеҷЁеҺӮе•ҶпјҢжҳҜ CoWoS зғӯз®ЎзҗҶзҺҜиҠӮзҡ„ж ёеҝғдҫӣеә”е•ҶгҖӮ |
пјҲдёүпјүж ёеҝғи®ҫеӨҮзҺҜиҠӮпјҲCoWoS жҠҖжңҜйҮҸдә§зҡ„еә•еұӮж”Ҝж’‘пјҢеӣҪдә§жӣҝд»ЈжҲҳз•ҘиөӣйҒ“пјү
еүҚйҒ“-дёӯйҒ“-еҗҺйҒ“е…ЁжөҒзЁӢе·ҘиүәпјҢиҰҶзӣ–е…үеҲ»гҖҒеҲ»иҡҖгҖҒй”®еҗҲгҖҒжөӢиҜ•зӯүж ёеҝғзҺҜиҠӮпјҢйҫҷеӨҙдјҒдёҡеҰӮдёӢпјҡ
ж ёеҝғи®ҫеӨҮзҺҜиҠӮ | дёҠеёӮе…¬еҸё | ж ёеҝғдјҳеҠҝпјҲдёҺCoWoS ејәзӣёе…іпјү |
еҲ»иҡҖ/е…үеҲ»ж ёеҝғи®ҫеӨҮ | дёӯеҫ®е…¬еҸёпјҲ688012пјү | еӣҪеҶ…еҲ»иҡҖи®ҫеӨҮйҫҷеӨҙпјҢе…¶TSV зЎ…йҖҡеӯ”еҲ»иҡҖжңәгҖҒй«ҳеҜҶеәҰзӯүзҰ»еӯҗдҪ“еҲ»иҡҖжңәе·Іе®һзҺ°еӨ§и§„жЁЎйҮҸдә§пјҢжҳҜ CoWoS е°ҒиЈ… TSVгҖҒRDL е·Ҙиүәзҡ„ж ёеҝғи®ҫеӨҮпјҢе·Іиҝӣе…ҘеҸ°з§Ҝз”өгҖҒеӣҪеҶ…е°ҒжөӢйҫҷеӨҙдҫӣеә”й“ҫпјҢжҠҖжңҜж°ҙе№іе…ЁзҗғйўҶе…ҲгҖӮ |
еҢ—ж–№еҚҺеҲӣпјҲ002371пјү | еӣҪеҶ…еҚҠеҜјдҪ“и®ҫеӨҮе…Ёе“Ғзұ»йҫҷеӨҙпјҢе…·еӨҮеҲ»иҡҖжңәгҖҒи–„иҶңжІүз§ҜгҖҒз”өй•ҖгҖҒPVD зӯүи®ҫеӨҮйҮҸдә§иғҪеҠӣпјҢе…¶ TSV еҲ»иҡҖжңәгҖҒеҮёеқ—з”өй•Җи®ҫеӨҮгҖҒRDL з”Ёи–„иҶңжІүз§Ҝи®ҫеӨҮе·Іе…Ёйқўй…ҚеҘ—еӣҪеҶ…е…Ҳиҝӣе°ҒиЈ…дә§зәҝпјҢжҳҜ CoWoS е°ҒиЈ…и®ҫеӨҮеӣҪдә§еҢ–зҡ„ж ёеҝғйҫҷеӨҙгҖӮ | |
иҠҜжәҗеҫ® пјҲ688037пјү | еӣҪеҶ…ж¶Ӯиғ¶жҳҫеҪұи®ҫеӨҮйҫҷеӨҙпјҢе…Ҳиҝӣе°ҒиЈ…з”Ёж¶Ӯиғ¶жҳҫеҪұи®ҫеӨҮе·Іе®һзҺ°еӨ§и§„жЁЎйҮҸдә§пјҢеҸҜиҰҶзӣ–CoWoS е°ҒиЈ…зҡ„е…үеҲ»е·ҘиүәйңҖжұӮпјҢй…ҚеҘ—еӣҪеҶ…жүҖжңүеӨҙйғЁе°ҒжөӢеҺӮе•ҶпјҢжү“з ҙжө·еӨ–еһ„ж–ӯгҖӮ | |
иҠҜзўҒеҫ®иЈ…пјҲ688630пјү | еӣҪеҶ…зӣҙеҶҷе…үеҲ»и®ҫеӨҮйҫҷеӨҙпјҢе…ЁзҗғPCB зӣҙжҺҘжҲҗеғҸи®ҫеӨҮеёӮеҚ зҺҮ第дёҖпјҢе…¶жҷ¶еңҶзә§зӣҙеҶҷе…үеҲ»и®ҫеӨҮе·ІйҖҡиҝҮеҸ°з§Ҝз”ө CoWoS-L дә§зәҝйӘҢиҜҒпјҢжҳҜеӣҪеҶ…йҰ–家иҝӣе…ҘеҸ°з§Ҝз”өе…Ҳиҝӣе°ҒиЈ…е…үеҲ»и®ҫеӨҮдҫӣеә”й“ҫзҡ„еҺӮе•ҶгҖӮи®ҫеӨҮеҸҜе…ЁиҰҶзӣ– CoWoS е°ҒиЈ… RDL йҮҚеҲҶеёғеұӮгҖҒзЎ… / жңүжңәдёӯд»ӢеұӮгҖҒеҫ®еҮёеқ—еҲ¶йҖ зҡ„ж ёеҝғе…үеҲ»е·ҘиүәпјҢеҗҢж—¶йҖӮй…Қ FC-BGA е°ҒиЈ…еҹәжқҝзҡ„й«ҳзІҫеҜҶзәҝи·ҜеҠ е·ҘпјҢе·Іжү№йҮҸеҜје…Ҙй•ҝз”ө科жҠҖгҖҒйҖҡеҜҢеҫ®з”өзӯүеӣҪеҶ…е°ҒжөӢйҫҷеӨҙдә§зәҝпјҢжҳҜ CoWoS жҠҖжңҜеӣҪдә§еҢ–жӣҝд»Јзҡ„ж ёеҝғе…үеҲ»и®ҫеӨҮдҫӣеә”е•ҶгҖӮ | |
й”®еҗҲ/иҙҙиЈ…ж ёеҝғи®ҫеӨҮ | ж–ҮдёҖ科жҠҖпјҲ600520пјү | еӣҪеҶ…й«ҳз«Ҝе°ҒиЈ…и®ҫеӨҮеҺӮе•ҶпјҢе…¶й«ҳз«ҜеҖ’иЈ…иҠҜзүҮй”®еҗҲжңәгҖҒжҷ¶еңҶзә§иҙҙиЈ…жңәе·Іе®һзҺ°жҠҖжңҜзӘҒз ҙпјҢеҸҜй…ҚеҘ—CoWoS е°ҒиЈ…зҡ„иҠҜзүҮе ҶеҸ гҖҒжҷ¶еңҶиҙҙиЈ…е·ҘиүәпјҢжҳҜеӣҪеҶ…е°‘ж•°е…·еӨҮй«ҳз«Ҝй”®еҗҲи®ҫеӨҮйҮҸдә§иғҪеҠӣзҡ„дјҒдёҡгҖӮ |
жөӢиҜ•/йҮҸжөӢи®ҫеӨҮ | еҚҺеі°жөӢжҺ§пјҲ688200пјү | еӣҪеҶ…еҚҠеҜјдҪ“жөӢиҜ•жңәйҫҷеӨҙпјҢе…¶SoC жөӢиҜ•жңәгҖҒе…Ҳиҝӣе°ҒиЈ…з”ЁжөӢиҜ•зі»з»ҹе·Іе®һзҺ°йҮҸдә§пјҢеҸҜиҰҶзӣ– CoWoS е°ҒиЈ…иҠҜзүҮзҡ„е…ЁеҠҹиғҪжөӢиҜ•пјҢй…ҚеҘ—еӣҪеҶ…е°ҒжөӢйҫҷеӨҙе’Ң AI иҠҜзүҮеҺӮе•ҶгҖӮ |
й•ҝе·қ科жҠҖпјҲ300604пјү | еӣҪеҶ…жөӢиҜ•и®ҫеӨҮйҫҷеӨҙпјҢе…·еӨҮжөӢиҜ•жңәгҖҒжҺўй’ҲеҸ°гҖҒеҲҶйҖүжңәе…Ёе“Ғзұ»й…ҚеҘ—иғҪеҠӣпјҢ2.5D/3D е…Ҳиҝӣе°ҒиЈ…з”ЁжөӢиҜ•и®ҫеӨҮе·Іе®һзҺ°еӨ§и§„жЁЎйҮҸдә§пјҢжҳҜ CoWoS е°ҒиЈ…жөӢиҜ•зҺҜиҠӮзҡ„ж ёеҝғдҫӣеә”е•ҶгҖӮ | |
еҚҺжө·жё…科пјҲ688120пјү | еӣҪеҶ…CMP жҠӣе…үи®ҫеӨҮйҫҷеӨҙпјҢ12 иӢұеҜёжҷ¶еңҶзә§ CMP и®ҫеӨҮе·Іе®һзҺ°еӨ§и§„жЁЎйҮҸдә§пјҢеҸҜиҰҶзӣ– CoWoS е°ҒиЈ…зҡ„зЎ…дёӯд»ӢеұӮжҠӣе…үгҖҒTSV е·ҘиүәжҠӣе…үйңҖжұӮпјҢиҝӣе…ҘеӣҪеҶ…еӨҙйғЁе°ҒжөӢеҺӮе•Ҷе’Ңжҷ¶еңҶеҺӮдҫӣеә”й“ҫгҖӮ |
пјҲеӣӣпјүй…ҚеҘ—жңҚеҠЎзҺҜиҠӮпјҲCoWoS жҠҖжңҜиҗҪең°зҡ„ж ёеҝғй…ҚеҘ—пјү
й…ҚеҘ—жңҚеҠЎзҺҜиҠӮ | дёҠеёӮе…¬еҸё | ж ёеҝғдјҳеҠҝпјҲдёҺCoWoS ејәзӣёе…іпјү |
й…ҚеҘ—жңҚеҠЎ | жҫңиө·з§‘жҠҖ пјҲ688008пјү | е…ЁзҗғеҶ…еӯҳжҺҘеҸЈиҠҜзүҮйҫҷеӨҙпјҢе…·еӨҮHBM еҶ…еӯҳзј“еҶІиҠҜзүҮйҮҸдә§иғҪеҠӣпјҢжҳҜ CoWoS е°ҒиЈ…дёӯ HBM еҶ…еӯҳзҡ„ж ёеҝғй…ҚеҘ—еҺӮе•ҶпјҢеҗҢж—¶жҺҢжҸЎ UCle й«ҳйҖҹдә’иҒ”жҺҘеҸЈжҠҖжңҜпјҢеҸҜжҸҗдҫӣ Chiplet дә’иҒ”и§ЈеҶіж–№жЎҲпјҢжҳҜ AI иҠҜзүҮ CoWoS е°ҒиЈ…зҡ„ж ёеҝғй…ҚеҘ—дјҒдёҡгҖӮ |
иҠҜеҺҹиӮЎд»Ҫ пјҲ688521пјү | еӣҪеҶ…еҚҠеҜјдҪ“IP дёҺи®ҫи®ЎжңҚеҠЎйҫҷеӨҙпјҢе…·еӨҮ Chiplet ејӮжһ„йӣҶжҲҗи®ҫи®ЎиғҪеҠӣпјҢеҸҜжҸҗдҫӣ 2.5D/3D е…Ҳиҝӣе°ҒиЈ…зҡ„иҠҜзүҮи®ҫи®Ўе…ЁжөҒзЁӢи§ЈеҶіж–№жЎҲпјҢй…ҚеҘ—еӣҪеҶ… AI иҠҜзүҮеҺӮе•Ҷзҡ„ CoWoS е°ҒиЈ…и®ҫи®ЎйңҖжұӮпјҢжҳҜеӣҪеҶ…е…Ҳиҝӣе°ҒиЈ…и®ҫи®ЎжңҚеҠЎзҡ„йҫҷеӨҙдјҒдёҡгҖӮ |
еЈ°жҳҺпјҡ
пјҲ1пјүжң¬ж–ҮеҲ—дёҫзҡ„дёҠеёӮе…¬еҸёж Үзҡ„д»…з”ЁдәҺз ”з©¶еҲҶжһҗпјҢдёҚжһ„жҲҗдёӘиӮЎжҺЁиҚҗ
пјҲ2пјүжң¬ж–ҮеӣҫзүҮеј•иҮӘе…¬дј—еҸ·пјҡйҳҝж”ҝиҠҜи§Ҷи§’


