
Q1: 混合键合是什么? 先进封装已成为驱动算力持续提升的“后摩尔时代”新引擎,键合技术的性能直接决定了集成系统的上限。键合技术本身经历了从引线键合、倒装芯片、热压键合到扇出封装的演进,最终迈向混合键合时代。混合键合通过铜-铜直接键合取代传统凸块,实现了10μm以下的超精细间距互连,在互连密度、带宽、能效和单位互连成本上带来数量级提升,是支撑3D堆叠与异构集成的关键突破。其工艺分为晶圆对晶圆(适合存储等均匀小芯片)和芯片对晶圆(适合大芯片及异构语言学习平台集成)。目前,混合键合已在3D NAND、CIS(取代TSV)等领域成熟应用,并正加速向HBM、AI芯片、DDR6+及SoIC等高性能计算场景扩展,成为突破算力与带宽瓶颈、重塑产业链价值的核心使能技术。
下载链接
1、内部培训资料:液冷AIDC行业趋势及技术路线分析
2、内部培训资料:中国AIDC液冷服务器市场分析
50+行业深度:行业概述、市场现状及空间、产业链及相关公司深度梳理
Q2:混合键合的优势与挑战?混合键合拥有极致互连密度与性能突破、工艺兼容性与成本优化潜力以及三维集成与异构设计灵活性等优势。然而要成功大批量生产混合键合,需要解决与缺陷控制、对准精度、热管理、晶圆翘曲、材料兼容性和工艺吞吐量等相关的挑战。
Q3:混合键合设备未来市场需求?混合键合技术正从先进选项转变为AI时代的核心基础设施。在存储领域,HBM5为实现20hi超高堆叠采用此项“无凸块”技术以突破物理极限;在逻辑集成侧,以台积电SoIC为代表的技术借其实现超高密度异构集成。行业已进入高速落地期:台积电等大厂提前扩产,HBM4/5与高端AI芯片将率先规模应用,相关设备需求预计在2030年前实现数倍增长,标志着该技术已成为驱动下一代算力的确定方向。
Q4:海内外及中国大陆主要有哪些企业参与?混合键合设备市场呈现“海外主导、国产突破”的鲜明格局。荷兰BESI凭借在高端市场的深厚积累占据全球约70%的份额,呈现绝对龙头地位。与此同时,中国设备商正加速追赶并实现从零到一的突破:拓荆科技已推出首台量产级混合键合设备并获得重复订单,引领国产化进程;百敖化学、迈为股份的混合键合设备已交付客户并进入产业化验证阶段。在行业高景气与国家大基金重点投入的驱动下,国产设备正凭借不断提升的精度与稳定性,在3D集成与先进封装的关键赛道上快速切入,市场份额有望持续提升。
Q5:BESI如何成为AI驱动下混合键合技术范式转换的核心受益者?BESI作为全球混合键合设备的绝对领导者,凭借其覆盖从传统封装到尖端2.5D/3D集成的完整设备组合,确立了在高性能计算市场的核心地位。其旗舰产品Datacon 8800 CHAMEO ultra plus AC能够实现100nm的对准精度与2000 CPH的吞吐量,标志着混合键合技术正从实验室走向规模化量产。


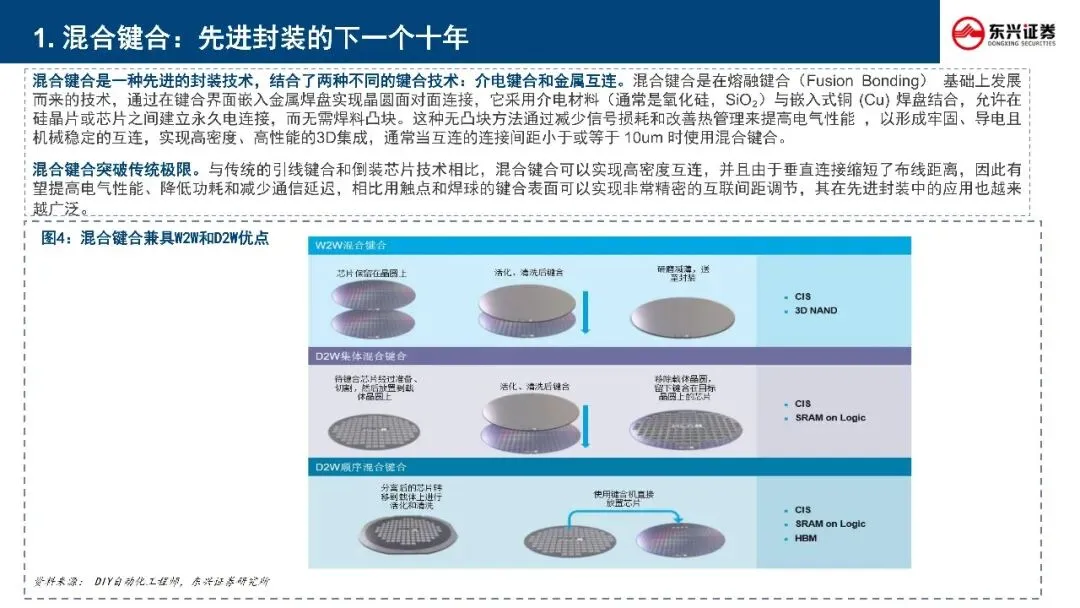
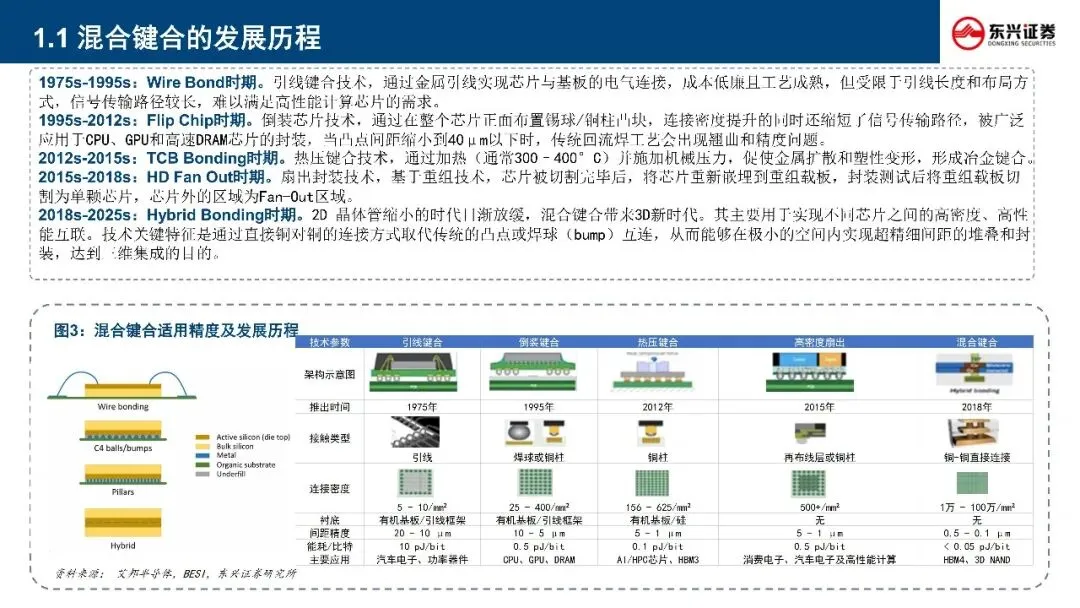


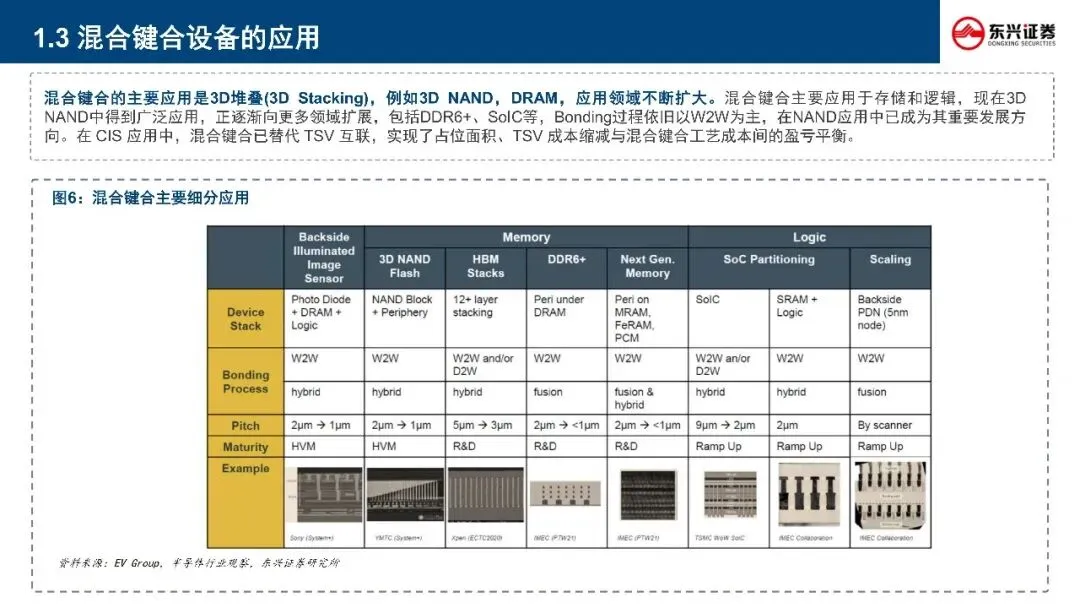





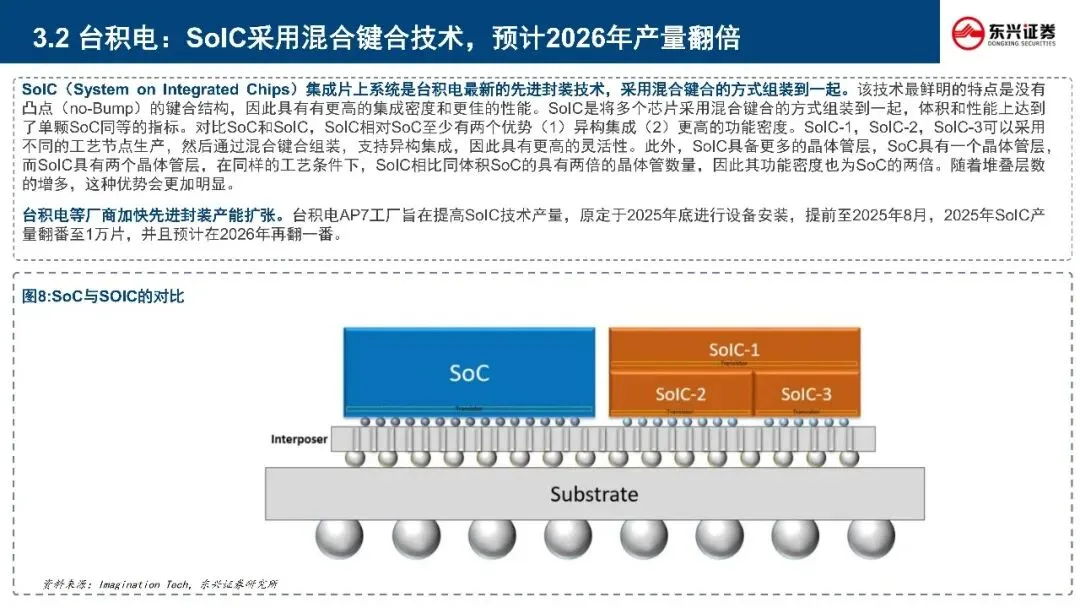




















———— 分割线 ————
本号资料全部上传至知识星球,更多内容请登录智能计算芯知识(知识星球)星球下载全部资料。
免责申明:本号聚焦相关技术分享,内容观点不代表本号立场,可追溯内容均注明来源,发布文章若存在版权等问题,请留言联系删除,谢谢。
温馨提示:
请搜索“扫码”加入星球,点击“阅读原文”获取更多原创技术干货。






