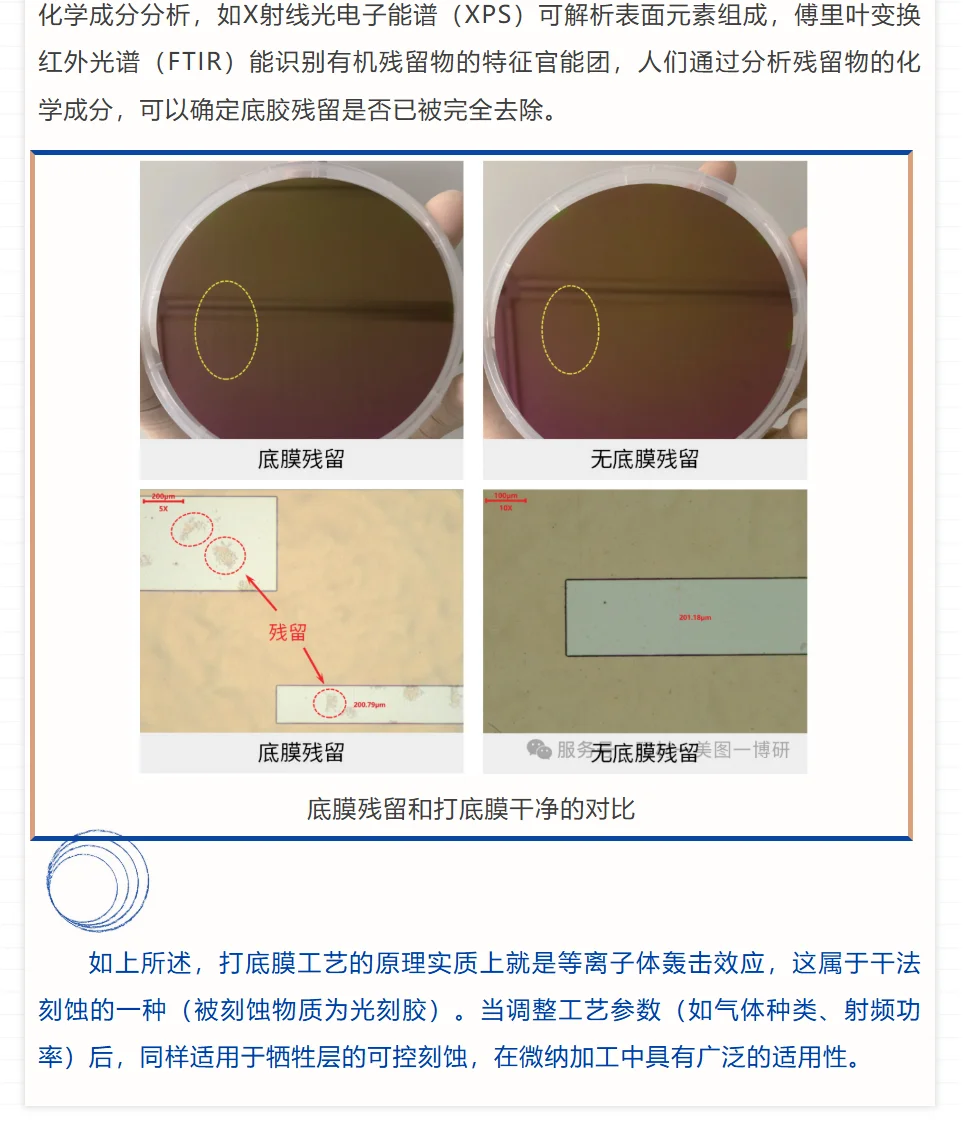






在光刻工艺中有一个常见的现象:光刻显影后,结构底部有时会残留一层光刻胶(或者是干燥后残留的显影液),这层底胶往往非常薄。(底膜的专业术语:显影工序后抗蚀剂形貌缺陷的一种,即底部有一部分光致抗蚀剂未被完全去除的现象,剖面形如脚形。)
由于底胶残留会导致的问题,所以在进行后续工艺前,人们需要去除底胶,该过程又称打底膜工艺。常用的等离子干法去胶是利用高能等离子体处理光刻胶表面,其机理是等离子体场把氧气激发到高能状态,将光刻胶成分氧化为气体并通过真空泵从反应室吸走。等离子体发生方式可以分为射频(RF)和微波。
等离子体去胶法速度快且去胶彻底,不需要引入化学物质,因此大大减少了对晶圆材料的腐蚀和损伤,是现有去胶工艺中最优的、有效且高效的方法,适用于半导体光刻胶的去除。打底胶工艺所需要去除的光刻胶层非常薄,因此人们不需要很长时间即可完成。但是,打底胶工艺需要注意:等离子体在灰化掉底胶的同时,可能会连带灰化本应保留的相邻光刻胶层。如果光刻胶被灰化得比较严重,会导致光刻胶的顶部轮廓变圆或形成顶切形态,这两种形貌均会显著增加后续剥离工艺的难度。
打底膜之后,需要检验残胶清除效果,从而判断是否可以进行下一步工艺。首先,可以使用光学显微镜检查样品表面,观察是否有残留的底胶或其他杂质。通过高倍率放大观察,可以检查样品表面的图案和结构是否清晰、完整,以及是否存在残胶或污染物。此外,也可以使用表面轮廓仪对样品表面的高度或轮廓进行测量。通过比较打底膜操作前后的表面高度或轮廓变化,间接评估残胶的去除效果。对于关键区域或纳米级薄膜残留,若想要更加精准地辨别打底膜的效果,则需借助扫描电子显微镜(SEM)对样品进行表面形貌的观察和分析。SEM具有高分辨率和高放大倍率的特点,能够更清晰地观察样品表面的微观结构和形貌。当需要判断残留物的化学属性时,可以使用化学分析技术对样品表面进行化学成分分析,如X射线光电子能谱(XPS)可解析表面元素组成,傅里叶变换红外光谱(FTIR)能识别有机残留物的特征官能团,人们通过分析残留物的化学成分,可以确定底胶残留是否已被完全去除。
如上所述,打底膜(干法)的原理实质上就是等离子体轰击效应,这属于干法刻蚀的一种(被刻蚀物质为光刻胶)。当调整工艺参数(如气体种类、射频功率)后,同样适用于牺牲层的可控刻蚀,在微纳加工中具有广泛的适用性。
#半导体 #工艺 #苏州美图半导体 #西安博研微纳
由于底胶残留会导致的问题,所以在进行后续工艺前,人们需要去除底胶,该过程又称打底膜工艺。常用的等离子干法去胶是利用高能等离子体处理光刻胶表面,其机理是等离子体场把氧气激发到高能状态,将光刻胶成分氧化为气体并通过真空泵从反应室吸走。等离子体发生方式可以分为射频(RF)和微波。
等离子体去胶法速度快且去胶彻底,不需要引入化学物质,因此大大减少了对晶圆材料的腐蚀和损伤,是现有去胶工艺中最优的、有效且高效的方法,适用于半导体光刻胶的去除。打底胶工艺所需要去除的光刻胶层非常薄,因此人们不需要很长时间即可完成。但是,打底胶工艺需要注意:等离子体在灰化掉底胶的同时,可能会连带灰化本应保留的相邻光刻胶层。如果光刻胶被灰化得比较严重,会导致光刻胶的顶部轮廓变圆或形成顶切形态,这两种形貌均会显著增加后续剥离工艺的难度。
打底膜之后,需要检验残胶清除效果,从而判断是否可以进行下一步工艺。首先,可以使用光学显微镜检查样品表面,观察是否有残留的底胶或其他杂质。通过高倍率放大观察,可以检查样品表面的图案和结构是否清晰、完整,以及是否存在残胶或污染物。此外,也可以使用表面轮廓仪对样品表面的高度或轮廓进行测量。通过比较打底膜操作前后的表面高度或轮廓变化,间接评估残胶的去除效果。对于关键区域或纳米级薄膜残留,若想要更加精准地辨别打底膜的效果,则需借助扫描电子显微镜(SEM)对样品进行表面形貌的观察和分析。SEM具有高分辨率和高放大倍率的特点,能够更清晰地观察样品表面的微观结构和形貌。当需要判断残留物的化学属性时,可以使用化学分析技术对样品表面进行化学成分分析,如X射线光电子能谱(XPS)可解析表面元素组成,傅里叶变换红外光谱(FTIR)能识别有机残留物的特征官能团,人们通过分析残留物的化学成分,可以确定底胶残留是否已被完全去除。
如上所述,打底膜(干法)的原理实质上就是等离子体轰击效应,这属于干法刻蚀的一种(被刻蚀物质为光刻胶)。当调整工艺参数(如气体种类、射频功率)后,同样适用于牺牲层的可控刻蚀,在微纳加工中具有广泛的适用性。
#半导体 #工艺 #苏州美图半导体 #西安博研微纳


