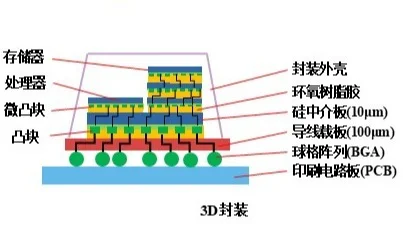
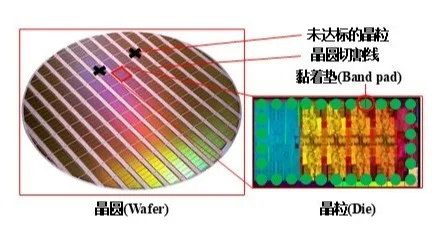
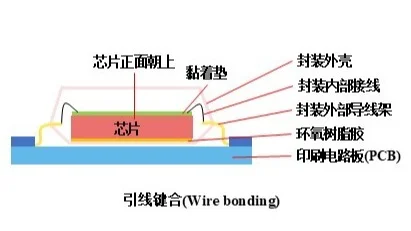

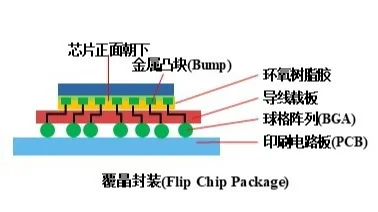
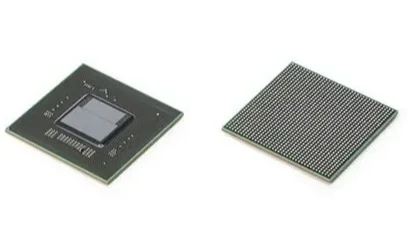
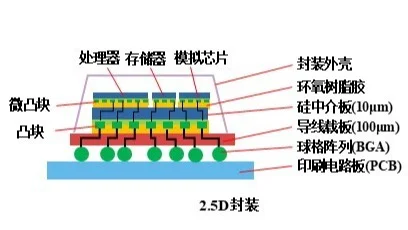
芯片封装是半导体中游产业必不可少的支撑部分。晶圆代工厂将制造好的硅晶圆提供给封装公司,封装公司将硅晶圆上的芯片进行切割分类并进行封装。
芯片封装可分为2类:引线键合封装和覆晶键合封装。
1.引线键合封装
芯片通过环氧树脂胶与封装外壳黏合在一起。封装芯片正面朝上,芯片上的黏着垫与封装导线相连,最终接到印刷电路板上。
2.覆晶键合封装
引线封装受限于芯片周长,难以使集成度继续增大。覆晶封装是在晶圆面上直接制作金属凸块,封装时芯片正面朝下,金属凸块可以直接连接到导线载板上,导线载板再通过球格阵列与印刷电路板焊接相连,实现了从2D周边互联到2D面阵互联的跨越,进一步提升了封装集成度。
但随着现代制程越来越先进,需要连接的芯片金属凸块也越来越多,使得封装载板面积增大,增大了信号传输时间,降低了芯片性能。为了解决这类问题,在原本的覆晶封装上进行了优化,出现了2.5D封装和3D封装。
2.5D封装
2.5D封装是将多个芯片并排放在一个硅中介层上。中介层内部有高密度细小走线,充当“高级电梯”,负责芯片之间的高速通信,再通过中介层下方的焊球连接到PCB。2.5D封装进一步提升了封装集成度,降低了信号传输时间。
3D封装
3D封装是在2.5D封装的基础上将多个芯片或芯片层垂直堆叠起来。中间的芯片层既要发挥它的芯片功能也要起到连接上下两层芯片的功能。
芯片封装的发展史,是一部从技术边缘走向舞台中央的历史。
过去封装=保护+电气连接+物理接口转换
现在与未来封装=提升系统性能、降低功耗、缩小体积、整合异构技术的核心手段#芯片 #电子元器件 #工业数字化 #工业自动化 #新一代电子信息技术
芯片封装可分为2类:引线键合封装和覆晶键合封装。
1.引线键合封装
芯片通过环氧树脂胶与封装外壳黏合在一起。封装芯片正面朝上,芯片上的黏着垫与封装导线相连,最终接到印刷电路板上。
2.覆晶键合封装
引线封装受限于芯片周长,难以使集成度继续增大。覆晶封装是在晶圆面上直接制作金属凸块,封装时芯片正面朝下,金属凸块可以直接连接到导线载板上,导线载板再通过球格阵列与印刷电路板焊接相连,实现了从2D周边互联到2D面阵互联的跨越,进一步提升了封装集成度。
但随着现代制程越来越先进,需要连接的芯片金属凸块也越来越多,使得封装载板面积增大,增大了信号传输时间,降低了芯片性能。为了解决这类问题,在原本的覆晶封装上进行了优化,出现了2.5D封装和3D封装。
2.5D封装
2.5D封装是将多个芯片并排放在一个硅中介层上。中介层内部有高密度细小走线,充当“高级电梯”,负责芯片之间的高速通信,再通过中介层下方的焊球连接到PCB。2.5D封装进一步提升了封装集成度,降低了信号传输时间。
3D封装
3D封装是在2.5D封装的基础上将多个芯片或芯片层垂直堆叠起来。中间的芯片层既要发挥它的芯片功能也要起到连接上下两层芯片的功能。
芯片封装的发展史,是一部从技术边缘走向舞台中央的历史。
过去封装=保护+电气连接+物理接口转换
现在与未来封装=提升系统性能、降低功耗、缩小体积、整合异构技术的核心手段#芯片 #电子元器件 #工业数字化 #工业自动化 #新一代电子信息技术


