В еҜј иҜ»В В
йҡҸзқҖе…ҲиҝӣеҲ¶зЁӢе·ҘиүәйҖҗжёҗйҖјиҝ‘зү©зҗҶжһҒйҷҗпјҢи¶ҠжқҘи¶ҠеӨҡеҺӮе•Ҷзҡ„з ”еҸ‘ж–№еҗ‘з”ұвҖңеҰӮдҪ•жҠҠиҠҜзүҮеҸҳеҫ—жӣҙе°ҸвҖқиҪ¬еҸҳдёәвҖңеҰӮдҪ•жҠҠиҠҜзүҮе°Ғеҫ—жӣҙе°ҸвҖқпјҢе…Ҳиҝӣе°ҒиЈ…еҝ«йҖҹеҸ‘еұ•гҖӮе…ҲиҝӣдёҺдј з»ҹе°ҒиЈ…жңҖеӨ§еҢәеҲ«еңЁдәҺиҠҜзүҮдёҺеӨ–йғЁз”өиҝһжҺҘж–№ејҸпјҢе…Ҳиҝӣе°ҒиЈ…зңҒз•Ҙеј•зәҝпјҢйҮҮеҸ–дј иҫ“йҖҹеәҰжӣҙеҝ«зҡ„еҮёеқ—гҖҒдёӯй—ҙеұӮзӯүпјҢдё»иҰҒеҢ…жӢ¬еҮёеқ—пјҲ Bump пјүгҖҒеҖ’иЈ…пјҲFlip ChipпјүгҖҒжҷ¶еңҶзә§е°ҒиЈ…пјҲWafer level packageпјүгҖҒеҶҚеҲҶеёғеұӮжҠҖжңҜпјҲRDLпјүе’ҢзЎ…йҖҡеӯ”пјҲTSVпјүжҠҖжңҜзӯүгҖӮ
жҲ‘еӣҪе°ҒжөӢдә§дёҡй“ҫиҫғдёәжҲҗзҶҹпјҢдҪҶе°ҒиЈ…и®ҫеӨҮеӣҪдә§еҢ–зҺҮиҫғдҪҺгҖӮ2022е№ҙе…Ёзҗғ委еӨ–е°ҒжөӢпјҲOSATпјүеҺӮе•ҶеүҚеҚҒеӨ§еҗҲи®ЎеҚ жҜ”зәҰ78%пјҢеҹәжң¬иў«дёӯеӣҪеҸ°ж№ҫе’ҢдёӯеӣҪеӨ§йҷҶеҺӮе•ҶеҢ…жҸҪпјҢдёӯеӣҪеҸ°ж№ҫж—ҘжңҲе…үгҖҒе®үйқ зӯүеҗҲи®ЎеҚ жҜ”зәҰ41%пјҢдёӯеӣҪеӨ§йҷҶй•ҝз”ө科жҠҖгҖҒйҖҡеҜҢеҫ®з”өеҚ зӯүеҗҲи®ЎеҚ жҜ”зәҰ25%пјӣдҪҶеӣҪеҶ…зјәд№ҸзҹҘеҗҚе°ҒиЈ…и®ҫеӨҮе•ҶпјҢе°ҒиЈ…и®ҫеӨҮеӣҪдә§еҢ–зҺҮдёҚи¶…иҝҮ5%пјҢдё»иҰҒзі»дә§дёҡж”ҝзӯ–еҗ‘еҲ¶зЁӢи®ҫеӨҮзӯүжңүжүҖеҖҫж–ңпјҢжңӘжқҘиҮӘдё»еҸҜжҺ§иғҢжҷҜеҸ еҠ еӣҪдә§и®ҫеӨҮе•ҶзӘҒз ҙпјҢе°ҒиЈ…и®ҫеӨҮзҡ„еӣҪдә§еҢ–зҺҮжңүжңӣиҝӣдёҖжӯҘжҸҗеҚҮгҖӮ
е…Ёж–ҮпјҲж— еҲ еҮҸпјү



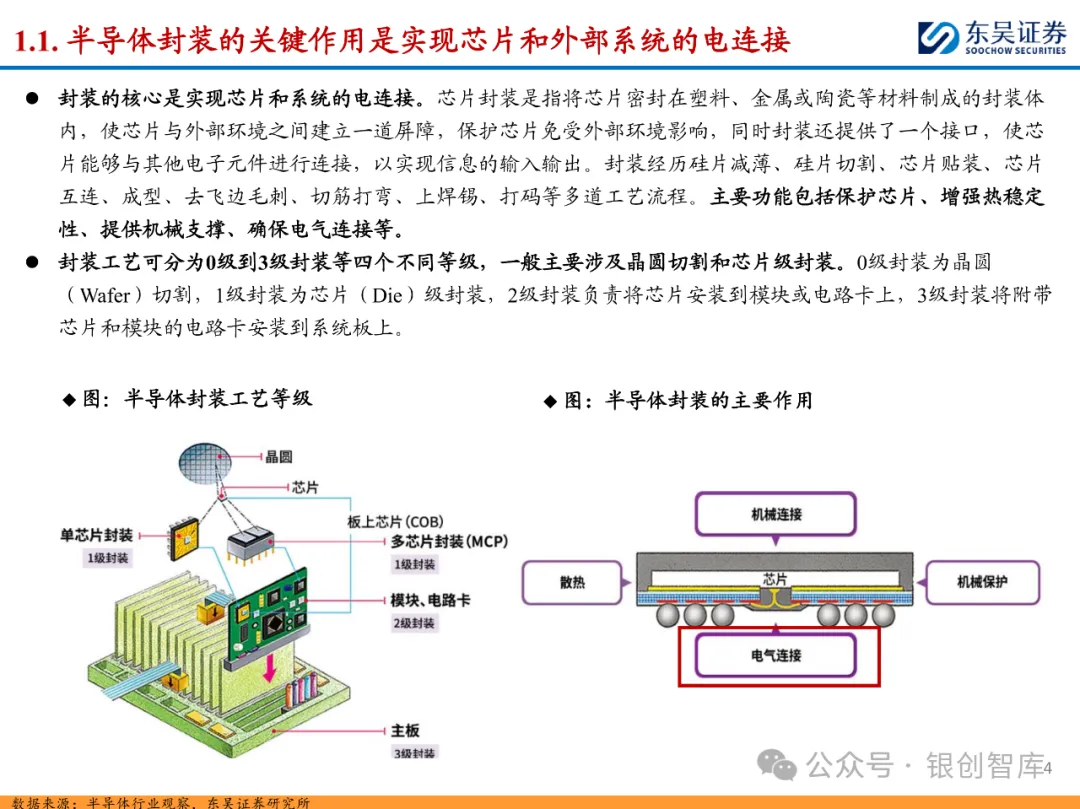
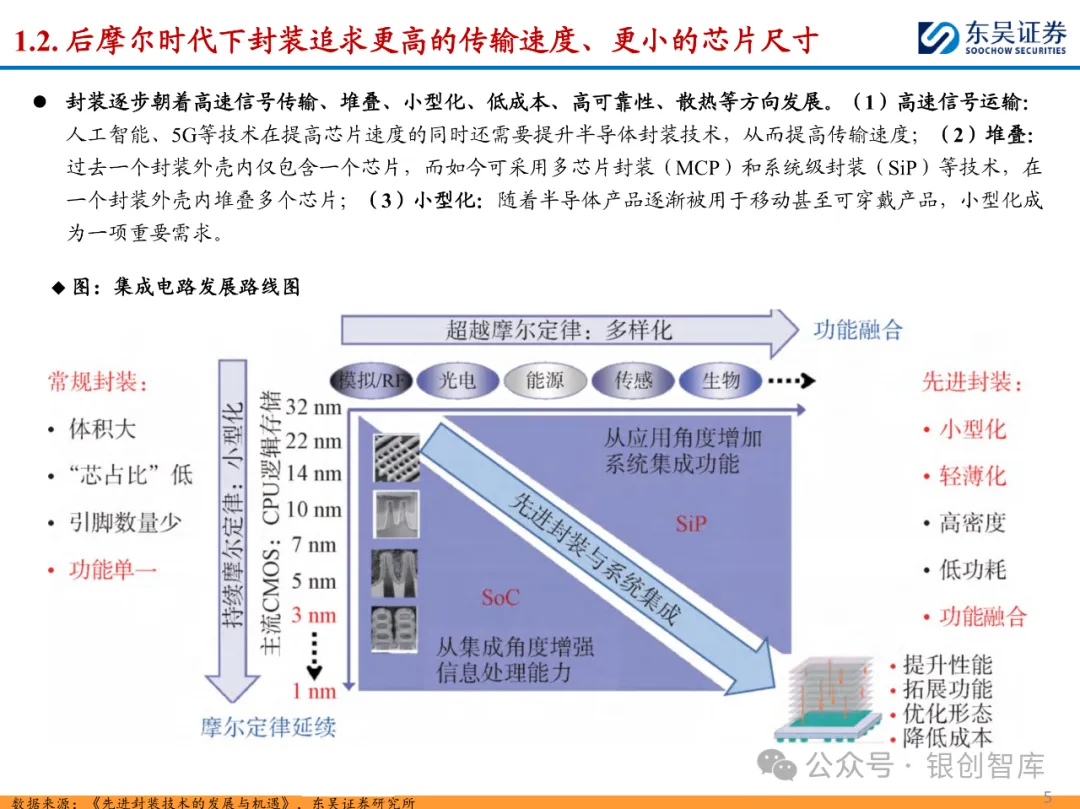

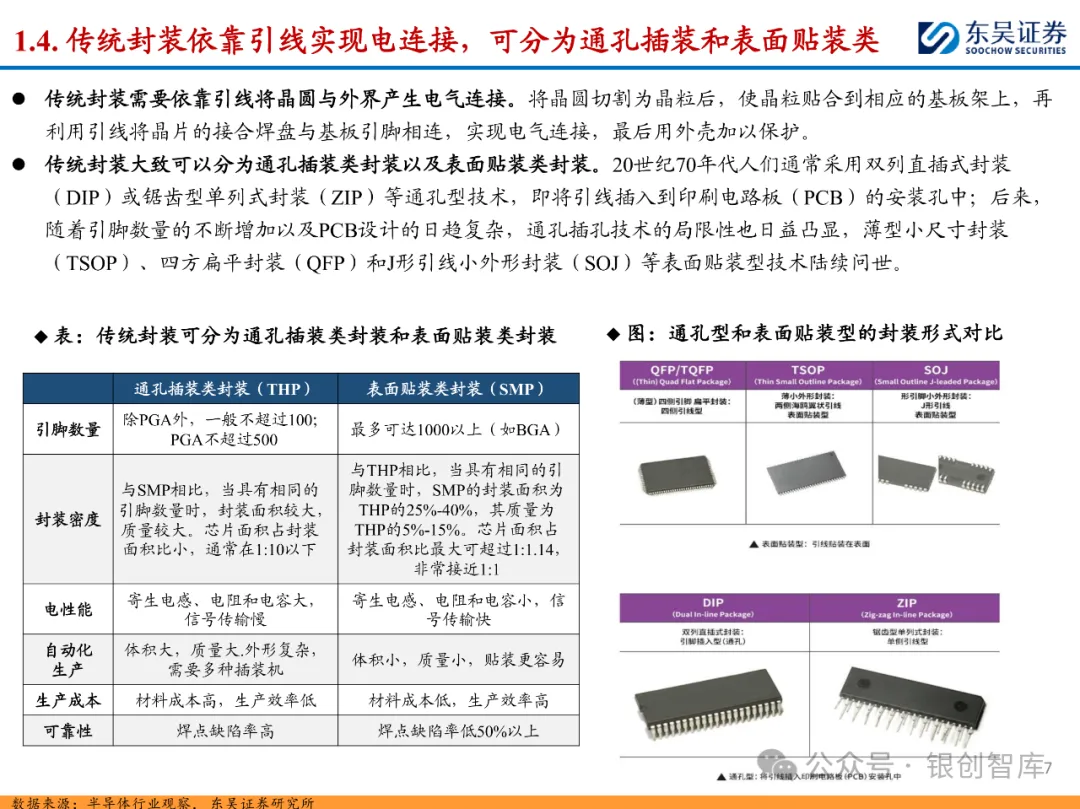
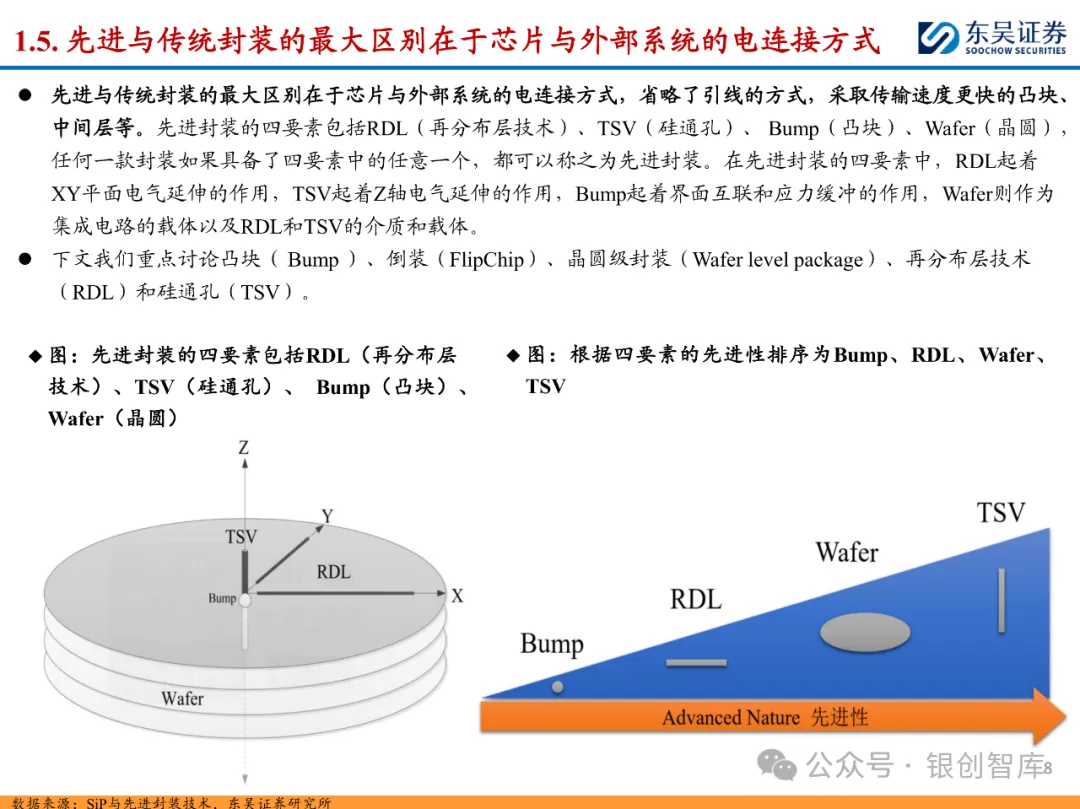

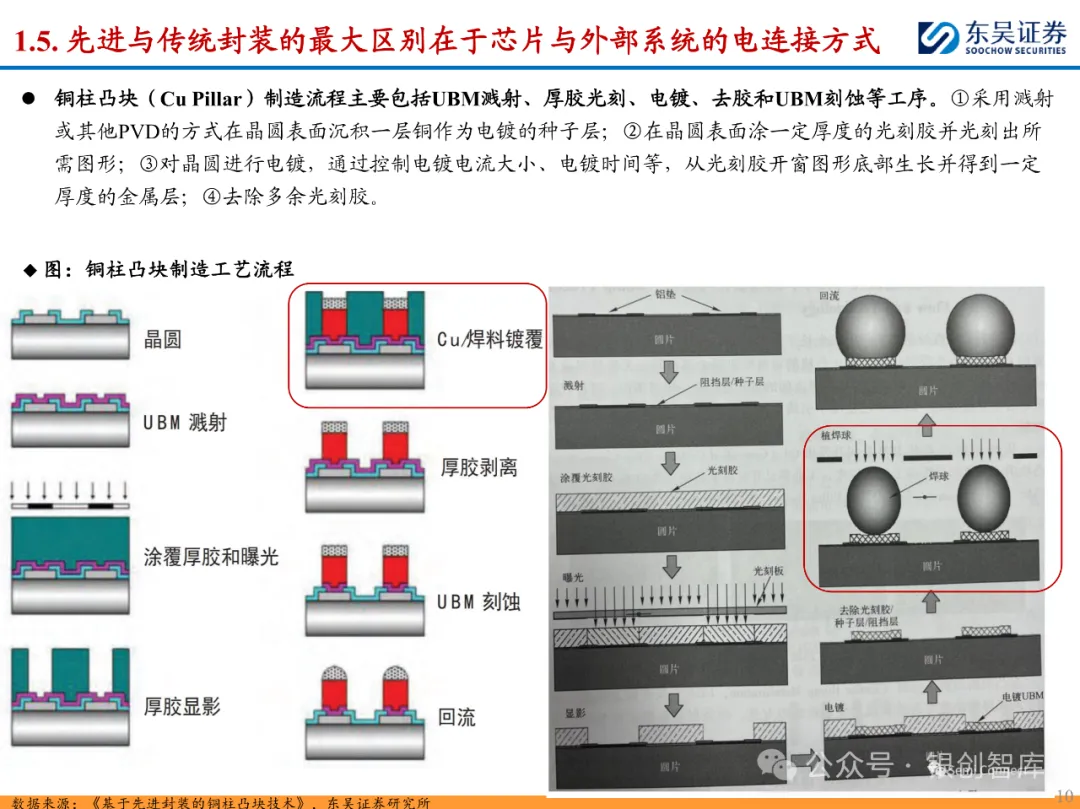

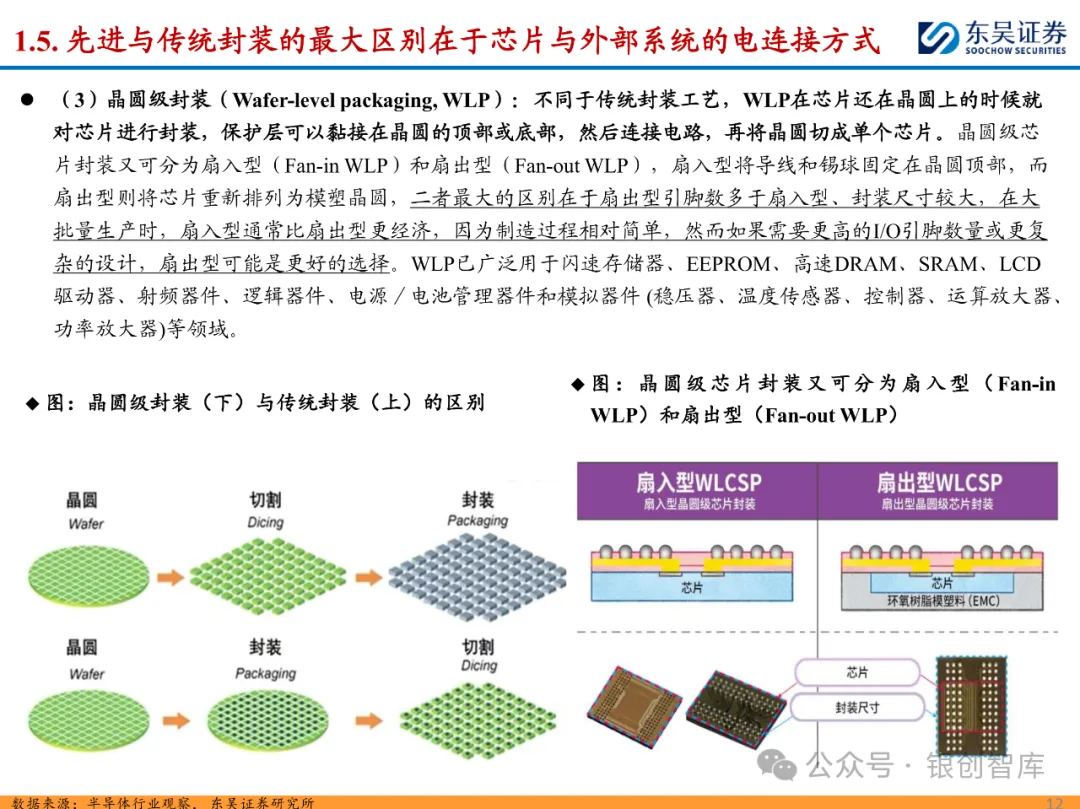
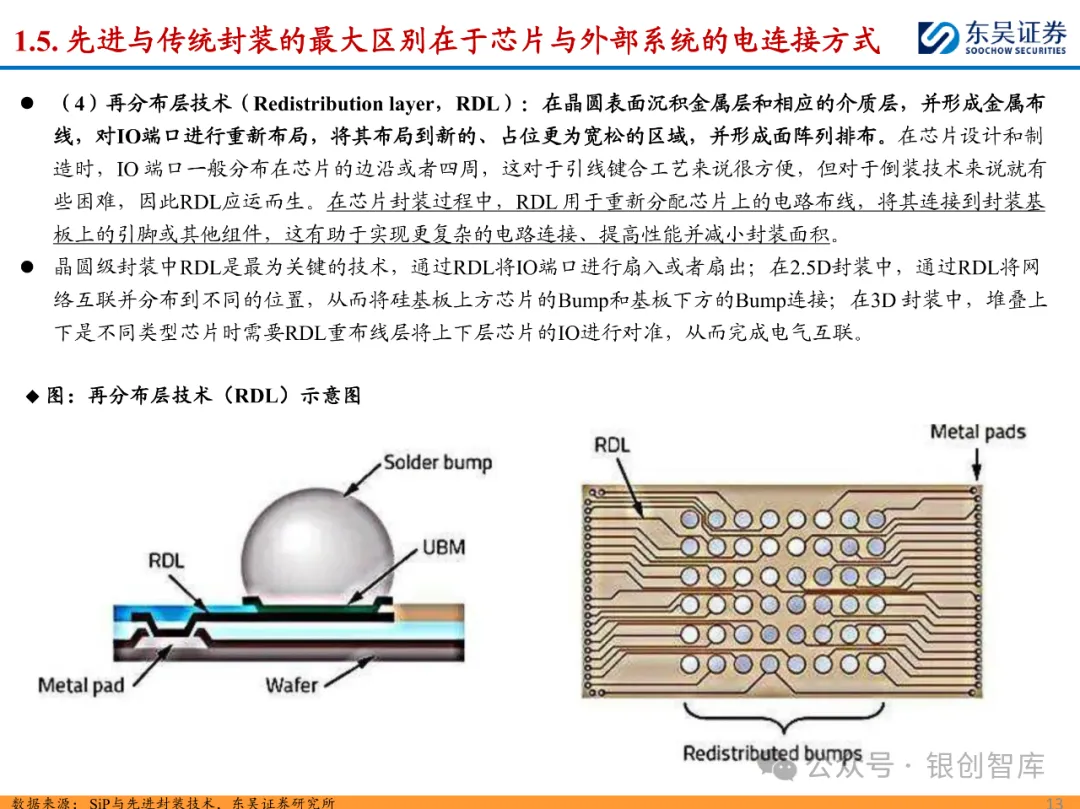
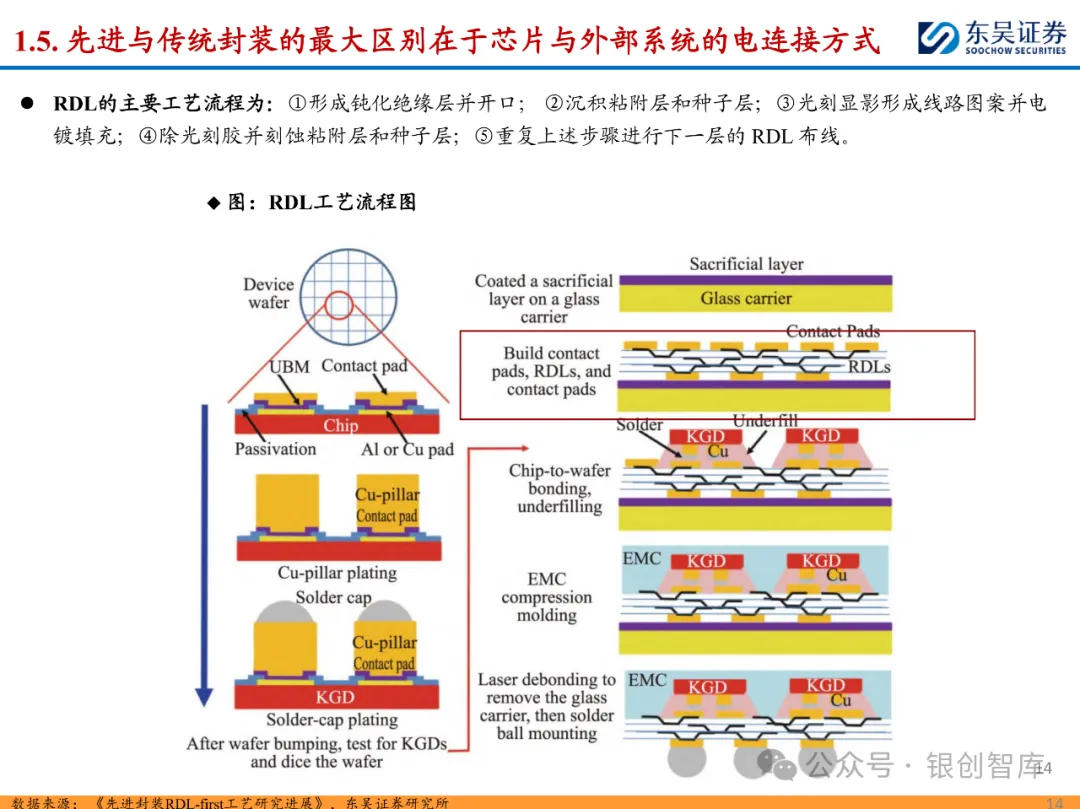
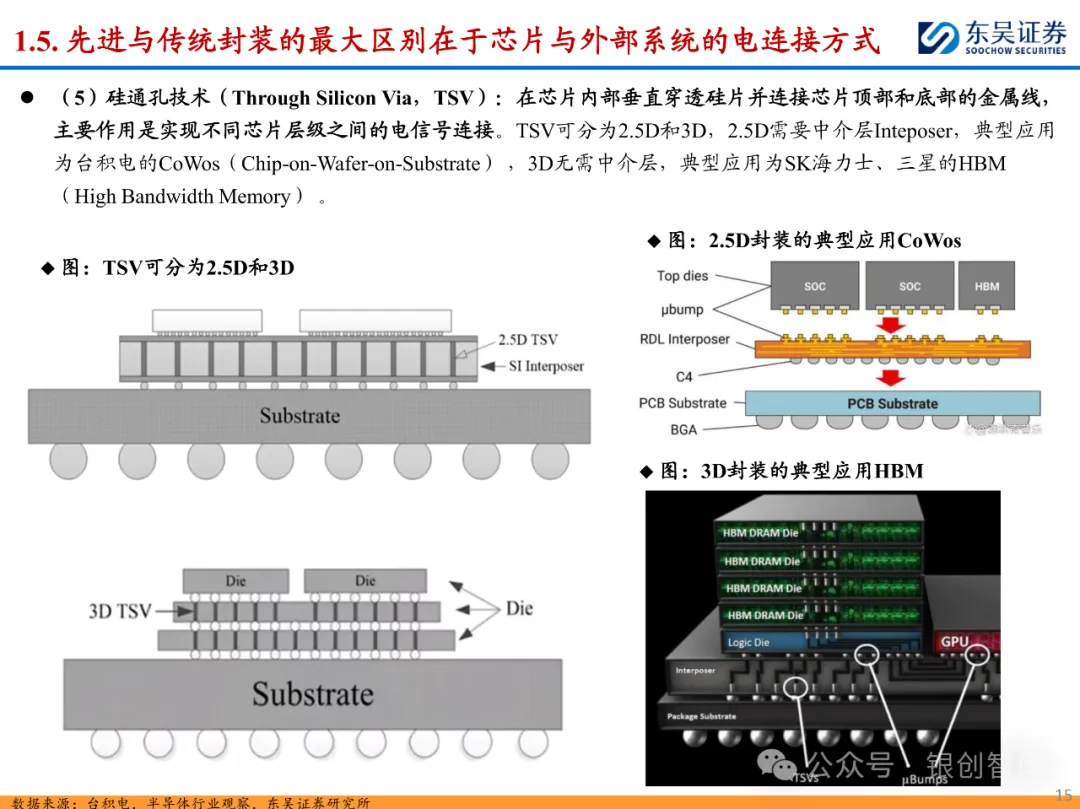
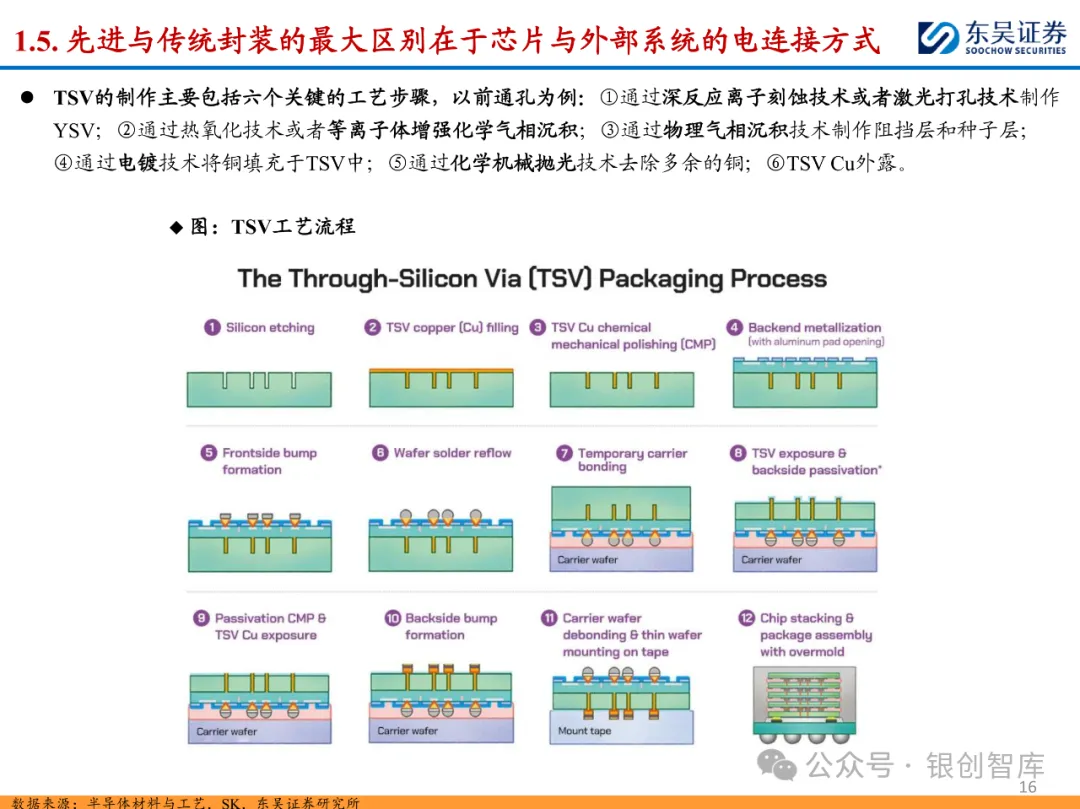




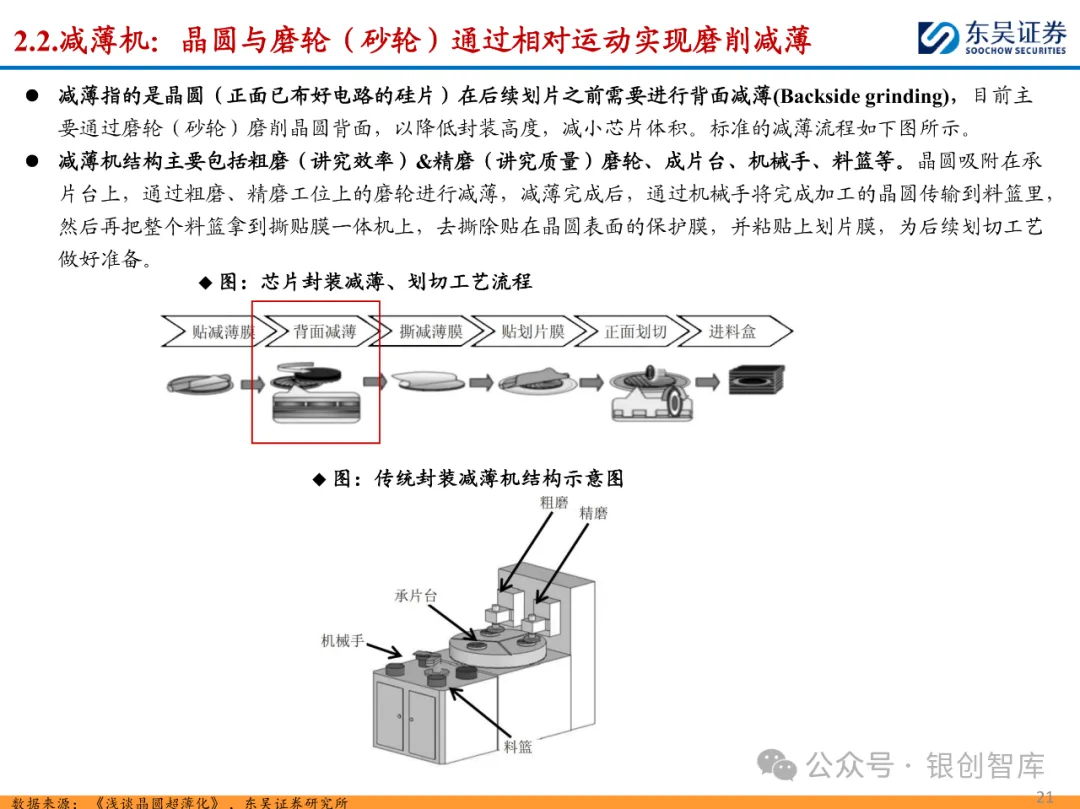








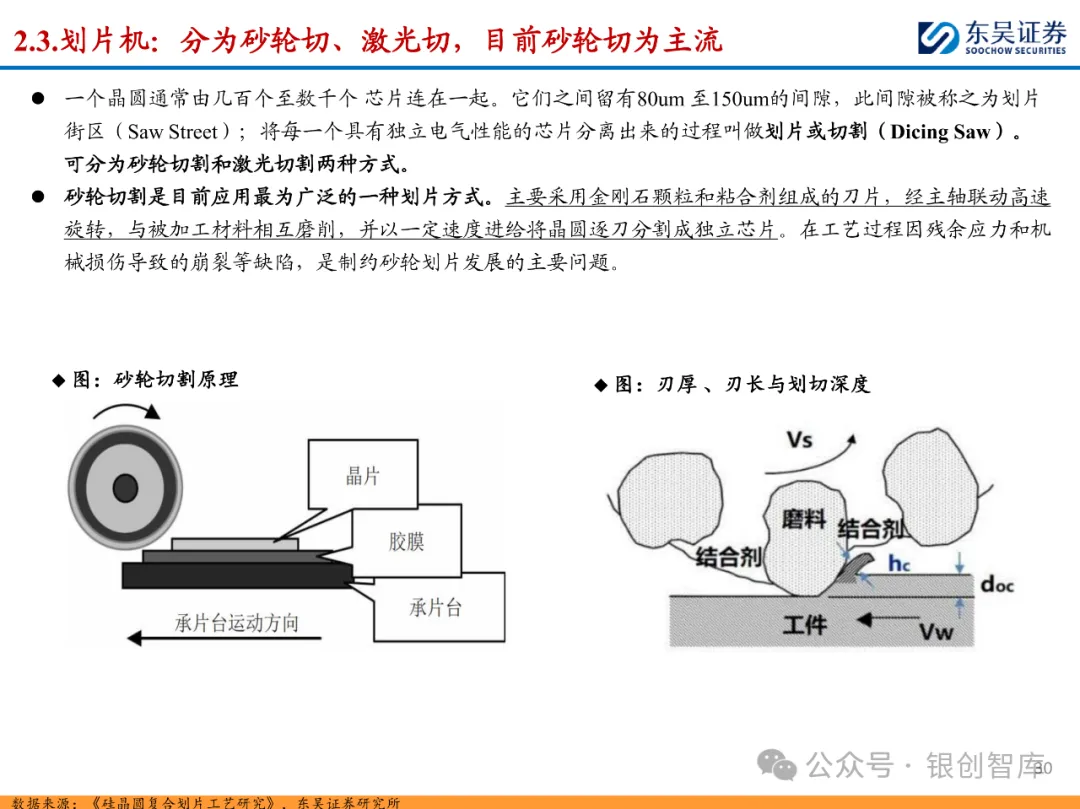


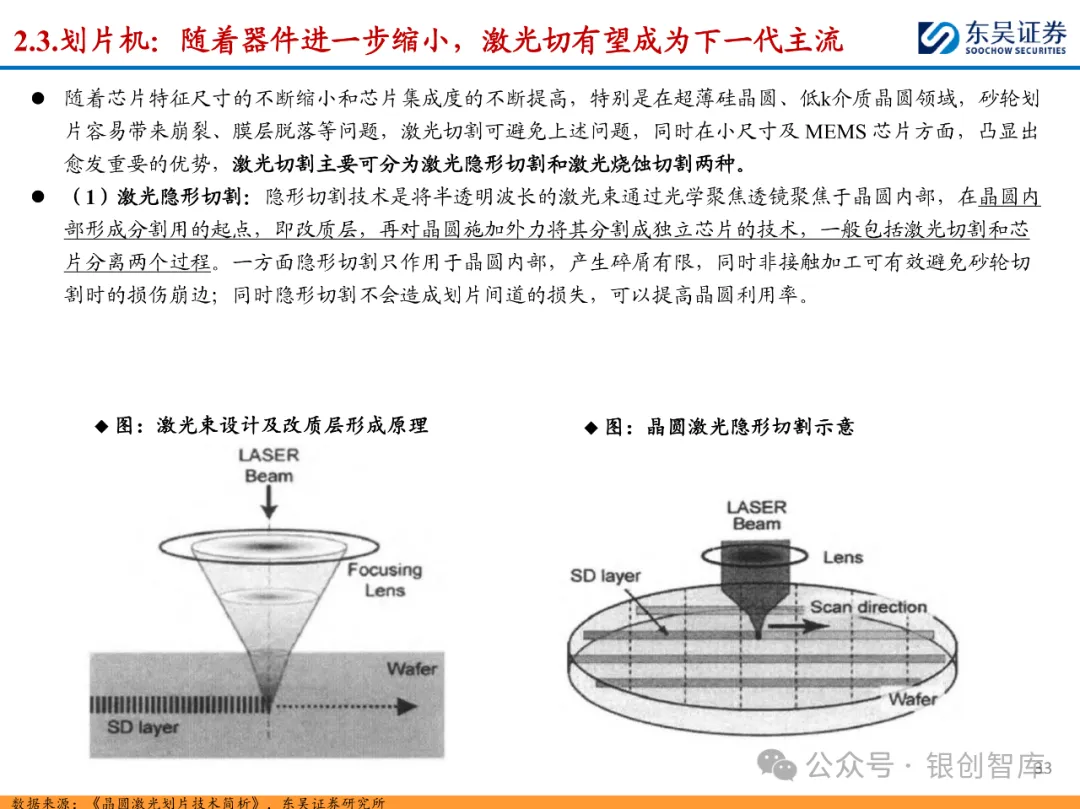
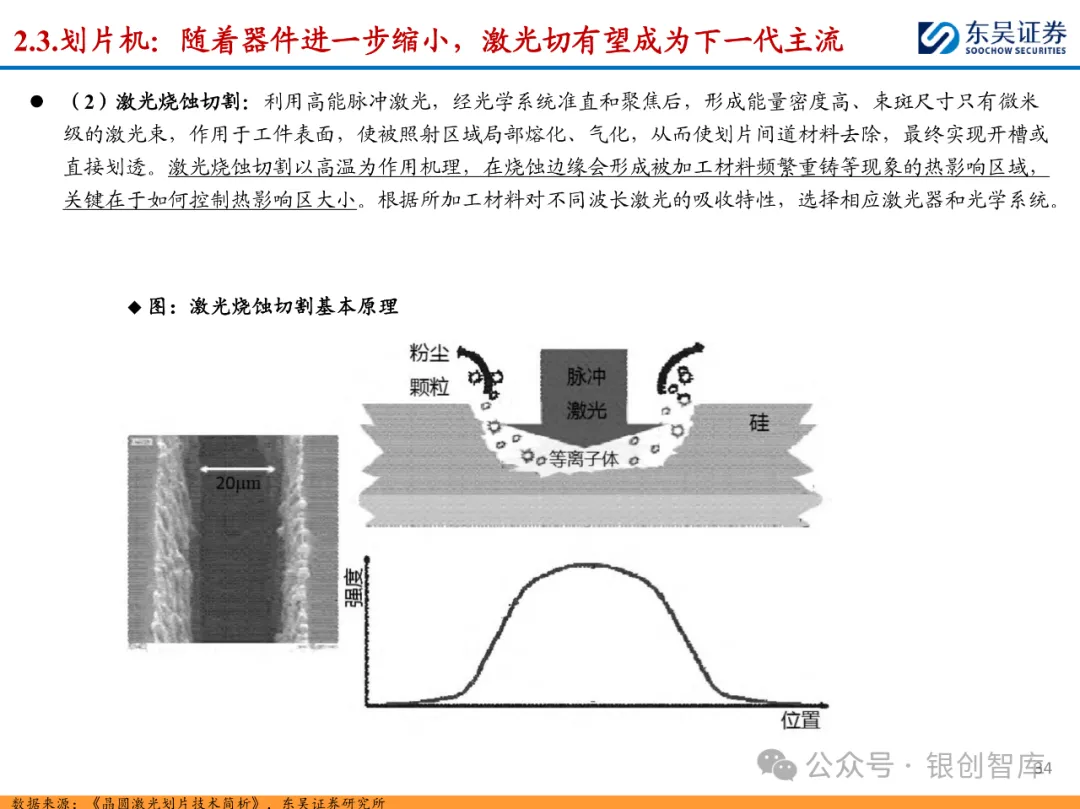


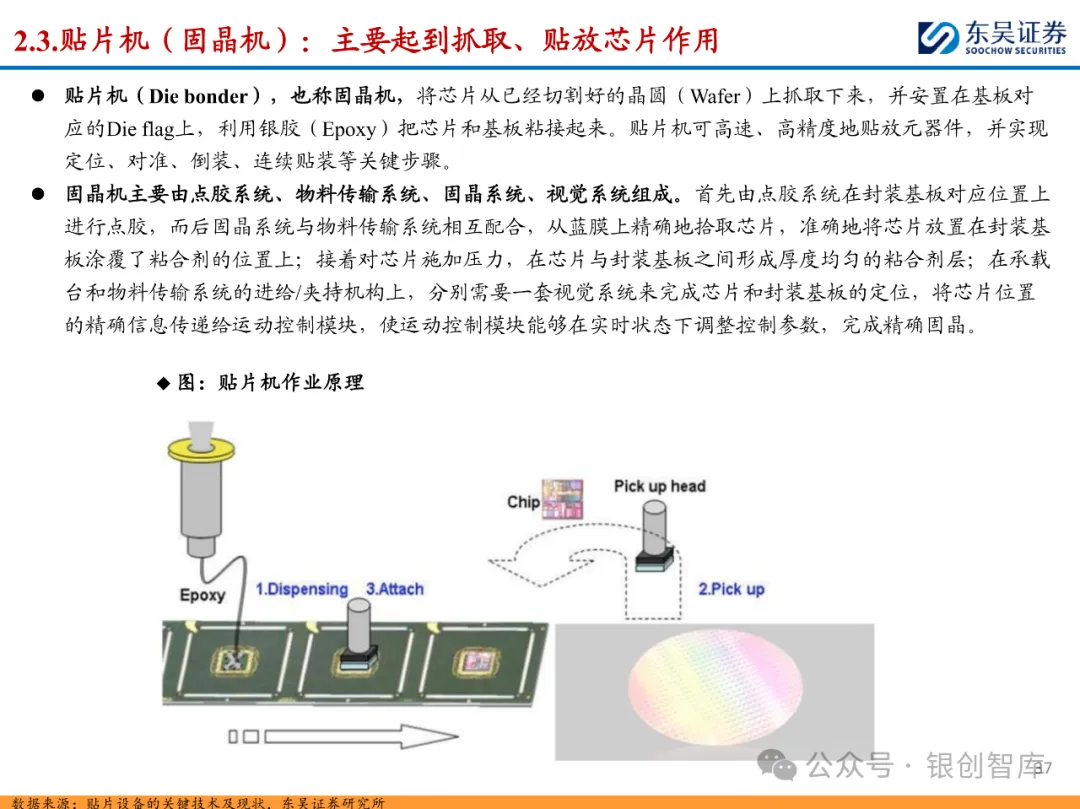







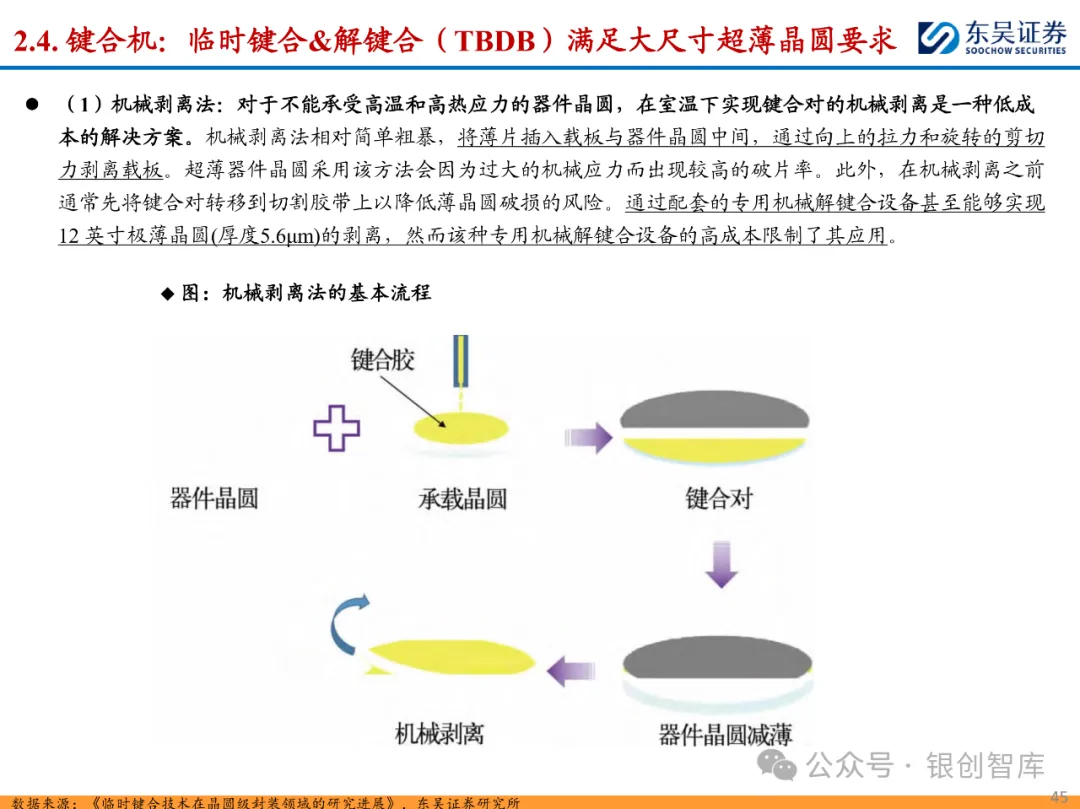
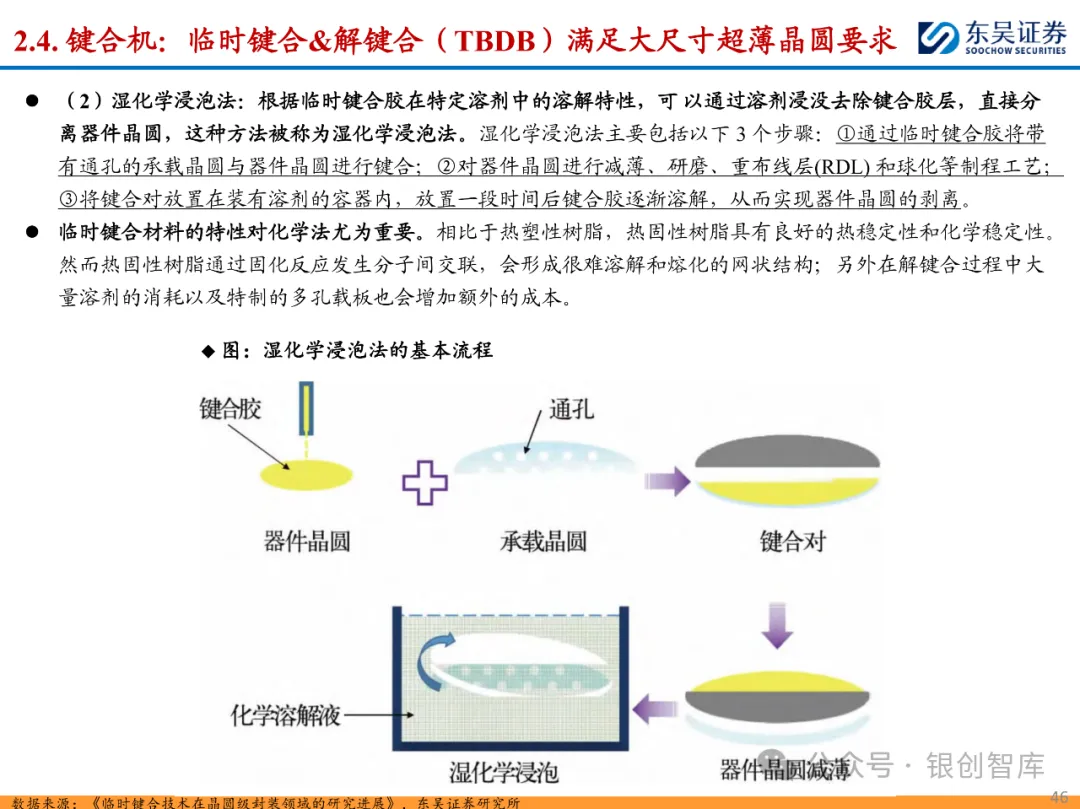
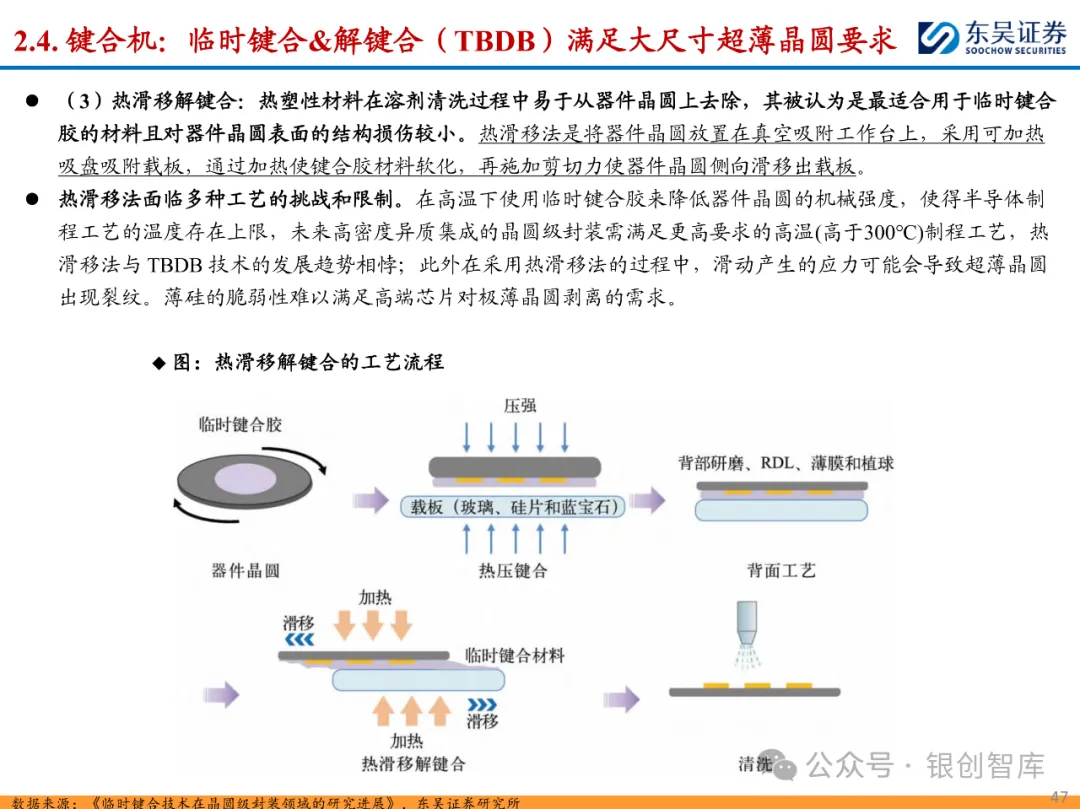
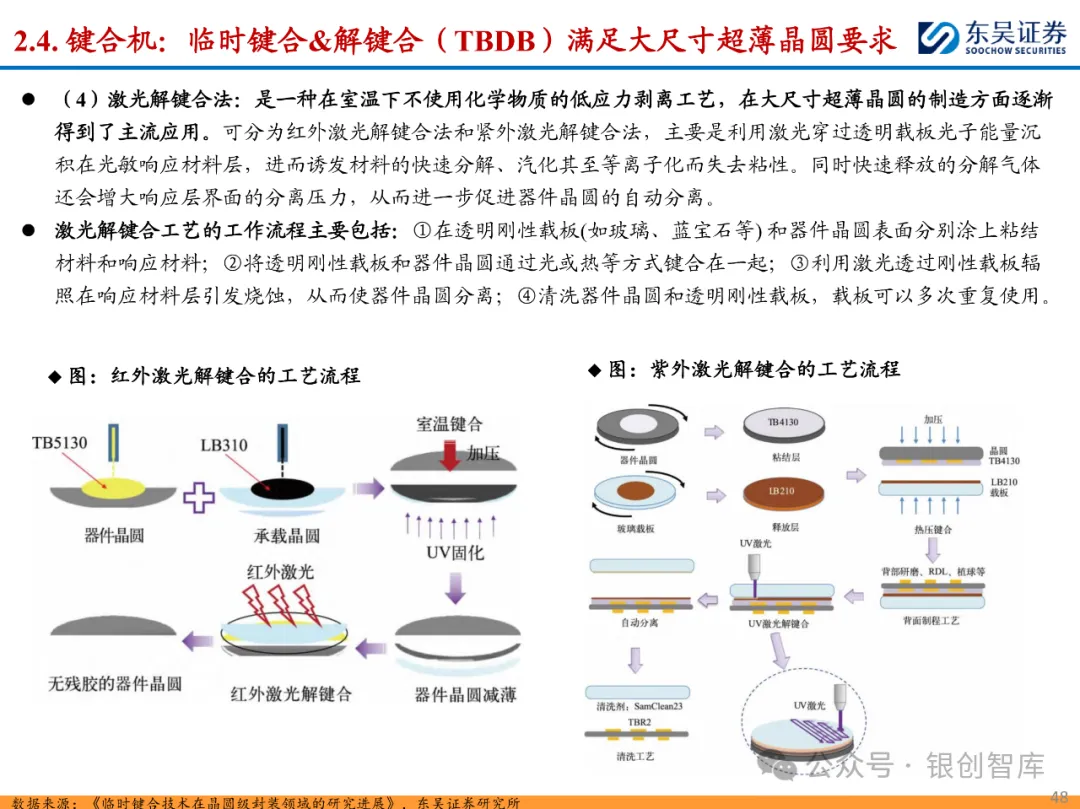
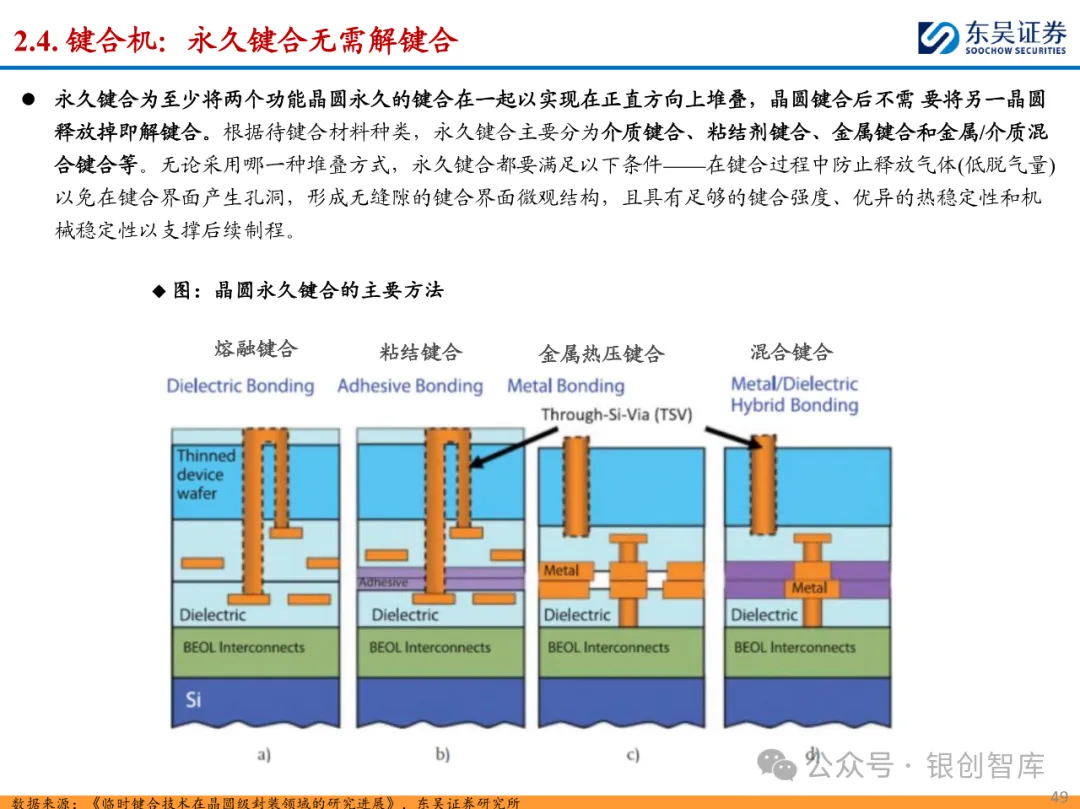


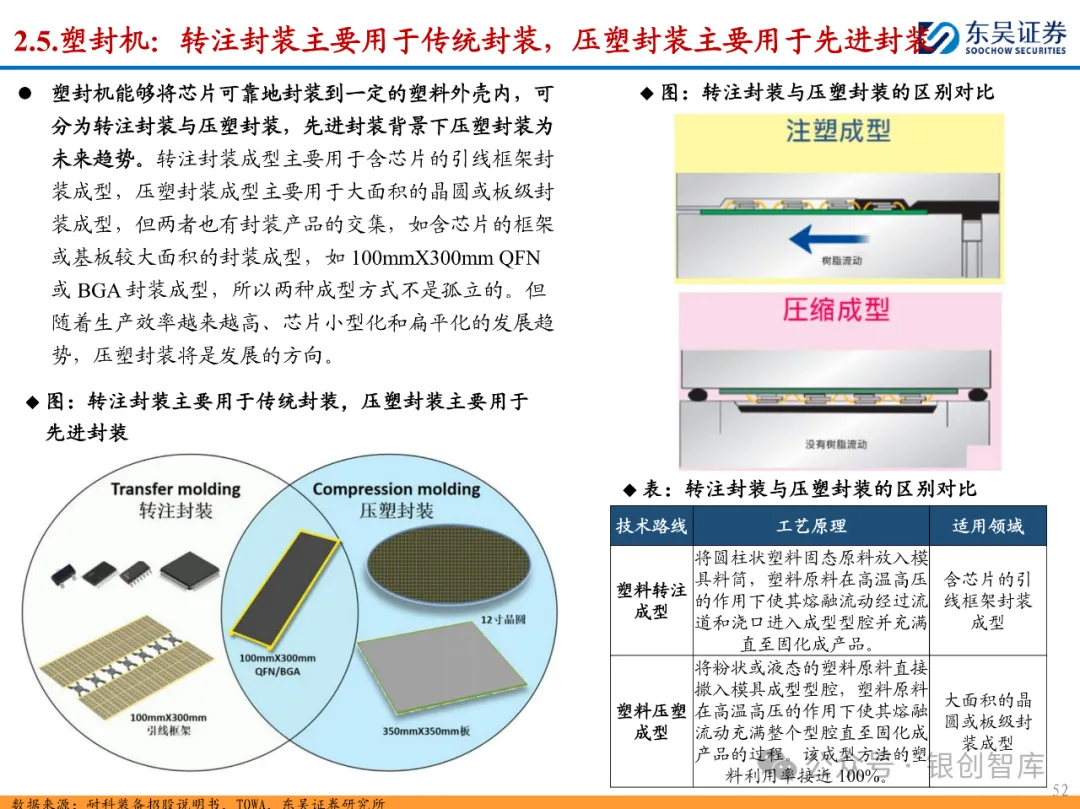








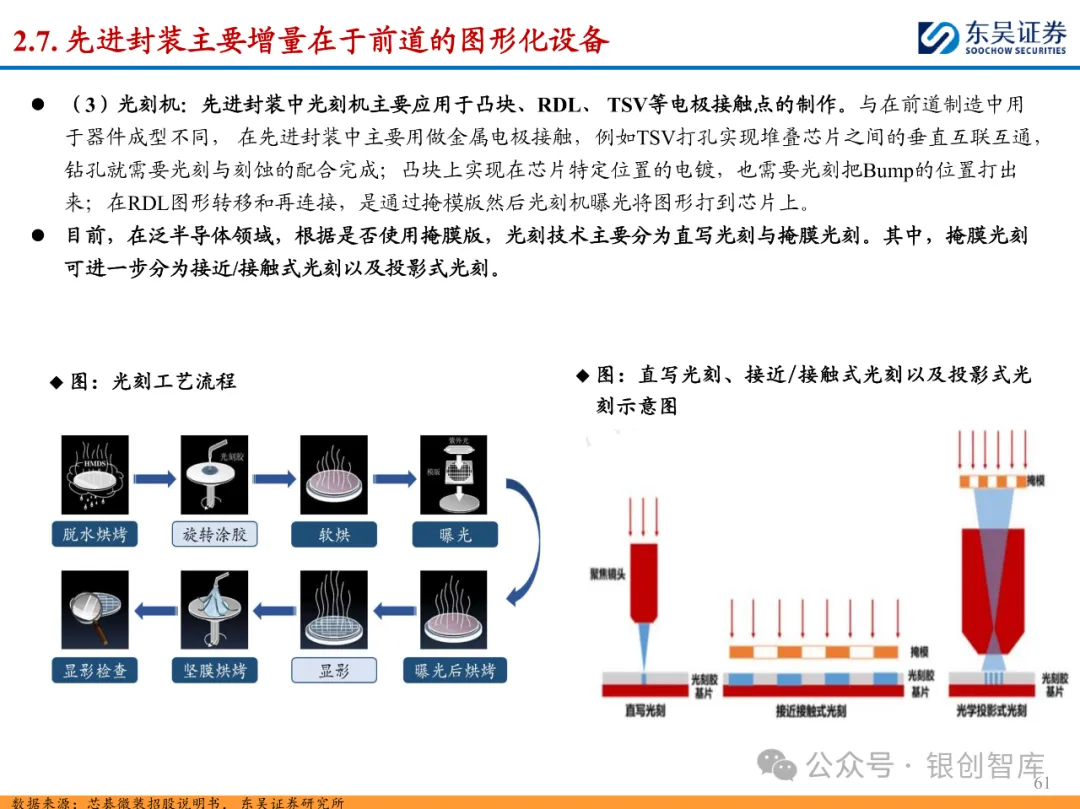








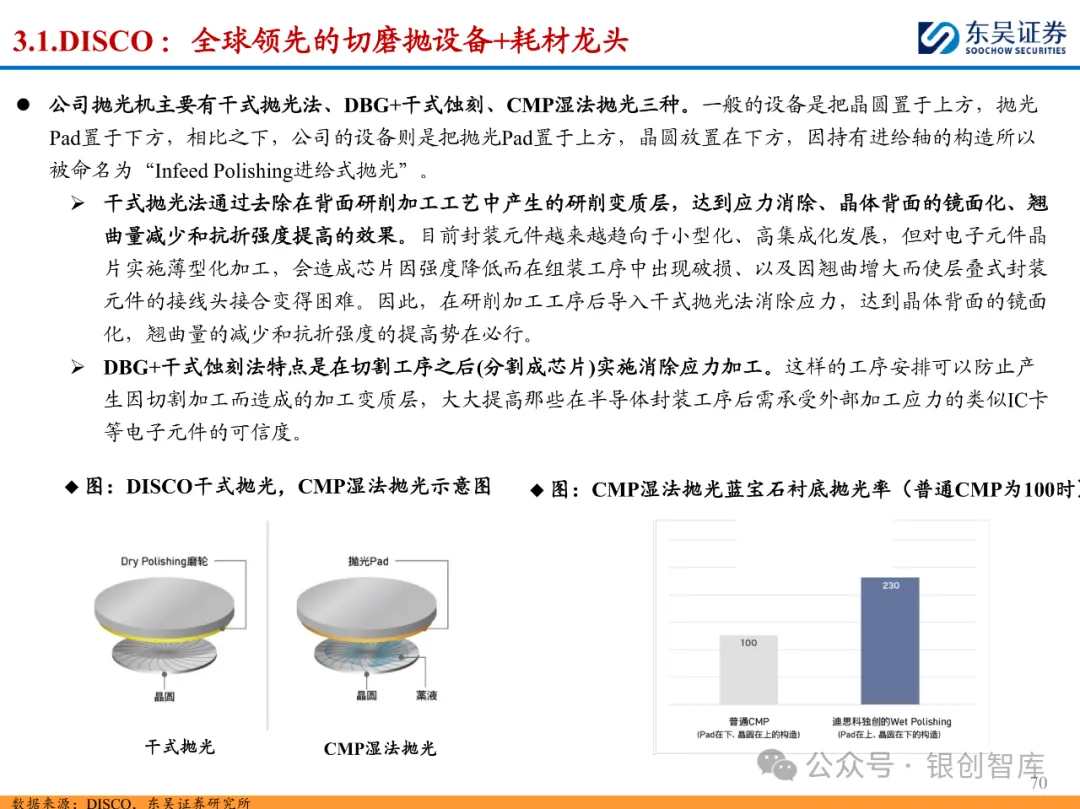













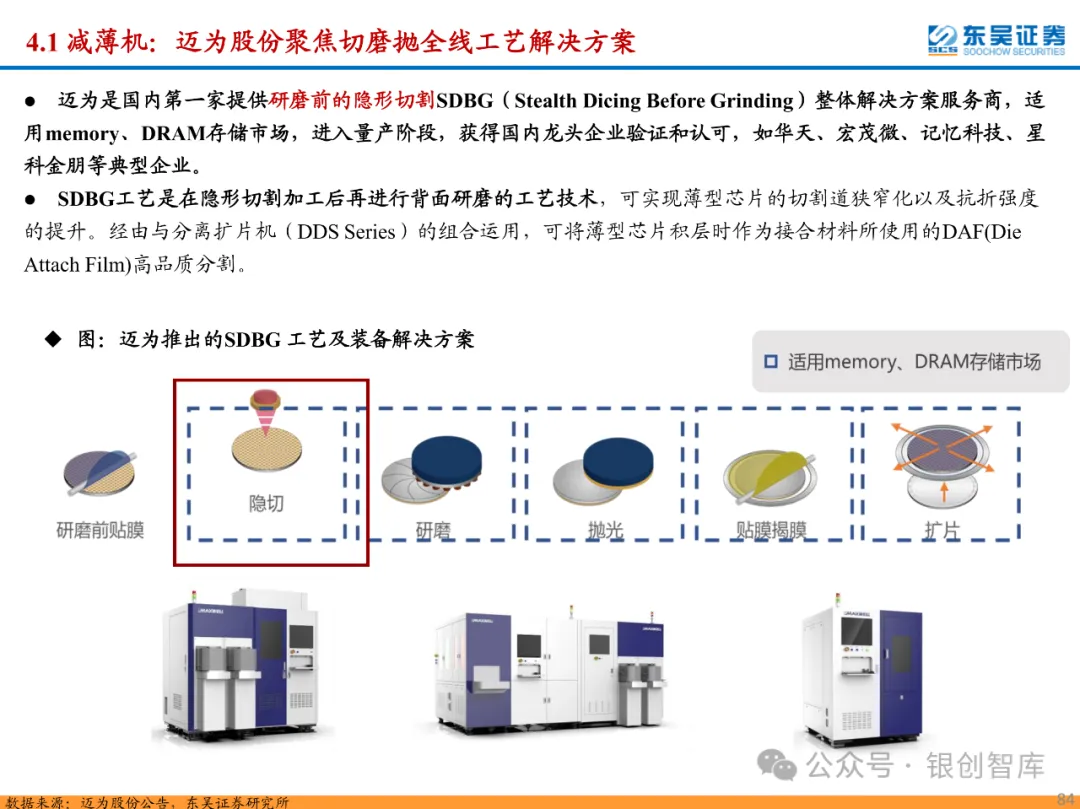
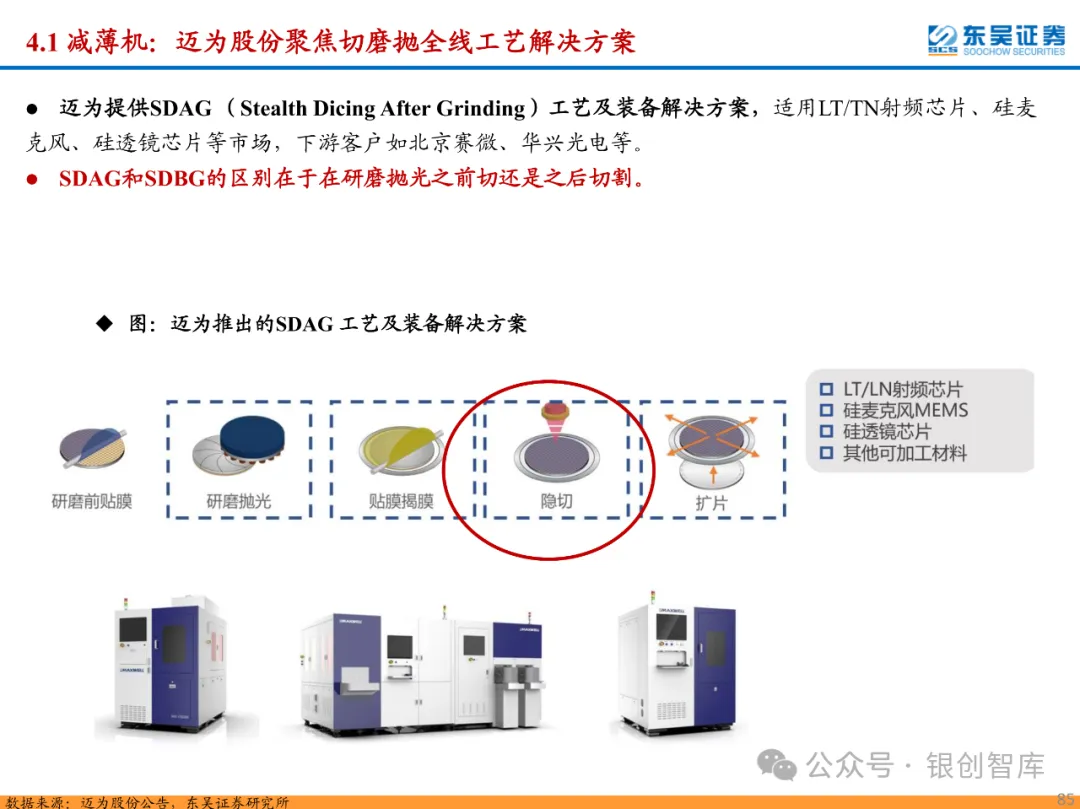

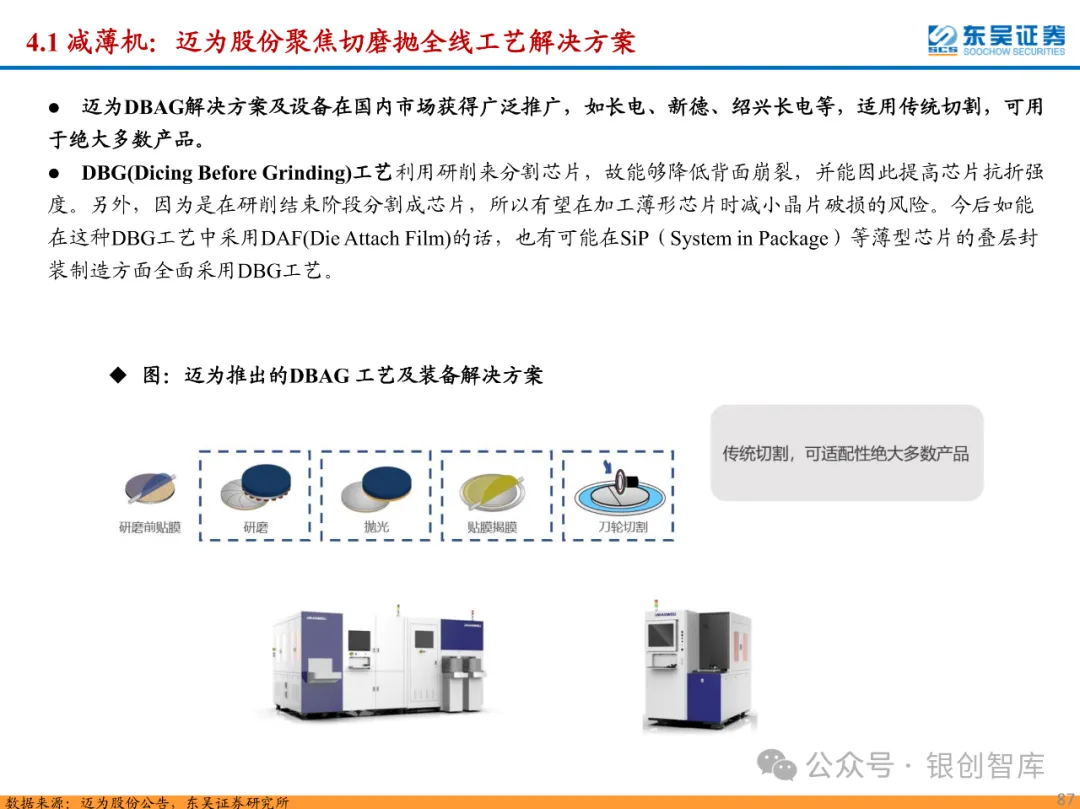





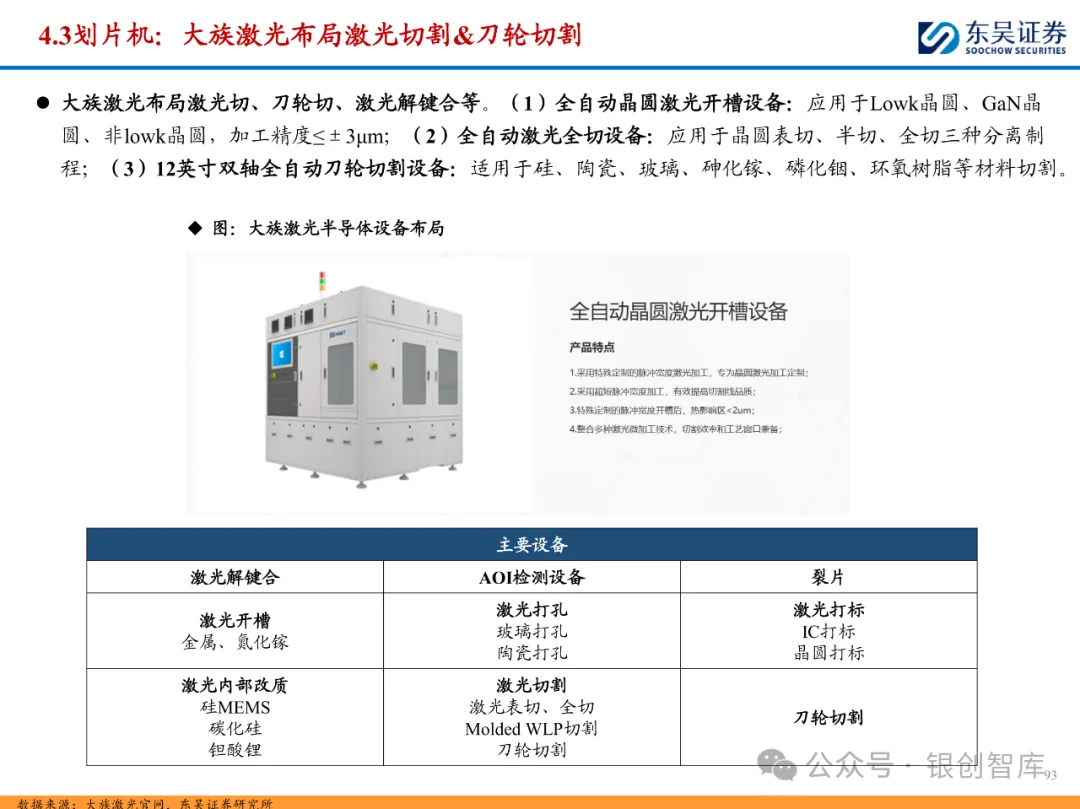

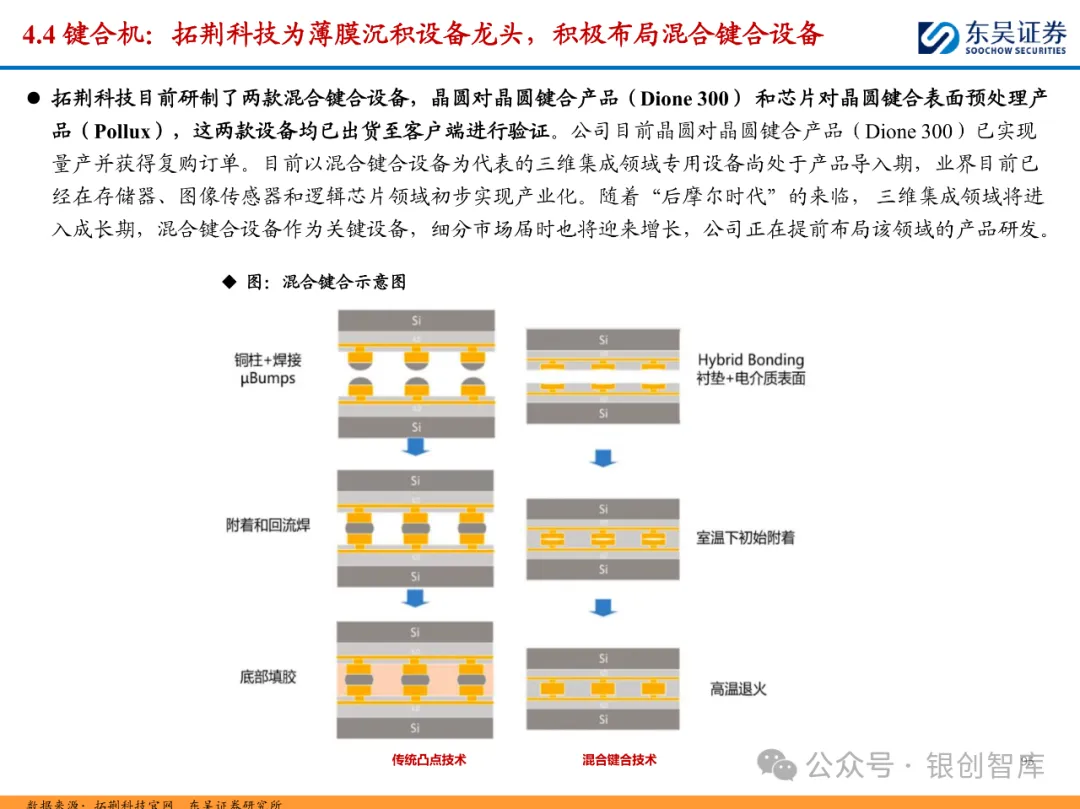


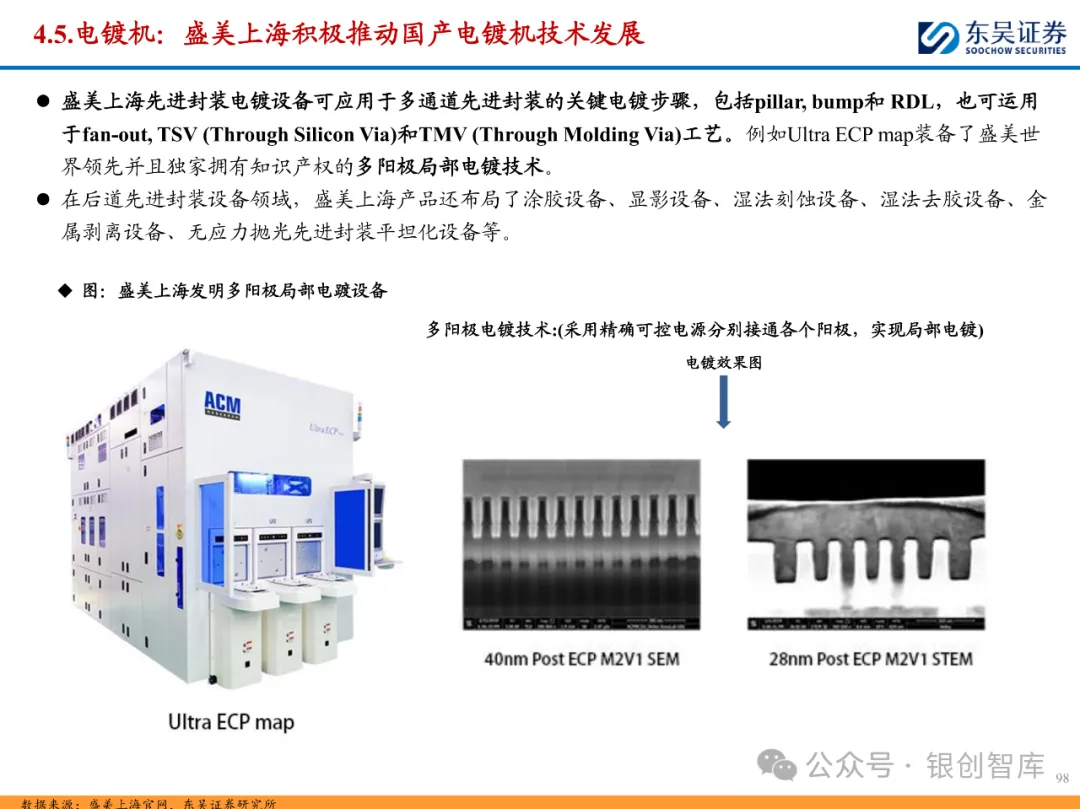

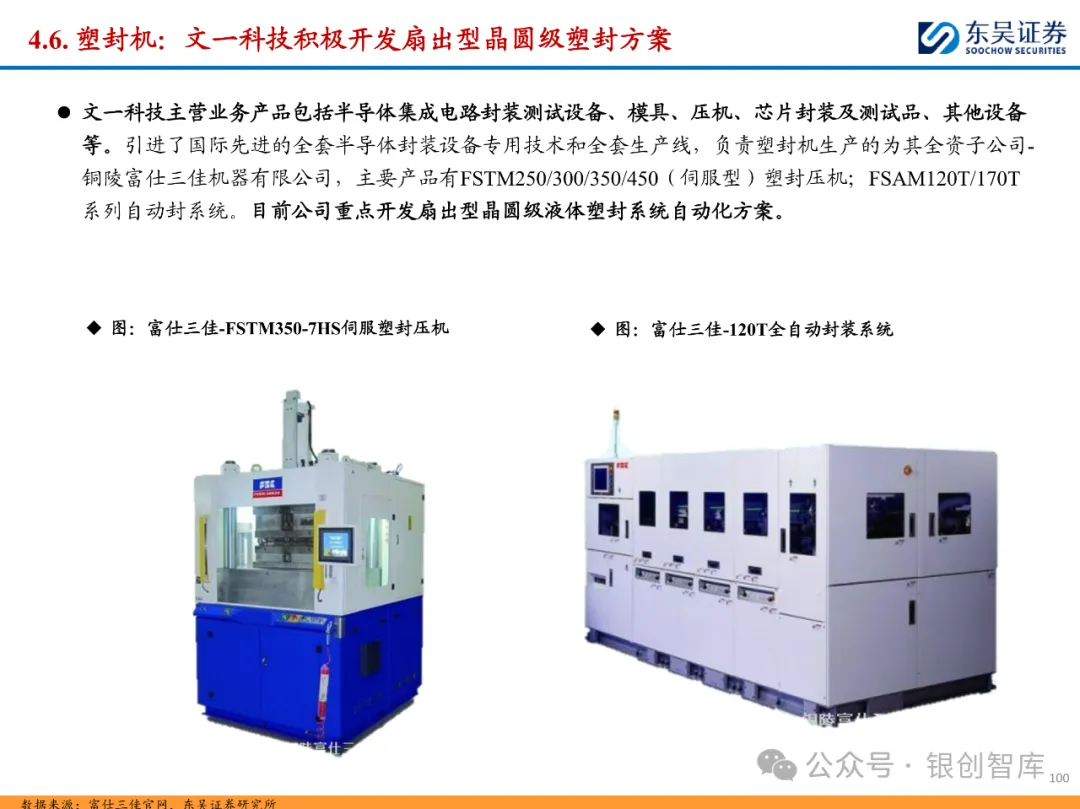




ж–Үз« жқҘжәҗпјҡдёңеҗҙиҜҒеҲёгҖҒ银еҲӣжҷәеә“
е…іжіЁжҲ‘们пјҢиҺ·еҸ–жңҖж–°жңҖе…Ёжҷәеә“еҠЁжҖҒ

дёӯеӣҪиө„жң¬еёӮеңә50дәәи®әеқӣ
йӣҶиҒҡиө„жң¬ж–№гҖҒдә§дёҡз•ҢгҖҒ科жҠҖеңҲдёүеӨ§еҠӣйҮҸ
жү“йҖ ж”ҝдјҒгҖҒиө„дјҒгҖҒз ”дјҒгҖҒдјҒдјҒеӣӣеӨ§дәӨжөҒе№іеҸ°
иҮҙеҠӣдәҺжҲҗдёәдёӯеӣҪиө„жң¬еёӮеңә第дёҖжҷәеә“


