(半导体行业案例)背面减薄工艺基底厚度等检测
2023-08-25 13:17
晶圆背面减薄是一步重要的晶圆制造工艺,目的是去除晶圆背面多余材料,以有效减小晶圆封装体积,降低热阻,提高器件的散热性能,降低封装后芯片因受热不均而开裂的风险,提高产品可靠性;同时,减薄后的芯片机械性能与电气性能也得到显著提高。晶圆背面减薄技术有很多种,如磨削、抛光、干式抛光、电化学腐蚀、湿法腐蚀、等离子辅助化学腐蚀和常压等离子腐蚀等。将从晶圆厂出来的晶圆进行背面研磨,来减薄晶圆达到封装需要的厚度。磨片时,需要在正面贴胶带保护电路区域,同时研磨背面。研磨之后,去除胶带,测量厚度;目前已经成功应用于晶圆制备的磨削工艺有转台式磨削、晶圆旋转磨削、双面磨削、TAIKO磨削、化学机械磨削、抛光磨削和行星盘磨削等。确认减薄后的基底厚度分布情况,是否满足下一步工艺需要。通常采用红外干涉的方式从背面检测基底或从正面切割道穿透晶圆基底部分来进行厚度的检测与计算。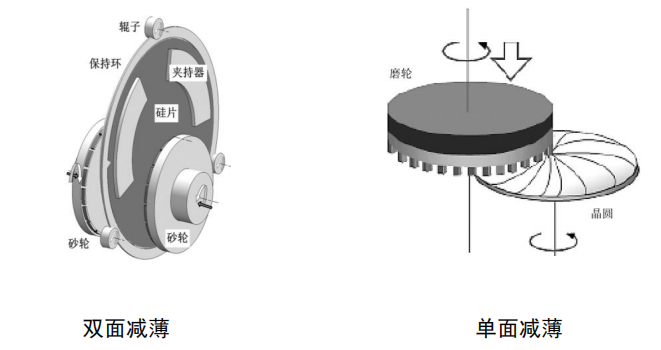
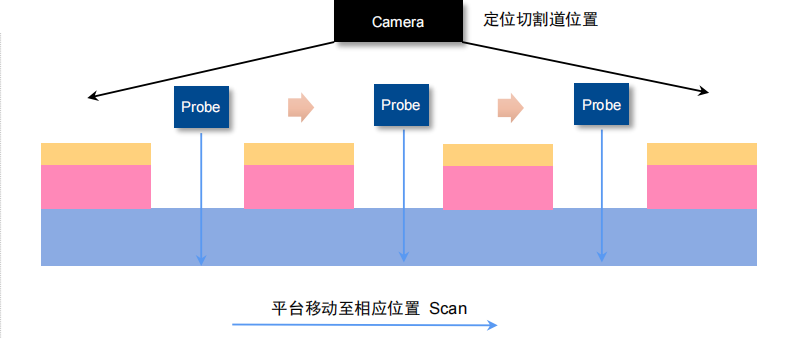
• 建议的配置与检测能力说明