用于芯片互连的双大马士革工艺
2023-08-24 11:20
上期的文章中,我们介绍了芯片互连金属由金转变为铜的历程,见文章:
那么,铜作为互连金属是如何完成互连任务的呢?这个就有必要介绍一下目前芯片互连最普遍的工艺--双大马士革工艺(Dual Damascene Process)。为什么这个工艺叫大马士革?为什么要用到这个工艺?用什么机台实现该工艺?
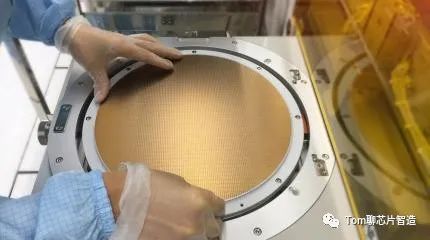
芯片互连指的是集成电路上,不同的部件之间进行电连接的金属连接。这些导线使得芯片内部的成千上万乃至上亿的晶体管之间可以进行信号传输。简单来说,就像几个水库,相互独立。通过挖沟渠的方式,将水库之间导通,来实现水流(电流)的流动。如果没有互连,芯片内部就像一个断路。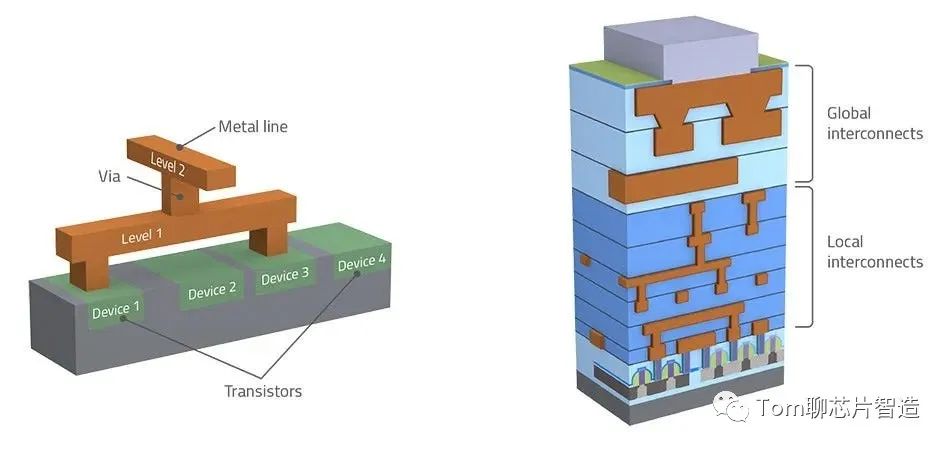
熟悉历史和地理的朋友都知道叙利亚首都大马士革(Damascene)这座城市,而大马士革刀剑以其锋利,纹理的精美而著称。其中需要用到一种镶嵌工艺:首先,在大马士革钢的表面上雕刻出所需的图案,将预先准备好的材料紧密地镶嵌到雕刻出的凹槽中,完成镶嵌后,表面可能会有些不平整。工匠会仔细打磨,确保整体的光滑。
了解芯片工艺的朋友不禁惊呼,这不就是芯片的双大马士革工艺的雏形嘛。先在介电层中刻出凹槽或孔,然后在其中填充金属。填充后,多余的金属会被cmp去除。简直如出一辙。与某些材料不同,铜在等离子体刻蚀过程中不容易形成挥发性化合物。对于许多材料,干法刻蚀会形成容易从表面蒸发的反应产物,这些产物会迅速扩散出去而不会再次沉积在晶圆表面。但是,铜与常见的刻蚀气体反应生成的化合物往往是非挥发性的,这使得其难以被有效地从表面去除。干法不行,那用湿法?芯片制程新线宽在几十纳米,湿法精度根本达不到。
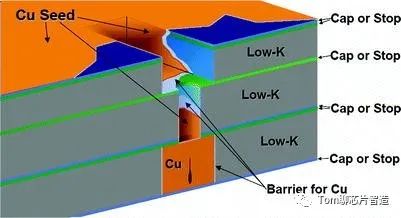
介电层沉积:在已有的金属层上沉积一层介电材料。通常是一个低介电常数的材料,以减少电容和信号延迟。孔与槽的光刻与蚀刻:首先通过光刻技术在介电层上形成图案,定义出导通孔和互连槽的位置。然后,使用蚀刻技术,将这些图案转移到介电层中,形成实际的孔和槽。
铜沉积:在孔和槽中沉积铜。通常是通过电镀技术完成的。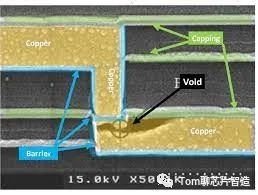
化学机械抛光:去除多余的铜,使铜与介电层的表面齐平。这样,只有孔和槽内部的铜仍然保留。这个展开来讲能写一本20w字的书,笔者正在从事这本书的写作工作,欢迎关注。原创不易,转载需注明出自本处。 我建了一个知识分享的社区,陆续上传一些芯片制造各工序,封装与测试各工序,建厂方面的知识,供应商信息等半导体资料。目前已上各类半导体文档600余个,解答问题200余条,并在不断更新中,内容远远丰富于日常发的文章。当然也可仅关注本号,我定期都有发文章在上面,可以满足小需求的读者。