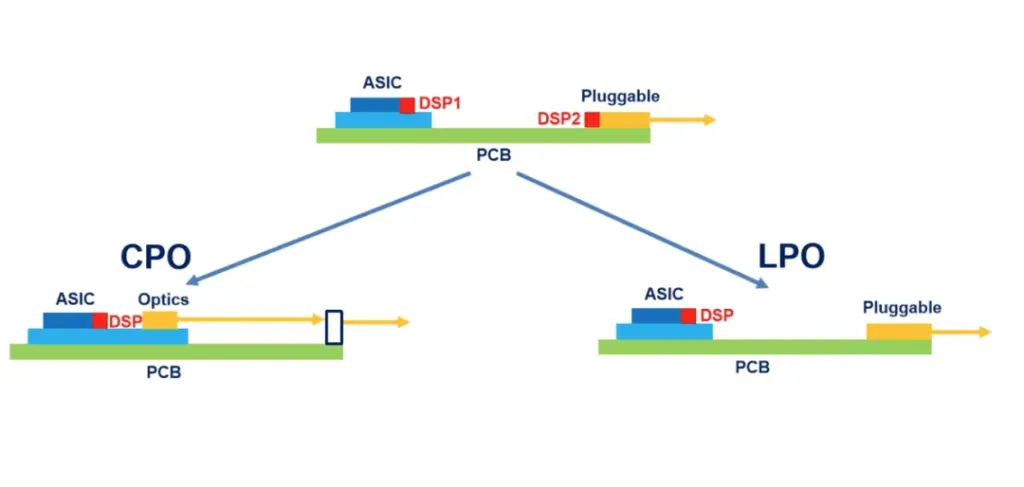
- 铜互联已触及物理极限
:在112G SerDes速率下,无源铜缆有效传输距离仅2-3米;224G SerDes时代,AEC有源铜缆有效距离缩短至2-3米,仅覆盖机柜内短距离,机柜间互联必须转向光方案。趋肤效应导致功耗随速率呈指数级增长。 - CPO是高密度AI互联场景的核心演进方向
:可插拔光模块解决了铜的距离问题,但1.6T可插拔模块功耗高达25W/端口,万卡集群仅光模块功耗就超1MW。CPO将光引擎与交换芯片共封装,1.6T端口光引擎功耗降至约9W,降幅64%。但需注意:CPO与LPO、可插拔光模块在不同场景各有优势,是高密度AI互联的核心演进方向而非所有场景的唯一选择,三者长期共存。 - 英伟达Rubin平台推动CPO商用拐点
:2026年1月Rubin GPU正式发布(CES 2026),预计下半年进入量产阶段。英伟达Quantum-X Photonics和Spectrum-X Photonics硅光CPO交换机是CPO商用的核心驱动力。博通Bailly 51.2T CPO交换机2025年完成客户送样,Meta ECOC 2025实测超100万端口小时无中断,2026年进入小批量交付。 - CPO市场规模2030年可达93亿美元
:摩根士丹利预测2023-2030年CAGR达172%(口径:CPO光引擎及模组市场)。LightCounting预测2029年3.2T CPO端口出货量将大幅增长。注意不同机构预测口径差异较大(见第五章对比表)。 - 中国厂商在CPO中角色转换
:从光模块组装向光引擎和先进封装延伸。中际旭创已完成1.6T/6.4T CPO光引擎送样验证(2026年3月已向英伟达送样),天孚通信CPO光学组件已送样,源杰科技从芯片切入,长电科技已推出CPO封装解决方案。但核心EML激光器和先进封装仍主要依赖海外供应。
一、为什么AI让CPO变得不可回避?
1.1 AI算力爆炸带来的通信危机
AI大模型训练的本质是大规模并行计算——数千甚至数万张GPU需要协同工作,而协同的前提是高速通信。当GPU算力每2年翻倍时,GPU间的通信需求也在同步爆炸,但网络带宽的增速严重落后于算力增速,导致"通信墙"(Communication Wall)成为AI训练的最大瓶颈之一。
英伟达的NVLink互连带宽演进清晰展示了这一趋势:NVLink3(A100)提供600GB/s双向带宽,NVLink4(H100)提升至900GB/s,NVLink5(Blackwell)进一步翻倍至1.8TB/s。而在Scale-Out网络层面,InfiniBand从200G NDR演进至800G XDR,以太网也从400G向800G/1.6T升级。每一次GPU换代,互联带宽必须同步翻倍,否则GPU算力将被通信延迟浪费。
以一个万卡AI训练集群为例:假设采用H100 GPU,每张GPU需要6个光模块进行互联,整个集群需要约6万个光模块。仅光模块采购成本就超过3亿美元,功耗超过1MW——这还只是800G时代的数据。当速率升级到1.6T/3.2T时,如果继续沿用可插拔光模块,功耗和密度将成为无法承受的负担。
核心矛盾
GPU算力增速 >> 网络带宽增速 >> 铜互联物理极限。CPO是打破这一矛盾的关键。
1.2 铜互联的物理极限
铜互联(以DAC直连铜缆和AEC有源铜缆为代表)是当前数据中心短距离互联的主力方案,在成本和延迟方面具有天然优势。然而,铜作为导电介质的物理特性,决定了它在高速信号传输上存在不可逾越的极限。
趋肤效应:速率越高,有效导体越薄
趋肤效应(Skin Effect)是高频信号在导体表面传输的物理现象。信号频率越高,电流越集中在导体表面,有效导电截面积越小,交流电阻急剧增大。
具体而言,趋肤深度 δ = √(2ρ/ωμ),其中ρ为电阻率、ω为角频率、μ为磁导率。对于铜导体,在1GHz时趋肤深度约2.1μm,在10GHz时仅0.66μm,在56GHz(对应112G PAM4)时趋肤深度不足0.28μm。这意味着在112G SerDes速率下,铜缆中大部分铜材实际上是"闲置"的——信号只在极薄的表面层传输,有效电阻急剧增大,功耗飙升。
信号衰减:速率越高,传输距离越短
高频信号在铜缆中传输时,由于导体电阻和介质损耗,信号幅度会随距离衰减。速率越高,衰减越严重。在112G SerDes速率下,无源DAC铜缆的有效传输距离仅约2-3米;AEC有源铜缆通过内置DSP重定时器可将距离延伸至5米,但代价是额外功耗和成本。
当速率提升至224G SerDes时,铜缆衰减问题更加严重。OIF(光互联论坛)已于2025年完成224G SerDes铜缆互操作性验证,AEC有源铜缆在224G速率下可稳定支持2-3米传输,但功耗显著增加,仅覆盖机柜内短距离场景。机柜间互联(>3米)必须转向光方案——铜缆的"可用距离"和"可用场景"在持续缩小。

图1:铜缆有效传输距离随速率急速衰减,光纤几乎不受影响
串扰与电磁干扰
高密度布线场景下,相邻铜缆之间存在电磁耦合,导致串扰(Crosstalk)。速率越高、线缆间距越小,串扰越严重。在AI数据中心中,一个机柜内可能需要数百根铜缆互联,串扰问题在高密度部署下尤为突出。此外,铜缆作为导体,对外部电磁干扰(EMI)敏感,也容易成为干扰源,这在合规性方面带来额外挑战。
⚠️ 224G SerDes时代,AEC铜缆有效距离缩短至2-3米,仅覆盖机柜内短距离——机柜间互联必须转向光方案,铜缆的"可用场景"持续缩小,这是CPO被重视的根本物理原因。

图2:铜互联功耗随速率指数级增长,CPO在高速率下优势显著
1.3 从铜到光:为什么光互联是必然选择
光互联的关键优势在于:光纤的低衰减特性使信号可以在几乎不损失能量的情况下传输数百米甚至数公里,而且衰减与信号频率几乎无关,这意味着速率提升不会导致传输距离缩短。此外,光纤可以通过波分复用(WDM)技术在同一根光纤中传输多个波长的信号,大幅提升带宽密度。
然而,光互联并非没有代价。电信号和光信号之间的转换需要光模块,这引入了额外的功耗、延迟和成本。在低速率场景下,光电转换的代价可能超过光互联的收益,这正是铜互联在短距离、低速率场景下仍然不可替代的原因。
1.4 可插拔光模块的天花板
可插拔光模块是当前数据中心光互联的主流方案,它将光发射/接收组件封装在标准化的模块外壳中,通过连接器插在交换机前面板上,支持热插拔,运维便利性极高。然而,随着速率从800G向1.6T/3.2T演进,天花板日益显现:
功耗天花板
可插拔光模块的功耗随速率快速增长:400G模块约10W,800G模块15-18W,1.6T模块预计高达25W以上。在一个配备数万个光模块的AI数据中心中,仅光模块的功耗就可能超过1MW,占整个数据中心功耗的10%-15%。这不仅带来巨额电费,还对数据中心的散热系统造成巨大压力。功耗高的根本原因:信号需要从交换芯片出发,经过PCB走线、连接器、再进入光模块内部的DSP和驱动器,这段电信号路径长达10-15厘米,带来显著的功耗和信号损失。

图3:可插拔光模块的功耗天花板 vs CPO方案
密度天花板
可插拔光模块的端口密度受限于交换机前面板的物理空间。一台标准1U交换机前面板通常可容纳32-64个端口,当模块体积和功耗增大时,散热需求进一步限制了可部署的端口数量。在1.6T时代,单端口功耗25W意味着64端口交换机仅光模块功耗就达1600W,加上交换芯片本身的功耗,传统风冷散热已难以应对。
延迟天花板
可插拔光模块的信号路径较长:交换芯片→PCB走线→连接器→光模块DSP→激光驱动器→光纤→光接收器→TIA→DSP→连接器→PCB走线→交换芯片。每一段都引入延迟,特别是DSP的数字信号处理延迟约100ns级别。在AI训练场景中,GPU间的通信延迟直接影响训练效率,每减少1微秒的延迟都可能节省数百小时的训练时间。
结论
铜互联碰到物理墙→可插拔光模块碰到功耗/密度/延迟墙→CPO是高密度AI互联场景的核心演进方向。三种技术在不同场景长期共存,CPO不是对所有场景的唯一选择,而是在高密度AI互联中具有不可替代的优势。
二、CPO技术全解析
2.1 CPO的定义与核心原理
CPO(Co-Packaged Optics,共封装光学)是一种将光引擎(Optical Engine)与交换芯片(ASIC)共同封装在同一基板上的新型光互联技术。其核心改变是:将光引擎从交换机前面板的可插拔模块,移到了紧贴交换芯片的位置,电信号传输路径从"厘米级"缩短到"毫米级"。
在传统可插拔方案中,交换芯片与光模块之间的电信号需要通过PCB走线(约10-15厘米)和连接器传输,这段路径是功耗和信号完整性的主要瓶颈。CPO方案通过将光引擎直接集成在交换芯片封装内,电信号路径缩短至1-2毫米,大幅降低了功耗和延迟,同时提升了信号完整性。
CPO的典型架构包括:交换芯片(ASIC)、光引擎(包含激光器、调制器、探测器)、光纤接口(光纤阵列连接器)、以及封装基板(有机基板或硅中介层)。光引擎可以安装在交换芯片的侧面或上方,通过微凸块或混合键合与基板连接。
2.2 光互联技术演进路线

图4:光互联技术演进路线(气泡大小=带宽密度倍数,颜色=商用成熟度)
关于LPO与CPO的关系:LPO(Linear Pluggable Optics)是近期最受关注的过渡方案,它去掉了光模块中的DSP芯片,将信号均衡功能转移到交换芯片侧,功耗降低约50%,但仍保持可插拔形态。1.6T LPO功耗约8-12W(不含DSP,口径与CPO光引擎功耗9W不同,后者也不含交换芯片侧功耗),需注意口径差异。LPO的局限在于去除DSP后对噪声更敏感,传输距离受限(通常2km以内),更适合短距离AI集群内部互联。LPO和CPO并非简单替代关系——LPO适合中短距离通用场景,CPO适合高密度Scale-Up/Scale-Out场景,两者长期共存。LPO的成熟可能延缓部分客户向CPO迁移的时间表,但在3.2T及更高速率下,CPO的功耗和密度优势将更加明显。
NPO(Near-Packaged Optics)将光引擎放置在靠近交换芯片的位置(但不在同一封装内),通过高密度连接器与交换芯片连接,功耗和延迟介于LPO和CPO之间。NPO可以作为CPO的过渡方案,降低CPO的集成难度和风险。
2.3 CPO的核心技术挑战
热管理:最棘手的矛盾
CPO面临一个看似矛盾的热管理挑战:激光器对温度极其敏感(InP激光器波长漂移约0.1nm/℃),而CPO将光引擎紧贴着功耗高达数百瓦的交换芯片。如何确保激光器在高温环境下稳定工作,是CPO最核心的技术难题。当前的热管理方案包括:(1)热隔离设计——在光引擎和交换芯片之间设置隔热层和热通道,将交换芯片的热量导向散热器而非光引擎;(2)微流道液冷——在封装内部集成微流道冷却系统,直接将冷却液引导至热源附近,散热效率比传统风冷提升10倍以上;(3)PLS可更换光源——将激光器单独封装在可插拔模块中,远离热区,通过光纤将光信号传导至光引擎。英伟达和博通的CPO方案均采用了PLS设计。
封装工艺:先进封装的极限挑战
CPO需要2.5D/3D先进封装技术,微米级的对准精度——光纤阵列与光芯片的对准精度需达到±0.5μm以内,远超传统电子封装的要求。台积电的CoWoS和SoIC封装是当前量产首选(已商用CPO产品均采用台积电封装),但英特尔EMIB和三星I-Cube也已完成CPO封装全流程验证,未来有望形成多供应商竞争格局。台积电已验证1.6Tbps光引擎,并测试3.2Tbps产品。日月光作为全球最大封测代工厂,也在积极布局CPO系统级封装能力。据报道,英伟达CEO黄仁勋曾访问日月光,市场预期日月光将在CPO封装领域获得重要订单。
可靠性与维护性
CPO的可靠性挑战在于光电器件寿命不匹配:激光器的典型寿命约10-20年,而交换芯片的设计寿命通常更长。当激光器失效时,传统可插拔方案只需更换光模块,但CPO方案中光引擎与交换芯片共封装,理论上需要更换整个封装,维护成本极高。PLS(Pluggable Light Source)可更换光源是主流解决方案——将激光器单独封装在可插拔模块中,当激光器失效时只需更换PLS模块,无需更换整个CPO封装。OCP和CPO联盟正在推进PLS接口标准化,目标是实现不同供应商的PLS模块互换。CPO系统可靠性目标:累计无中断工作时间>100万小时(UCW,Unplanned Chassis Withdrawal)。
标准化进展
CPO标准化是规模商用的前提。当前推进中的标准化组织包括:OCP(开放计算项目)的CPO Workstream,定义CPO系统架构和PLS接口规范;OIF(光学互联论坛),推进光电器件互操作标准;CPO联盟,由博通、思科、英特尔等公司发起。标准化进展顺利,但互操作性和多供应商生态建设仍需时间。
2.4 CPO vs 铜互联 vs 可插拔光模块

图5:AI数据中心互联需求 vs 技术方案匹配矩阵
三种技术并非简单替代关系,各有最优场景:机柜内短距离(<3米),铜缆仍是最优选择;机柜间和行间互联(3-100米),可插拔光模块是当前主流;高密度AI集群Scale-Up/Scale-Out,CPO是未来的最优解。
三、CPO产业链拆解

图6:CPO产业链全景图
3.1 上游:光芯片与材料
激光器芯片
在CPO架构中,硅光芯片+外置激光器(PLS)是当前主流方案,英伟达Quantum-X/Spectrum-X Photonics和博通Bailly均采用此架构。硅光芯片负责调制和探测,激光器(InP材质,封装在PLS模块中)提供光源。这种分离式设计既解决了激光器热管理难题,又利用了硅光芯片的高集成度优势。Lumentum和Coherent是全球EML激光器芯片的两大巨头,合计市场份额超过70%。中国厂商源杰科技在DFB/EML芯片领域正在快速追赶,已实现25G EML量产,50G/100G EML仍在研发中。
硅光芯片
硅光技术是CPO的核心使能技术之一。硅光芯片利用成熟的CMOS工艺在硅基衬底上集成光波导、调制器、探测器等光子器件,实现光电子的大规模集成。硅光芯片的关键优势包括:(1)与CMOS工艺兼容,可利用现有晶圆厂大规模生产;(2)集成度高,单个芯片可集成数十个调制器和探测器;(3)成本潜力大,规模量产后单芯片成本可显著低于III-V族方案。
Intel是全球硅光技术的领导者,其硅光平台已实现数百万只光模块的商用交付。Marvell在硅光CPO方面也有布局,其数据中心互连芯片方案集成了硅光引擎。中国方面,中际旭创通过硅光技术路线实现800G/1.6T光模块量产,但在硅光CPO芯片的自研能力方面仍有差距。
薄膜铌酸锂调制器(TFLN)
薄膜铌酸锂调制器(TFLN)是下一代超高速光调制的重要技术方案。相比传统铌酸锂调制器,TFLN通过薄膜化将器件尺寸缩小数十倍,同时保持高带宽(>100GHz)和低半波电压(<2V)的优势。TFLN在3.2T及以上速率的光模块中具有重要优势,但硅光MZM调制器在3.2T速率下也在推进量产应用,两者存在技术路线竞争,并非简单的"谁替代谁"。
光纤阵列与微透镜
CPO封装需要高精度的光纤阵列连接器,将外部光纤与光引擎中的波导对准。光纤阵列的对准精度要求达到±0.5μm级别,这对精密加工和组装提出了极高要求。主要供应商包括日本扇港(Senko)、美国US Conec等。微透镜阵列用于光路耦合,提升光纤与光芯片的耦合效率,是CPO光路设计的关键组件。
3.2 中游:封装与集成
先进封装
台积电在CPO先进封装领域占据核心地位,当前已商用的CPO产品均采用台积电封装。CoWoS封装是目前AI芯片的主流封装方案,也是当前CPO实现高密度集成的首选封装技术。台积电已验证1.6Tbps光引擎与交换芯片的共封装,并正在测试3.2Tbps方案。日月光作为全球最大封测代工厂,也在积极布局CPO系统级封装能力。英特尔EMIB和三星I-Cube作为替代封装方案已完成CPO封装全流程验证,未来有望形成多供应商竞争格局,降低对台积电的单一依赖。国内长电科技已推出基于XDFOI的CPO封装解决方案,通富微电也在研发中。
光引擎集成
Fabrinet是全球精密光学封装代工龙头,为多家光模块厂商提供代工服务。在CPO时代,光引擎的精密组装(光纤对准、芯片贴装、密封封装)是Fabrinet的核心能力。Coherent和Lumentum的光引擎产品也大量采用Fabrinet的代工服务。
CPO交换机整机
CPO交换机是产业链的集成环节,将CPO光引擎、交换芯片、封装基板、散热系统等组合成完整产品。英伟达和博通是当前CPO交换机的主要推动者。思科和Arista作为网络设备厂商,预计将在2027-2028年推出基于博通CPO芯片的交换机产品。
3.3 下游:AI数据中心
CPO的下游需求主要来自AI数据中心,具体包括三类客户:
- 英伟达生态
:英伟达Quantum-X Photonics(InfiniBand)和Spectrum-X Photonics(以太网)CPO交换机是CPO商用的最核心推动力。英伟达的AI集群方案(如DGX/HGX/B200机架)将大量采用CPO交换机进行GPU间和节点间互联。 - 自研AI芯片厂商
:谷歌TPU、亚马逊Trainium、微软Maia等自研AI芯片,同样需要高带宽低功耗互联。谷歌已在内部数据中心测试CPO方案,预计2027-2028年将开始规模部署。 - 云服务商
:Meta、微软、阿里云、腾讯云等云服务商的数据中心网络升级,是CPO在中长期的重要需求来源。当800G/1.6T可插拔光模块的功耗和密度无法满足需求时,CPO将成为必然选择。
四、关键玩家深度分析
4.1 英伟达:CPO最积极推动者
英伟达是CPO技术的最积极推动者。2025年GTC大会上,英伟达推出了两款CPO交换机产品:Quantum-X Photonics(InfiniBand)和Spectrum-X Photonics(以太网),标志着CPO技术正式从实验室走向商用。
英伟达的CPO方案采用硅光引擎+PLS外置激光器架构,将光引擎与交换芯片共封装在CoWoS基板上。PLS模块安装在交换机面板上,通过光纤将光源传导至封装内部的光引擎,解决了激光器热管理难题的同时保持了可维护性。英伟达计划在未来产品路线图中全面导入CPO技术。
2026年1月CES大会上Rubin GPU正式发布,预计下半年进入量产阶段,将是CPO规模商用的关键节点。Rubin GPU采用3360亿晶体管,配备288GB HBM4内存,配套NVLink 6互联带宽将达到3.6TB/s以上,对光互联的带宽和功耗要求极高,CPO是满足这一需求的核心方案。
4.2 博通:CPO最早量产者
博通在CPO领域处于技术领先地位。公司已推出两款CPO以太网交换机:Bailly(51.2T)和Humboldt(25.6T),采用自研的Tomahawk 5交换芯片和CPO封装技术。博通是全球最大的交换芯片供应商,其CPO方案对行业走向具有重要影响力。博通的CPO方案采用自研硅光引擎,集成在交换芯片封装内。Bailly交换机提供512个100G端口,总交换容量51.2Tbps,采用CPO方案后,前面板不再需要传统光模块,端口密度和功耗均大幅优化。
2025年10月,Meta在ECOC 2025上发布了博通Bailly CPO交换机的大规模实测结果:累计运行超100万CPO 400G端口小时,零数据丢失(零Link Flap),功耗相比可插拔方案降低65%。这是CPO技术首次在超大规模数据中心环境中获得权威实测验证,意义重大。实测还验证了CPO与标准可插拔光模块的互操作性。
博通Bailly 2025年完成客户送样,2026年进入小批量交付阶段,大规模商用预计2027年后。
4.3 Meta:CPO最关键的验证方和推动者
Meta虽然在CPO产业链中不直接制造产品,但它是CPO技术最核心的推动者和验证方。在OCP(开放计算项目)中,Meta主导了CPO架构标准和PLS可更换光源规范的制定,为CPO的标准化和生态建设奠定了基础。
2025年10月,Meta在ECOC 2025上发布了博通Bailly 51.2T CPO交换机的大规模实测结果,这是CPO技术首次在超大规模数据中心环境中获得权威验证:累计运行超100万CPO 400G端口小时,实现零数据丢失(零Link Flap),功耗相比传统可插拔方案降低65%,并验证了与标准可插拔光模块的互操作性。
这一实测结果对CPO商用具有里程碑意义,证明CPO在超大规模数据中心的可靠性已达到可接受水平。Meta的验证为整个行业消除了最大的不确定性——CPO在实际数据中心环境中的可靠性。此后,多家云服务商加速了CPO部署规划,CPO商用节奏明显提速。
4.4 台积电:先进封装的关键支撑
台积电虽然是封装代工厂,但其在CPO产业链中的地位举足轻重。CPO需要2.5D/3D先进封装技术,台积电的CoWoS和SoIC封装是全球最先进的封装方案,也是目前CPO量产交付的首选封装技术。当前已商用的CPO产品均采用台积电封装,但英特尔EMIB和三星I-Cube已完成全流程验证,未来有望形成多供应商竞争格局。台积电已验证1.6Tbps光引擎与交换芯片的共封装,并正在测试3.2Tbps方案。在CPO时代,台积电的角色可能从"芯片代工"延伸至"光电子封装代工",开辟新的增长空间。
4.5 Lumentum与Coherent:光芯片双雄
Lumentum FY26 Q1(截至2025年9月)营收5.34亿美元,同比增长58%,组件业务营收3.79亿美元,同比增长64%。Coherent FY2025营收58.1亿美元,同比增长23%。两家公司合计占据高端EML芯片市场70%以上份额,是CPO产业链上游的核心供应商。
4.6 中国玩家:角色转换进行时
中国光模块厂商在CPO中的角色正在从"光模块组装"向"光引擎和先进封装"延伸。但核心环节——EML激光器芯片和先进封装——仍严重依赖海外供应。Lumentum和Coherent垄断了高端EML芯片市场,台积电主导了先进封装产能,中国厂商在CPO产业链中的话语权弱于可插拔光模块时代。
五、市场规模与渗透节奏
5.1 CPO市场规模预测

图7:CPO市场规模预测(多方数据对比)
注意:不同机构对"市场规模"的统计口径差异较大——摩根士丹利口径为CPO光引擎及模组市场,LightCounting含3.2T端口及配套,Yole为保守估计仅CPO模组。读者在做跨机构比较时需注意口径差异。
5.2 CPO渗透节奏判断
CPO渗透三阶段
- 第一阶段(2026-2027):商用验证期
。英伟达Rubin GPU 2026年1月发布、预计下半年量产,博通Bailly 2026年进入小批量交付,Meta ECOC 2025实测结果为商用提供信心支撑。渗透率约5%-10% - 第二阶段(2027-2028):规模部署期
。CPO技术成熟度提升,主流云服务商开始在新数据中心中规模部署。渗透率约15%-25% - 第三阶段(2029-2030):标配化期
。3.2T光互联时代,CPO在高密度AI数据中心中成为标配。但可插拔不会消失。渗透率约30%-40%(高密度AI场景可达70%+)
5.3 铜互联的市场收缩
CPO的渗透意味着铜互联在AI数据中心中的份额将持续收缩。但铜互联不会消失,其最后的堡垒是机柜内部短距离互联(<2米),这一场景对延迟和成本的要求使铜缆仍是最优选择。
市场格局演变预判:在AI数据中心中,铜缆份额从2024年的约40%逐步收缩至2030年的约15%;可插拔光模块从50%收缩至30%;CPO从接近0%增长至40%以上;LPO/NPO填补过渡期需求约15%。在通用数据中心中,可插拔光模块仍占主导,CPO渗透缓慢。
六、财务分析
财务数据注释:英伟达FY2025截至2025年1月,净利润729亿美元/同比+145%(营收+114%,两个增速不同口径);博通FY2025截至2025年11月,营收639亿美元,Q4单季净利润85亿美元,全年净利润含非经常性项目波动大,此处为Non-GAAP口径约300亿;Lumentum FY26Q1截至2025年9月;中际旭创/新易盛/天孚通信/源杰科技单位为人民币,其余为美元。中际旭创2025年净利润108亿元为业绩快报口径,正式财报请以公司公告为准。
从财务数据可以观察几个趋势:
- 光模块厂商业绩爆发
:中际旭创2025年净利润108亿元(业绩快报口径,同比+109%),新易盛2025H1净利润39亿元(同比+356%),反映出AI驱动光模块需求的强劲增长。但需注意,当前业绩主要由800G可插拔光模块贡献,CPO的业绩贡献尚未体现。 - 光芯片厂商增长加速
:Lumentum组件业务同比增长64%,Coherent网络业务占比57%,反映出CPO对光芯片需求的拉动效应正在显现。 - 高毛利率是护城河
:天孚通信57%的毛利率在光模块产业链中最高,体现了光器件的稀缺性和技术壁垒。CPO对精密光学组件的需求将进一步提升高毛利公司的价值。
七、技术趋势展望
7.1 224G SerDes与3.2T光模块
224G SerDes是下一代数据中心互连的标准电接口速率,单通道带宽翻倍。基于224G SerDes,3.2T光模块(16通道×200G或8通道×400G)正在研发中。3.2T光模块对光芯片的带宽和调制性能提出更高要求,TFLN调制器和硅光技术的进步是3.2T实现的关键。在3.2T速率下,可插拔光模块的功耗预计将超过40W,进一步凸显CPO方案的必要性。LightCounting预测2029年3.2T CPO端口出货量将超1000万个。
7.2 硅光CPO vs InP CPO
当前硅光CPO是主流路线,英伟达和博通均采用硅光芯片+外置PLS激光器(InP材质)的架构。InP方案在超高速调制方面具有性能优势,两者可能在不同的CPO代际中各有优势。长期来看,硅光的成本和集成度优势将使其成为CPO的主流路线,InP激光器则以PLS外置光源的形式长期存在。
7.3 OIO(光学I/O):比CPO更远的未来
OIO(Optical I/O)是将光互联直接集成在计算芯片(CPU/GPU)内部的终极方案。与CPO将光引擎与交换芯片共封装不同,OIO将光波导和调制器直接制作在芯片的I/O层,实现片内光通信。OIO的带宽密度可达CPO的数倍,功耗更低,但技术难度极高。美国DARPA的PIPES项目和LUMOS项目正在资助OIO技术的研究。Ayar Labs、Lightmatter等初创公司正在开发OIO方案,但距离商用仍需5-10年。OIO的商业化可能需要224G SerDes之后的下一代互连技术(448G+)才能实现经济可行性。
7.4 存算一体与光计算
更远的未来,光子计算(Photonic Computing)可能从根本上改变计算和互联的架构。光计算利用光的并行性和低能耗特性,在矩阵运算等AI核心计算中具有天然优势。Lightmatter、Salience Labs等公司正在开发光计算芯片。但光计算的精度和可编程性目前仍远不如电子计算,短期内更可能以"光电混合计算"的形式出现,而非完全取代电子计算。
八、风险提示
风险1:封装良率与成本是CPO最大的商用风险CPO封装的复杂度远高于传统光模块,微米级对准精度(±0.5μm)和光电器件集成对良率构成严峻挑战。当前CPO封装良率仍显著低于传统可插拔光模块,导致初期成本高企。如果封装良率无法快速提升至90%以上,CPO的成本优势将无法体现,可能推迟规模商用进程。Meta ECOC 2025的百万小时实测虽验证了可靠性,但良率和成本的突破才是大规模部署的前提。
风险2:LPO技术成熟度超预期,延长可插拔生命周期LPO通过去除DSP实现功耗降低(1.6T LPO功耗约8-12W),在短距离AI集群内已进入小批量阶段。如果LPO在200G/lane及更高速率下稳定运行,可能推迟CPO的渗透节奏。LPO与CPO并非简单替代关系,而是在不同场景(LPO适合2km以内短距离,CPO适合高密度Scale-Up)长期共存。但LPO的成熟可能延缓部分客户从可插拔向CPO迁移的时间表。
风险3:标准化进度不及预期,供应商锁定风险CPO的互操作性和多供应商生态建设依赖OCP/OIF等组织的标准化推进。PLS(可更换光源)接口规范是CPO维护性和生态开放性的关键,目前仍在制定中。如果标准化进度滞后,可能导致客户被单一供应商锁定(如英伟达或博通的封闭生态),抑制CPO的渗透速度,尤其是对成本敏感的中型数据中心。
风险4:核心零部件国产替代困难,供应链风险突出CPO核心环节高度依赖海外供应商:高端EML激光器芯片由Lumentum和Coherent双寡头垄断,合计份额超70%;先进封装由台积电主导(当前已商用CPO产品均采用台积电CoWoS);硅光芯片设计和制造也主要由Intel、Marvell等海外厂商领先。中美科技摩擦可能导致EML芯片和先进封装供应受限。国内源杰科技50G/100G EML仍在研发,长电科技CPO封装方案刚推出,短期国产替代能力有限,中国厂商在CPO产业链的话语权弱于可插拔时代。
风险5:AI资本开支周期性下行风险CPO需求高度依赖AI数据中心的资本开支。当前AI资本开支主要由英伟达生态驱动,Meta、谷歌、微软等超大规模云服务商是核心客户。如果AI应用落地不及预期,或云服务商资本开支进入调整期,CPO的市场需求可能放缓。历史上,光模块市场与云服务资本开支周期高度相关,存在周期性下行风险。