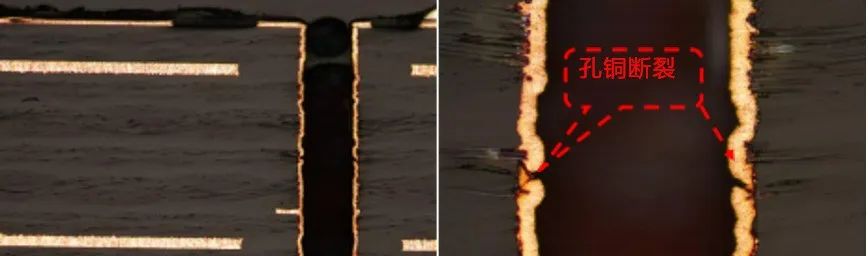
M401酸性除油剂:10% v/v
98%H2SO4:5% v/v
T:35-45℃; t:2-3min
水洗二次;
微蚀:
50%H2O2:10% v/v
98%H2SO4:3.5% v/v
H2O2稳定剂M101:5% v/v
T:室温 t:1min
水洗二次;
浸酸:
98%H2SO4:5% v/v
T:室温 t:30s
水洗二次;
预浸:
Ag48:100% v/v
T:室温 t:30s
PH:3.5-4.5
化学沉银:
Ag58:100%v/v
T:25-40℃ t:2-3min
去离子水洗三次;
吸干,吹干,烘干(70℃热风);
沉银组分的分析方法:
银离子浓度的分析方法:
原子吸收光谱(AA)法:
14.3化验:
容量滴定法:
14.4: 试剂:0.01N碘化钾(KI),亚硝酸钾(KNO2),浓硝酸,淀粉指示剂;b:分析方法:
用移液管准确吸取5.0ml沉银工作液于250ml烧瓶中;
加25ml去离子水并摇匀;
加1ml浓硝酸并摇匀;
加0.5g亚硝酸钾搅拌到溶解;
加3.5ml淀粉指示剂;
用0.01N碘化钾溶液滴定至第一次颜色转变为终点,体积为V(毫升);
14.4.1:计算:
银含量(g/l)=1.079V/5
沉银溶液中铜离子浓度的分析方法(建议用原子光谱法AA法):
请参阅原子吸收光谱仪的使用说明,并以1mg/L或2mg/L的标准铜溶液为参照测定沉银溶液中Cu2+的浓度.
沉银溶液的维护:
通常只需定期分析沉银液中的浓度,然后按照银离子浓度降低的数值加入Ag58补充液,即可补充银离子和其他组分,要补加1.0g/L的银(或1.5g/L的AgNO3),只需加入200ml/L Ag58补充液即可,Ag58沉银液可用到4个MTO(即补充4g/L或6g/L硝酸银)后更新,或者用至溶液中Cu2+浓度达到3g/L时更新.
当Ag58溶液更新时,Ag48预浸液也必须同时更新.
14.5沉银层的性能:
14.5.1.1. 沉银层的焊接性能(Solderability)
可焊性测试是在DAGE-BT 2400PC焊球剪切试验机(Solder ball shear techine)上进行.镀后的样品,先涂布Saparkle Flux WF-6050助焊剂,然后放上0.5mm的焊料球,在回流焊(Reflow)机上熔化一次,焊球则焊接在样品上.再放入焊球剪切试验机上,用移动臂将焊球推离焊接点,同时记录扒离越牢,可焊性越好.
在155℃烘烤不同时间后的可焊性
烘烤时间(h) BAIKAL银层 M公司银层 沉镍沉金
Al2O3-DBC就是指采用Al2O3陶瓷片与铜板在高温和惰性气体中直接键合而成的陶瓷基覆铜板。其制作流程为:这里所使用的Al2O3瓷片一般是指Al2O3含量96%,适用于薄膜电路或厚膜电路的电子陶瓷片经特殊加工处理而成。
在高温下含氧量一定的气氛中,金属铜表面氧化形成一薄层Cu2O,温度高于低共熔点时,出现Cu-Cu2O共晶液相,其中的Cu2O相与Al2O3陶瓷有着良好的亲和性,使界面能降低,共晶液相能很好地润湿铜和陶瓷。同时液相中的Cu2O与Al2O3发生化学反应
15.3.1 铜导带和Al2O3陶瓷基片在高温适合的气氛中直接键合,具有较高的导热性。热导率为:14~28W/m.K.
15.3.2 DBC的热膨胀系数同于Al2O3基片(7.4x10-6/℃),与Si相近并和Si芯片相匹配,可以把大型Si芯片直接搭乘在铜导体电路上,省去了传统模块中用钼片等过渡层。
15.3.3 由于DBC制作主要以化学键合为主,所以键合强度十分高,拉脱强度大于50N/mm2,剥离强度大于9N/mm。
15.3.4 基板耐可焊接性好,使用温度高。传统PCB一般在260℃ 60s左右,DBC成型温度在1000℃左右,在260℃可以多次焊接,-55~+88范围内长期使用具有优异的热可靠性。
15.3.5 可以利用传统PCB制作工艺设备进行精细线路的加工制作。具有通用性,适宜于大批量生产。
15.3.6 引线和芯片可焊性好。
15.3.7 不会产生金属迁移。
15.3.8 耐电压高(15kY/mm)
15.3.9 绝缘层电阻率高(一般大于1x10 14Ω.mm)。导电层铜电路的电阻率极其低(2.5x10-6Ω.mm),电流通过时发热。
15.3.10 导电层100~600/μm,可根据电路模块设计任意的大电流。
15.3.11 导电铜电路的电阻率极其低(2.5x10-6Ω.mm),电流通过时发热。
15.3.12 高频损耗小(tanδ<10-3),可进行高频电路的设计和组装。
15.3.13 可进行高密度组装,实现短、小、轻、薄化。
15.3.14 不含有机组分,耐宇宙射线,在航天航空方面可靠性高,使用寿命长。
15.3.15 导体铜具有极好的可塑性,可进行大面积模块组装。
陶瓷基覆铜板(DBC)在耐热性、散热性、耐宇宙射线、绿色环保性以及高低温循环老化试验方面的优异性能是传统覆铜板无法比拟的。从文献查阅看,国外目前还没有一个统一完整的标准,甚至与各个企业的生产标准相关报道也十分稀少。我国目前制定的最完整最权威的标准是国营第704厂制订,经中国电子技术标准化研究所评审确认的企业军用标准。该标准是根据常规覆铜板的一些性能要求并参考借鉴铜箔(电解铜箔或压延铜箔)、陶瓷基片(厚膜电路和薄膜电路用电子陶瓷基片)等相关标准以及陶瓷覆铜板的具体加工特点,规格尺寸等进行制订的。表4-6是陶瓷覆铜板主要性能及指标一览表。
由于各种氧化物陶瓷的化学性能、物质结构不尽相同。因此,高温下生成共晶熔,继而生产345 的过程存在着一定的差异。选择MgO,CaO,ZnO,2MgO.SiO2,BaTiO3,TiO2,SiO2,ZrO2,AIN,BN,SiC进行与Cu-Al2O3一样的键合,结果表明:TiO2,SiO2,ZrO2等陶瓷能与铜形成牢固的键合,剥离强度都在10N/mm以上;ZnO,2MgO.SiO2,BaTiO3陶瓷与铜也键合良好,但键合力要小一些,约在9N/mm;而MgO,CaO,AIN,BN,SiC则不能直接形成键合。
(一)陶瓷的化学键性的影响
实验结果表明,铜与大多数金属氧化物陶瓷及其盐类能形成良好的键合。一般来说,这些陶瓷都是离子键较强的化合物。Cu-Cu2O共晶熔体在高温下对氮化铝陶瓷的润湿性较差,与氮化铝陶瓷属共价键化合物有着很大的关系。Al-N间很强的共价键以及共价键极强的方向性,使氮化铝陶瓷具有良好的化学稳定性,高温下难以与金属及其氧化物发生化学反应。因而,可以推断共价键性较强的陶瓷(如AIN,BN,SiC等陶瓷)不能与铜形成直接键合,必须有一层氧化物相作为过渡层。
尽管在铜>陶瓷键合的温度下,Cu2O与大多数氧化物陶瓷还没能形成低共熔相,但如果键合温度与这一低温度较接近时可以增强陶瓷表面的活性,更好地促进Cu-Cu2O共晶熔体对陶瓷的湿润。表4-4列出了Cu2O与其他氧化物陶瓷形成低共熔点的温度。从表中可以看出Al2O3,ZrO2,SiO2和Cr2O3陶瓷与Cu2O形成低共熔相的温度不是很高,铜_陶瓷键合的温度(约1080℃左右)比较接近,有的甚至低于这一温度(如SiO2)。因而在键合的工艺条件下Cu2O与陶瓷晶粒的界面之间已有很大的活性,Cu-Cu2O共晶熔体能很好地湿润陶瓷,冷却后形成牢固的键合。而Cu2O与MgO陶瓷之间由于形成低共熔点的温度要高得多,因而在相对较低的温度下不易形成键合。
键合时铜_陶瓷界面发生微观结构的变化或进行化学反应,不可缺少的因素就是在界面间发生原子迁移。当Cu2O与Al2O3陶瓷发生化学反应时,其中的铜元素通过扩散将渗透到Al2O3陶瓷晶格中,形成Cu-Al-O键(尽管这一反应层很薄),从而形成牢固的化学键合。因此,铜能否与其他氧化物陶瓷形成键合,与键合时氧化物的结构是否便于铜元素的扩散将有一定的关系。
版权声明:本文信息版权归原作者所有来源,不代表本平台观点,仅为分享使用,如涉及版权与信息错误问题,敬请联系我们更正或删除。谢谢!
https://mp.weixin.qq.com/s/dP_S4bHH9xiQlKByucFxyw

电子电路上下游产业链交流平台,请添加微信PCBA2020交流加入交流群和8月上海、10月深圳终端论坛活动报名,敬请注明您所在公司及主营业务,添加后附名片即可。