
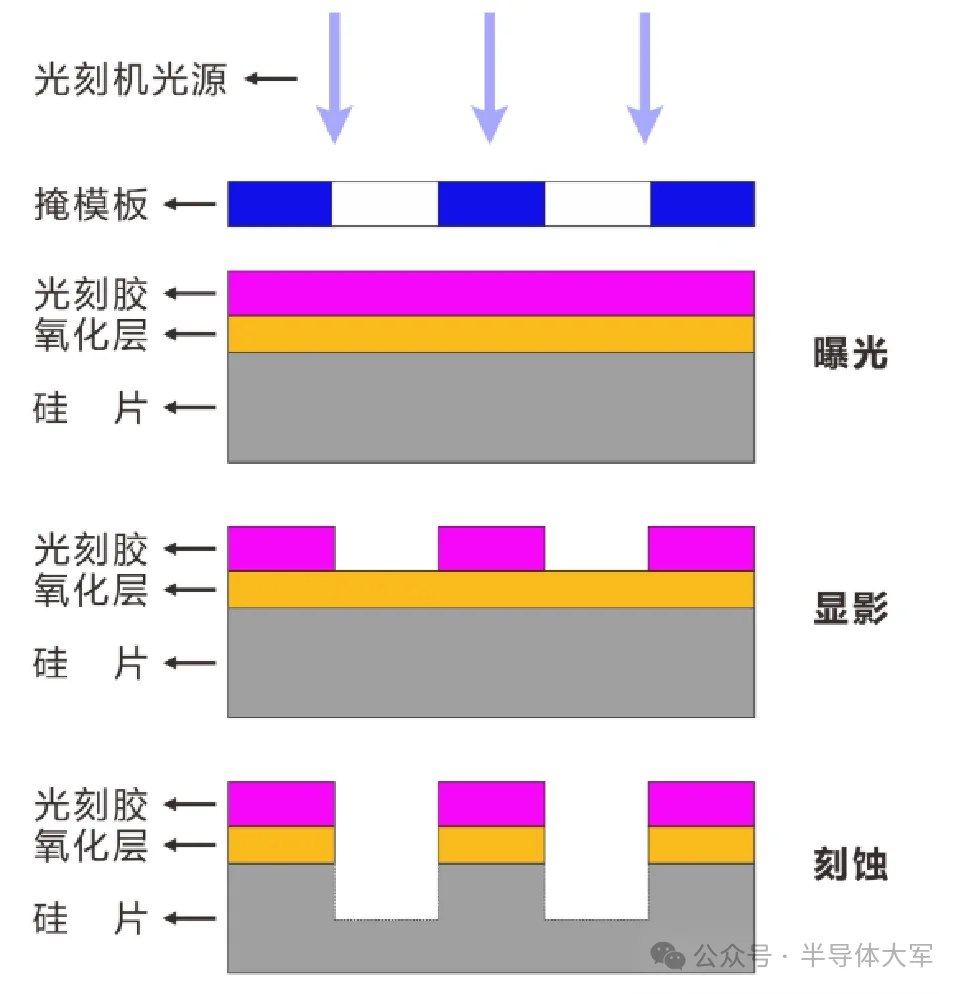
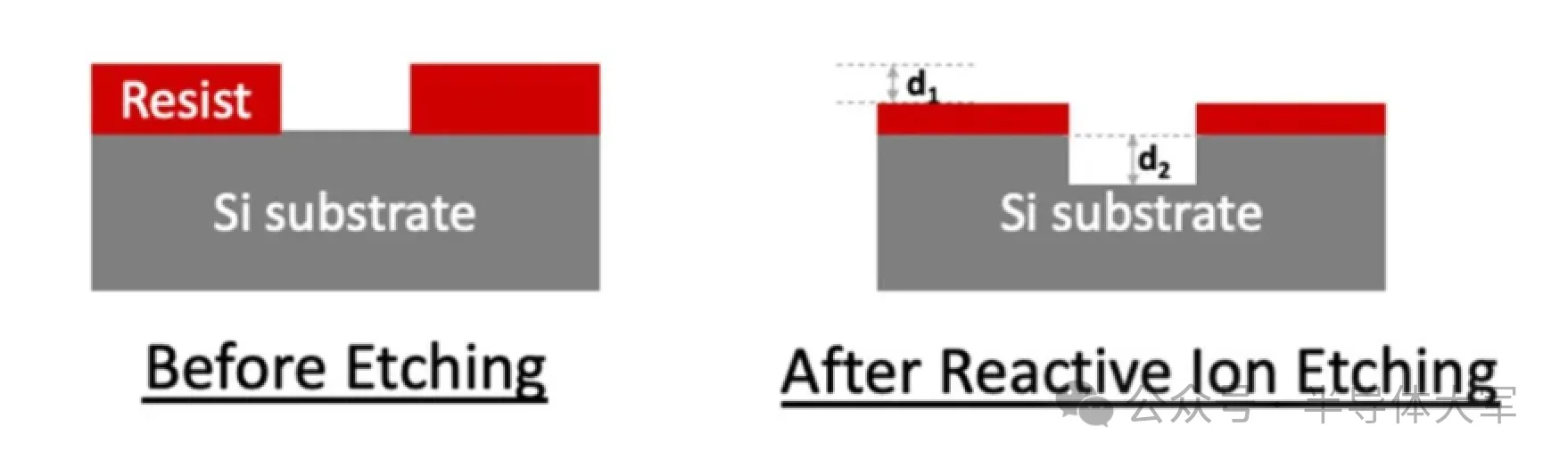
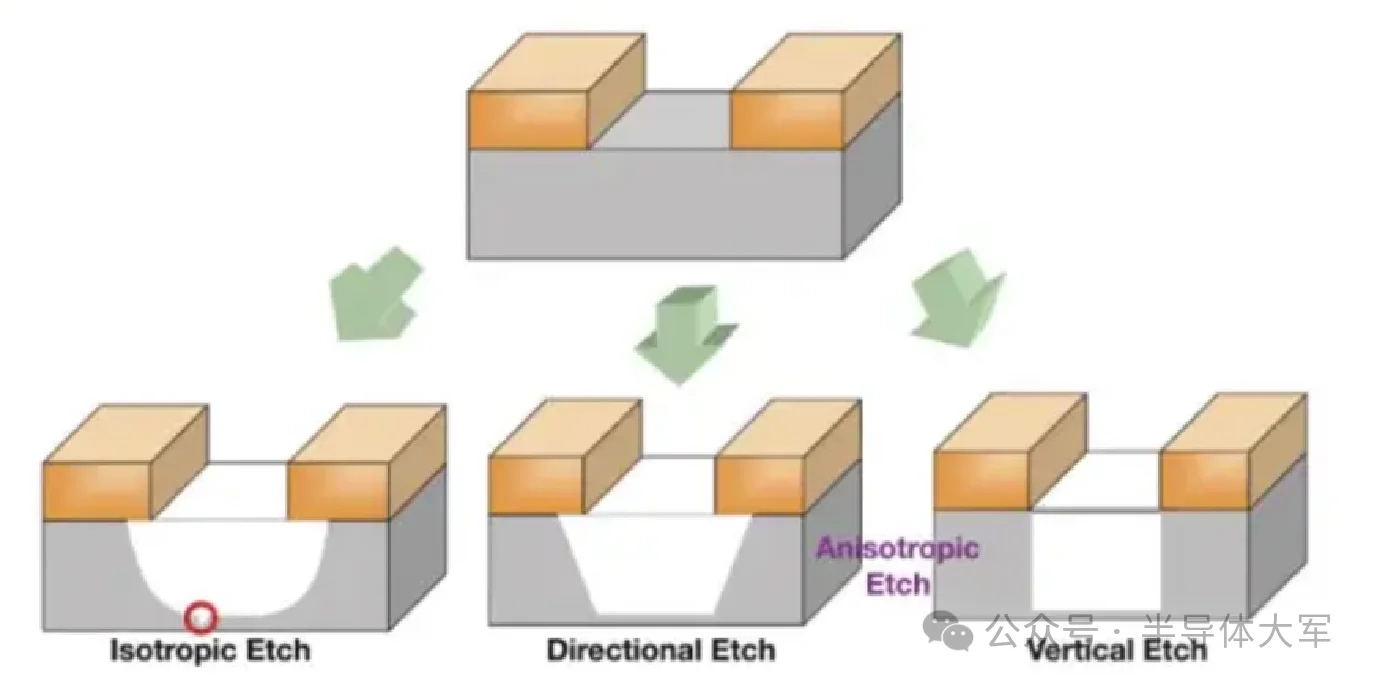
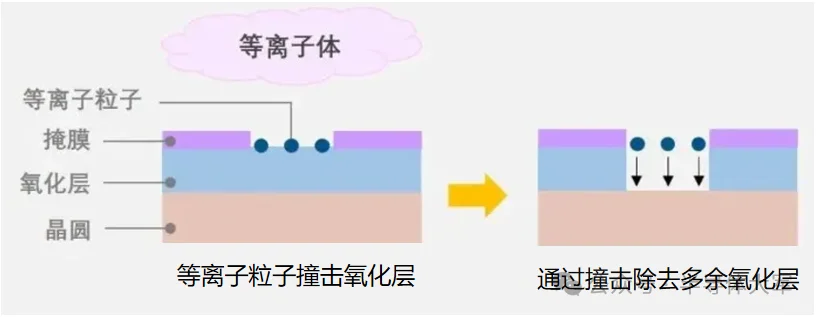
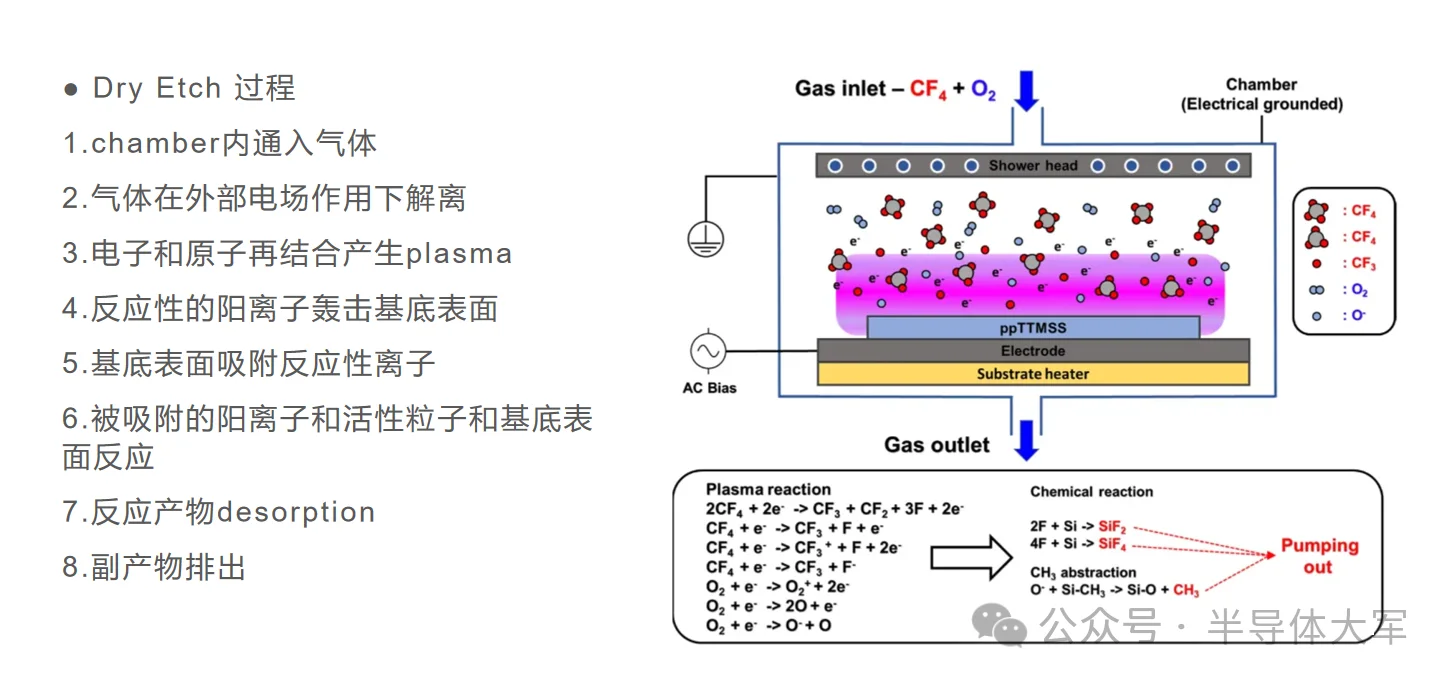
刻蚀(Etching)
核心原理是:利用物理化学方法,通过光刻胶(或硬掩模,如氧化物、氮化物)作为掩模,选择性去除基材表面不需要的部分,使保留的区域形成预设图案。
要求:
选择比:对目标材料的刻蚀速率和掩模材料和底层材料的速率比例;(图2)
方向性:控制刻蚀在纵向和横向的速率比;(图3)
刻蚀速率:是指单位时间内材料被去除的速度。
均匀性:保证大面积刻蚀的一致性,避免局部过刻或欠刻。
分类:
一、湿法刻蚀(Wet Etching)
原理:利用化学溶液与被刻蚀材料发生化学反应,生成可溶的化学产物,通过溶液溶解作用去除材料。
特点:
刻蚀过程为各向同性,易产生侧蚀,精度较低;
操作简单、成本低、适合大面积刻蚀;
选择性高。
典型应用与刻蚀液:
硅刻蚀:氢氟酸(HF)+硝酸(HNO₃)+醋酸(CH₃COOH)混合液(HF提供F-,HNO₃氧化Si为SiO₂,再被HF溶解);
二氧化硅刻蚀:用稀释的HF溶液;
金属刻蚀:用酸性溶液;
光刻胶去除:用有机溶液(丙酮)。
二、干法刻蚀(Dry Etching)
原理:在真空环境中,通过气体等离子体(含活性离子、自由基)与材料作用,或通过物理轰击去除材料。
根据机制不同,干法刻蚀可细分:
1. 化学干法刻蚀(纯化学刻蚀)
原理:利用等离子体中的活性自由基(如F·、Cl·)与材料发生化学反应,生成挥发性产物(如SiF₄、SiCl₄),被真空泵抽走。
特点:各向同性,刻蚀速率快、选择性高,但精度有限;
应用:SiO₂刻蚀(用CF₄、CHF₃等离子体,生成CO、SiF₄等)。
2. 物理干法刻蚀(纯物理刻蚀,离子铣刻蚀)(图4)
原理:高能离子(如Ar⁺)在电场加速下轰击材料表面,通过动量转移“溅射”去除原子。
特点:各向异性,但选择性差;
应用:需要严格控制横向刻蚀的场景(如金属细线刻蚀)。
3. 物理化学干法刻蚀(混合刻蚀)(图5)
原理:结合化学自由基的反应与离子轰击的物理作用,平衡选择性与各向异性,是目前最常用的干法刻蚀类型。
典型技术:
反应离子刻蚀(RIE):等离子体中,活性自由基与材料反应,同时离子轰击增强反应速率并抑制横向刻蚀(各向异性),选择性和精度均较好,广泛用于半导体刻蚀(如硅、金属、介质);
- 深层反应离子刻蚀(DRIE):通过交替进行刻蚀与钝化(沉积聚合物保护侧壁),实现超高深宽比(如100:1)结构刻蚀;
- 电感耦合等离子体刻蚀(ICP):通过电感耦合产生高密度等离子体,提高刻蚀速率和均匀性,适合大面积、高精度刻蚀。(图6)
核心原理是:利用物理化学方法,通过光刻胶(或硬掩模,如氧化物、氮化物)作为掩模,选择性去除基材表面不需要的部分,使保留的区域形成预设图案。
要求:
选择比:对目标材料的刻蚀速率和掩模材料和底层材料的速率比例;(图2)
方向性:控制刻蚀在纵向和横向的速率比;(图3)
刻蚀速率:是指单位时间内材料被去除的速度。
均匀性:保证大面积刻蚀的一致性,避免局部过刻或欠刻。
分类:
一、湿法刻蚀(Wet Etching)
原理:利用化学溶液与被刻蚀材料发生化学反应,生成可溶的化学产物,通过溶液溶解作用去除材料。
特点:
刻蚀过程为各向同性,易产生侧蚀,精度较低;
操作简单、成本低、适合大面积刻蚀;
选择性高。
典型应用与刻蚀液:
硅刻蚀:氢氟酸(HF)+硝酸(HNO₃)+醋酸(CH₃COOH)混合液(HF提供F-,HNO₃氧化Si为SiO₂,再被HF溶解);
二氧化硅刻蚀:用稀释的HF溶液;
金属刻蚀:用酸性溶液;
光刻胶去除:用有机溶液(丙酮)。
二、干法刻蚀(Dry Etching)
原理:在真空环境中,通过气体等离子体(含活性离子、自由基)与材料作用,或通过物理轰击去除材料。
根据机制不同,干法刻蚀可细分:
1. 化学干法刻蚀(纯化学刻蚀)
原理:利用等离子体中的活性自由基(如F·、Cl·)与材料发生化学反应,生成挥发性产物(如SiF₄、SiCl₄),被真空泵抽走。
特点:各向同性,刻蚀速率快、选择性高,但精度有限;
应用:SiO₂刻蚀(用CF₄、CHF₃等离子体,生成CO、SiF₄等)。
2. 物理干法刻蚀(纯物理刻蚀,离子铣刻蚀)(图4)
原理:高能离子(如Ar⁺)在电场加速下轰击材料表面,通过动量转移“溅射”去除原子。
特点:各向异性,但选择性差;
应用:需要严格控制横向刻蚀的场景(如金属细线刻蚀)。
3. 物理化学干法刻蚀(混合刻蚀)(图5)
原理:结合化学自由基的反应与离子轰击的物理作用,平衡选择性与各向异性,是目前最常用的干法刻蚀类型。
典型技术:
反应离子刻蚀(RIE):等离子体中,活性自由基与材料反应,同时离子轰击增强反应速率并抑制横向刻蚀(各向异性),选择性和精度均较好,广泛用于半导体刻蚀(如硅、金属、介质);
- 深层反应离子刻蚀(DRIE):通过交替进行刻蚀与钝化(沉积聚合物保护侧壁),实现超高深宽比(如100:1)结构刻蚀;
- 电感耦合等离子体刻蚀(ICP):通过电感耦合产生高密度等离子体,提高刻蚀速率和均匀性,适合大面积、高精度刻蚀。(图6)